文献标识码: A
DOI:10.16157/j.issn.0258-7998.182447
中文引用格式: 原怡菲,张博. GaAs基双相压控衰减器MMIC设计[J].电子技术应用,2019,45(4):45-47,51.
英文引用格式: Yuan Yifei,Zhang Bo. The MMIC design of GaAs bi-phase voltage variable attenuator[J]. Application of Electronic Technique,2019,45(4):45-47,51.
0 引言
压控衰减器是一种通过控制直流偏置调整输入、输出端口之间信号幅度的双端口网络,广泛应用于射频、微波系统中。其用途包括:LNA(Low Noise Amplifier)或PA(Power Amplifier)之后的增益控制、幅度调制器、振荡器中的幅度稳定电路、自动增益控制系统等[1-5]。
随着电路工作频率的提高,GaAs pHEMT管芯的寄生效应严重影响了压控衰减器的电路工作性能。目前,已有多种方法对其进行改进。文献[2]采用三栅MESFETs减小寄生,提高功率容量。文献[3]在π型衰减结构的技术上,采用带通滤波器技术以消除FET的寄生影响。文献[4]采用π型衰减结构和T型衰减结构级联的拓扑形式,扩大衰减范围,并联支路采用堆叠结构,提高线性度。文献[5]采用分布式结构以拓展带宽,采用堆叠结构以提高线性度。
本文设计了一款工作在Ku波段的双相压控衰减器。通过采用平衡式衰减器结构,供电电压采用互补形式,实现电路衰减值的双相调节。衰减部分采用T型衰减器和π型衰减器级联拓扑,扩大衰减范围。并联支路采用堆叠结构,提高电路的线性度。
1 压控衰减器基本原理
1.1 GaAs pHEMT等效模型
GaAs pHEMT管芯是单片集成电路设计的基础和核心,理解和掌握管芯的电特性机理和模型特点,对单片集成电路设计十分重要。在压控衰减器中,pHEMT管芯作为受栅压控制的可变电阻,实现电路的可变衰减。
当VDS<<2(VGS-Vth)时,pHEMT管工作在深三极管区,等效电路是R0和C0并联,如图1所示。R0和C0的值取决于管芯子尺寸,且随栅压的变化而变化[5]。在深三极管区,漏极电流ID是VDS的线性函数,源漏之间的沟道可以用一个线性电阻R0表示,其阻值如式(1)[6]:


1.2 压控衰减器电路拓扑
基本的衰减器拓扑有5种,即T型、π型、桥T型、反射式、平衡式。其工作原理是通过控制pHEMT管栅压来控制整个电路的等效电阻,从而改变衰减量。
T型衰减器结构简单,面积小,但两端的输入、输出回波损耗大;π型衰减器结构衰减范围大,端口匹配好;桥T型衰减器是T型结构的一种衍生结构,易匹配[7];反射式衰减器结构输入、输出回波损耗小,但受管芯寄生参数的影响,衰减范围有限,且性能不好;平衡式衰减器结构采用互补电压控制,可以消除最大衰减处的纹波,扩大衰减范围[8]。
2 电路设计
本文设计的双相压控衰减器采用平衡结构。其中,3 dB正交耦合器采用Lange耦合器实现,衰减部分采用T型衰减器和π型衰减器级联拓扑。

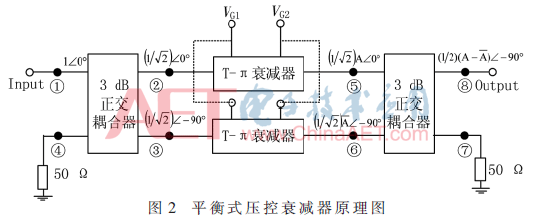
T型π型级联衰减结构如图3所示。控制电压VG1和VG2的电压变化范围为-1.5 V~+1.5 V。引入R1、R2、R3、R4、R5、R6可以减小最大衰减对控制电压的敏感度[10]。并联支路使用双栅pHEMT管,等效为两个尺寸相同的单栅pHEMT管串联,但电路更为紧凑、寄生小[11]。并联支路使用两个双栅pHEMT管串联,可以提升整个电路的功率容量[5]。

3 版图设计与电磁仿真结果
3.1 版图设计
在电路版图设计过程中,为了减小芯片面积,降低成本,在满足电路性能和设计规则的前提下,对Lange耦合器进行弯折,使整体电路布局合理。图4为双相压控衰减器版图。芯片尺寸为1.8 mm×1.2 mm。

3.2 电磁仿真结果
本设计采用0.25 μm GaAs pHEMT工艺,版图电磁(Electromagnetic simulation EM)仿真基于ADS2013仿真软件平台的Momentum仿真工具进行仿真。
图5给出了各个控制电压下电路插入损耗随频率的变化曲线。从图5中可以看出,最小插损为-12.5 dB,整个工作频带内衰减平坦度为±0.1 dB;最大衰减为-31.5 dB,整个工作频带内衰减平坦度为±0.9 dB;衰减范围达到20 dB以上。

图6给出了电路在13 GHz处传输系数S21的幅度和相位随控制电压的变化曲线。从图6中可以看出,当-1.5<VG1<0时,S21>0;当0<VG1<1.5时,S21<0,可以实现双相衰减。
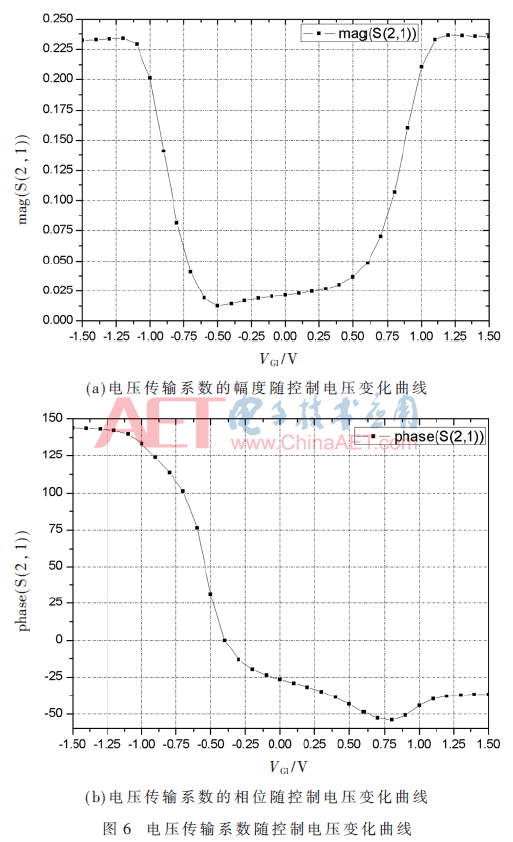
图7仿真条件是在13 GHz处,插入损耗为-12 dB时的仿真结果,Pout曲线为射频输出端口的输出功率曲线,Line线为辅助线。随着输入功率的增大,输出功率增大,当输入功率为30.5 dBm时,插损增大1 dB,则本设计的1 dB压缩点最大为30.5 dBm。

4 结论
本文应用0.25 μm GaAs pHEMT工艺设计了一款13~16 GHz频带的双相压控衰减器。由版图仿真结果可知,输入、输出回波损耗小,插入损耗为-12.5 dB,衰减范围达到20 dB以上,输入1 dB压缩点大于30 dBm,功率容量大,线性度好。本文设计可为国产化双相压控衰减器芯片设计提供参考。
参考文献
[1] BINH L P,DUY P N,ANH V P,et al.High dynamic range X-band MMIC VGLNA for transmit/receive module[C].IEEE Sixth International Conference on Communications and Electronics(ICCE),2016:225-229.
[2] SUN H J,EWAN J.A 2-18 GHz monolithic variable attenuator using novel triple-gate MESFETs[J].IEEE Int.Dig.Microw.Symp.,1990:777-780.
[3] DAOUD S M,SHASTRY P N.A novel wideband MMIC voltage controlled attenuator with a bandpass filter topology[J].IEEE Trans. Microw. Theory and Techn.,2006,54:2576-2583.
[4] RAVI T N,VERMA P,KUMAR A,et al.A broadband high linearity voltage variable attenuator MMIC[C].International Conference on Computers and Devices for Communication,2015.
[5] DUY P N,BINH L P,ANH-V P.A 1.5-45-GHz high-power 2-D distributed voltage-controlled attenuator[J].IEEE Transactions on Microwave Theory and Techniques,2017,65(11):4208-4217.
[6] ROBERTSON I,LUCYSZYN S.单片射频微波集成电路技术与设计[M].文光俊,谢甫珍,李家胤,译.北京:电子工业出版社,2007.
[7] KAUNISTO R,KORPI P,KIRALY J,et al.A Linear-contro wide-band CMOS attenuator[C].The 2001 IEEE International Symposium on Circuits and Systems,2001,4(4):458-461.
[8] SHIREESHA C,SADHU R,HARIKUMAR R.X-Band voltage variable attenuators using PIN diodes[C].IEEE International Microwave and RF Conference,2014:323-326.
[9] POZAR D M.微波工程[M].张肇仪,周乐柱,吴德明,等,译.北京:电子工业出版社,2006.
[10] SUN H J,WU W,EWAN J.A 2-20 GHz Gaas MESFET variable attenuator using a single positive external drive voltage[C].19th European Microwave Conference,1978:1270-1275.
[11] 洪倩,陈新宇,郝西萍,等.多栅GaAs MESFET开关[J].固体研究学与进展,2004,24(2):212-214.
作者信息:
原怡菲,张 博
(西安邮电大学 电子工程学院,陕西 西安

