Rapidus成功开发玻璃基板技术
2025-12-19
来源:芯智讯
12月18日消息,据《日经新闻》报道,日本晶圆代工初创企业Rapidus已成功开发玻璃基板面板级封装(PLP)技术,计划2028年投入量产,拉近与台积电的差距。Rapidus计划于SEMICON Japan 展会上,介绍其在玻璃基板面板级封装(PLP)领域的最新进展。
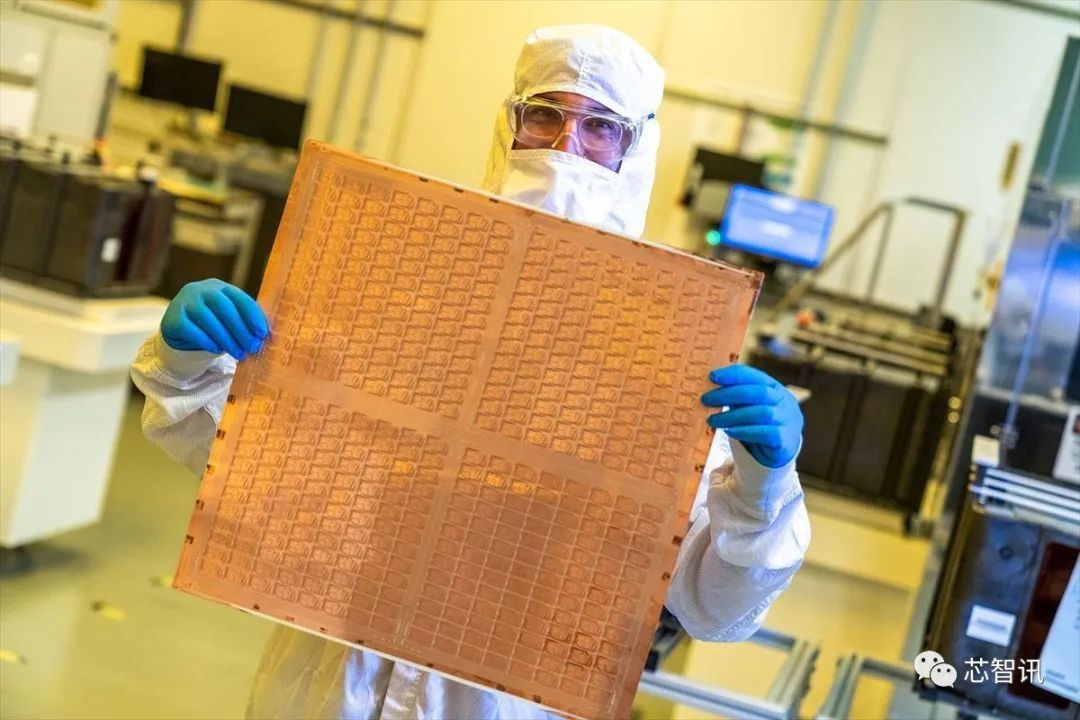
△资料图:英特尔展示玻璃基板
报道称,Rapidus 打造了全球首款以大型玻璃基板切割而成的中介层原型。所谓中介层,是用来承载AI加速器中的GPU与高带宽内存(HBM),并负责各元件之间的互连。
目前的中介层大多是硅基材料,需要直径300毫米的硅晶圆切割而成,由于中介层本身通常为方形,因此产生会浪费不少材料,综合成本较高。相比之下,采用面板级工艺生产的玻璃基板,不仅尺寸可以更大、生产效率更高,且本身是矩形,切割产生的浪费也少。更为关键的是,玻璃基板的成本要远低于硅晶圆。
此外,与目前业界主流的有机基板相比,玻璃基板拥有优秀的热机械性能,热膨胀(CTE)接近硅的同时,还可根据客户设计进行调整开发,支持更高温度下的先进的集成供电;玻璃本身的高刚性也使得其不易变形,可支持尺寸稳定性改进的特征缩放,也可以减少制程中产生的翘曲;玻璃优异的超光滑表面质量,有助于生产更精密的布线层线路;玻璃还拥有优越的电气隔离特性,通过可调节的介电特性,可防止电信号互相干扰,实现优越的电气隔绝效果,可以提升约10倍通孔密度;玻璃还支持比12英寸硅晶圆大外形尺寸;玻璃基板的高透明度也为未来实现光信号集成和高速信号传输奠定基础。
此前,全球半导体制芯片造商当中只有英特尔、台积电、三星在积极研发玻璃基板,相关材料公司Absolix、三星电机、LG Innotek也在发力玻璃基板。AI芯片大厂AMD也积极推动玻璃基板技术的导入。
《日经新闻》报道称,Rapidus 采用的是600×600毫米的方形玻璃基板,可大幅降低切割浪费,使单一玻璃面板可生产的中介层数量提升至原本的10倍。此外,Rapidus 原型中介层的表面积比其他中介层大30%至100%,可容纳更大尺寸的芯片。
不过,玻璃基板的商用还面临一些挑战。比如,玻璃基板材质脆弱,在制程与运输过程中容易破裂,且随着面板尺寸放大,翘曲问题也更加明显。而为了因应这些挑战,Rapidus招募了曾任职夏普(Sharp)等日本显示器大厂的工程师,并于6月在日本千岁市的自有设施洁净室内,展开原型制作。
至于面板级封装(PLP),是指在大型矩形面板上处理芯片封装,而非传统的圆形晶圆。现阶段,面板级封装主要用于某些汽车、电源、射频(RF)与可穿戴装置的扇出型面板级封装(FOPLP),但尚未普及。
相较于晶圆级封装,面板级封装可提供更高效率的制造流程及更大尺寸封装,但目前还没有高阶半导体封装设备能在面板上实现类似前段制程。而用于AI 与HPC 封装的面板级封装技术,英特尔与三星等大厂也仍处于开发阶段。


