文献标识码: A
DOI:10.16157/j.issn.0258-7998.199704
中文引用格式: 韩江安,程序. 太赫兹片上集成放大器研究进展[J].电子技术应用,2019,45(7):19-22.
英文引用格式: Han Jiangan,Cheng Xu. Research progress on terahertz integrated power amplifier[J]. Application of Electronic Technique,2019,45(7):19-22.
0 引言
太赫兹波可以用于研究宇宙产生和演化的辐射、高精度雷达成像以及高比特率通信等领域,是有待发展的重要新兴科学技术。在对宇宙的研究中,来源于外太空的主要电波频率不超过30 THz的频率范围,大部分的频率集中在3 THz附近。当人们将注意力放在空间背景辐射时,主要接收的电磁波频率约为150 GHz。因而对宇宙空间分布的太赫兹波的研究,首先可以探究宇宙的起源和发展过程,并且能够借此解释人类本身的困惑[1]。用于无损探测方面,太赫兹波相比频率低的微波更加接近光波而不失一定的穿透能力,据此特性太赫兹波用于探测可以提供更加出色的成像效果,作为将来雷达探测和无损成像的重点领域,其在最近十多年的电气和电子工程师协会各类会议期刊中保持了旺盛的发展生态,还得到各大公司投入研发力量进行技术攻关投入[2-7]。与用X射线的影像方式比较,利用太赫兹显像对生命体无生物电离伤害,辐射损伤十分有限,而且在空气中有颗粒和高湿度的条件下仍然能保持工作状态。将太赫兹波用于高速率传输,太赫兹频段的系统天生具有高带宽的通信条件,即时基于现有的通信构架,其传输速率可以达到上百Gb/s[8-10]。太赫兹射频链路中,目前源能够通过光电、激光、电真空、混合以及单片集成电路等方案来提供[11-12],为了能够将前述太赫兹波的巨大潜力转化到实际应用中,当下需要解决的一个迫切问题在于需要放大已产生的太赫兹源的信号,并保持一定的带宽特性[13-17]。
如果将源的功率水平考虑为已知条件,当前各种太赫兹源产生方法受制于体积和功率两个要素,阻碍了应用,为了进一步放大信号,需要借助电真空、混合和单片集成的手段。通过电真空方式,行波、速调、返波管输出能力在3种方式中最强,主要应用在对系统指标要求较高的情形,其缺点在于电真空方式往往需要高压高电流环境,占用较多的系统空间,难以与平面电路直接相连,导致系统集成度低,阻碍了其大规模应用场合[18-20]。混合集成的优势在于能够将各种设计理念加工的电路进行整合,为了实现这个目标,需要利用波导过渡等连接结构将各类电路模块拼接组装,批量产品的品控难以保证,因而影响了规模化应用场景[21]。单片集成可以把主动和被动元器件整体化在硅基或者化合物衬底材料上通过光照、刻蚀等工艺制作在一起,目前片上器件能够提供的功率有限,但是具有电路单元紧凑、批量生产可靠性高、可以与多种电路模块实现复杂系统单片集成等优点,并且在微波混合集成方案中作为不可或缺的模块[22-23]。因此,太赫兹放大单片性能的提升,不仅可以增强天线系统的发射能力,对于系统而言还可以增加射频覆盖距离。如应用于太赫兹雷达方面,能够提高显像的分辨率;应用于太赫兹高比特率通信方面,能够减少误码率。并且将放大单元与其他模块集成于一体,可以有效降低成本,推动太赫兹技术大规模市场化水平。
1 太赫兹片上集成化合物功率放大器研究进展
集成电路的设计需要依托于芯片加工工艺线进行,而现有的集成电路工艺根据衬底的不同可以划分为IV和III-V族两类。其中III-V族的集成电路设计可以选择砷化镓(GaAs)基片的应变高电子迁移率晶体管(mHEMT)工艺、磷化铟(InP)基片的高电子迁移率晶体管(HEMT)和异质结双极晶体管(HBT)工艺。IV族元素用于制作集成电路方面,也可以选择异质结双极晶体管器件工艺(HBT),而当前业界采用更多的方案则是互补金属氧化物半导体CMOS工艺。
在几种集成电路工艺中,磷化铟由于电子迁移速率快,可以制成的片上器件截止频率最高。例如由诺斯洛普·格鲁门公司和加州理工飞机推进实验室联合研制的基于高电子迁移率晶体管磷化铟放大器最高工作频率达508 GHz,提供了至少9 dB增益在420~470 GHz的频率范围,如图1所示[24]。由于晶体管在该频段增益极低,该放大器内部集成6级放大单元,每级提供的增益约为1.5 dB。

而该公司发表在IEEE MICROWAVE AND WIRELESS COMPONENTS LETTERS上的同类高电子迁移率晶体管集成单片内部运用伪差分对的结构,在285~345 GHz增益超过20 dB,饱和输出功率达到-1.5 dBm[25]。得益于DARPA项目资助,该公司继续优化高电子迁移率晶体管性能,将特征栅长缩小到30 nm,利用共面波导设计10级之间的连接结构,如图2所示。该放大单片在620~700 GHz的范围内小信号增益超过20 dB[26]。

另外一家美国公司泰洛科技同样与加州理工飞机推进实验室合作研发太赫兹单片,但其设计的芯片基于异质结双极晶体管,在2013年报道太赫兹放大单片在670 GHz增益大于24 dB,输出功率为0.86 mW[27]。中国由中电55所研发的固态太赫兹单片的技术路线同样采用异质结双极晶体管,通过6级单路放大在300 GHz增益7.4 dB,而其功率尚没有参考数据[28]。
基于应变高电子迁移率晶体管的太赫兹放大单片,欧洲的弗劳恩霍夫应用固态物理研究所走在世界前列。于2019年2月发表的功率放大器内部运用多个单元电流加和的方式提高功率,如图3所示,其中心频率为315 GHz,在片测试最高功率为10 dBm[29]。

另外一款运用类似技术的宽带放大单片同样由弗劳恩霍夫研究所开发,如图4所示,片上有源器件的特征栅长35 nm,频率范围覆盖220 GHz~320 GHz。由于末级总的功率合成数只有2路,最大输出功率接近5 dBm[30]。

对比InP和GaAs两种工艺类型的功率放大单片,InP较GaAs容易制成更高频率工作的集成电路。但InP单片往往采用非合成的构架设计太赫兹放大器,因此功率输出能力相比GaAs类型的太赫兹单片弱。因此InP和GaAs太赫兹单片分别在频率和功率上各据优势。
2 太赫兹片上集成硅基功率放大器研究进展
材料硅的载流子迁移率不如砷化镓和磷化铟。但是由于硅基器件大规模应用各类商用集成电路设计场合,各类商用工艺的制造技术最为先进,能够加工的晶体管栅长短,因而改良了其射频特性,并且具有批量生产、可靠一致性和低成本的优势,在最近十年的研究呈爆发的态势。
硅基集成电路中,同样制程下的异质结双极晶体管的工作频率高于互补金属氧化物半导体集成电路。因此异质结双极晶体管更容易设计太赫兹电路。如德国德累斯顿工业大学基于130 nm的SiGe HBT技术,在2017年开发的可变增益放大器调节范围在0~24.7 dB之间,如图5所示,中心频率190 GHz,输出1 dB压缩点-10.2 dBm。虽然其功率较低,但在阵列设计中具有优势[31]。

康奈尔大学同样基于130 nm的异质结双极晶体管管设计了太赫兹非敏感的单端共源共栅放大器,可提供的射频功率约0.52 mW,在179~187 GHz的频率范围小信号增益大于6.5 dB,该技术为提升晶体管在太赫兹频段的增益特性提供了参考[32]。
相比异质结双极晶体管,互补金属氧化物半导体集成电路已被广泛应用于各种消费电子产品中,在降低功耗的驱动力下,互补金属氧化物半导体晶体管栅制作工艺已经降低到10 nm以下。其中由芬兰阿尔托大学微纳科学部研发的全耗尽绝缘体硅技术的太赫兹放大单片最高频率已超过320 GHz,该放大单片的设计几乎达到此工艺条件下互补金属氧化物半导体硅电路的设计上限[33]。因此,在太赫兹频段设计CMOS集成放大单片极具挑战性。国际固态电路会议上,加利福尼亚大学同样尝试在65 nm互补金属氧化物半导体硅上设计CMOS集成放大单片,设计的太赫兹集成放大电路如图6所示,提出了运用功率注入补偿栅极损失的反馈方案,最高在251~273 GHz提供高于6.2 dB增益,最大射频输出为0.41 mW[34]。
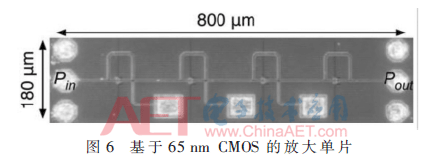
3 结论
本文总结了目前太赫兹放大单片的研究情况,以制作芯片的衬底的不同材料比较,体硅和锗化硅制成的太赫兹集成电路比砷化镓和磷化铟的造价、产量、一致性和集成度更具前景,而由于器件天生的电子迁移率较低,导致用硅基的太赫兹芯片在频率、功率、效率和增益方面尚不如化合物基底设计的芯片,因此二者当前各具优势,互相难以替代。从电路设计结构比较,磷化铟芯片虽然目前设计频率较高,但是较少有太赫兹大功率集成放大器的报道,而砷化镓基片上的应变高电子迁移率晶体管通过多路合成的形式,已经太赫兹频段高功率方面的优势得以初步显现。硅基电路由于器件本身增益较低,多数电路设计尚处于功能实现的阶段,但其在控制和系统复杂度上有潜力挖掘。
参考文献
[1] CHATTOPADHYAY G.Terahertz science,technology,and communication[M].Kolkata:IEEE,2012.
[2] WOOLARD D L,BROWN E R,PEPPER M,et al.Carbon isotope,terahertz frequency sensing and imaging: a time of reckoning future applications?[J].Proceedings of the IEEE,2005,93(10):1722-1743.
[3] APPLEBY R,ANDERTON N R.Millimeter-wave and submillimeter-wave imaging for security and surveillance[J].Proceedings of the IEEE,2007,95(8):1683-1690.
[4] LIU H B,ZHON H,KARPOWICZ N.Terahertz spectroscopy and imaging for defense and security applications[J].Proceedings of the IEEE,2007,95(8):1514-1527.
[5] KOWALSKI M,KASTEK M.Comparative studies of passive imaging in terahertz and mid-wavelength infrared ranges for object detection[J].IEEE Transactions on Information Forensics & Security,2016,11(9):2028-2035.
[6] Gao Jingkun,Cui Zhenmao,Cheng Binbin,et al.Fast three-dimensional image reconstruction of a standoff screening system in the terahertz regime[J].IEEE Transactions on Terahertz Science and Technology,2018,8(1):38-52.
[7] GRAJAL J,RUBIO-CIDRE G,BADOLATO A,et al.Compact radar front-end for an imaging radar at 300 GHz[J].IEEE Transactions on Terahertz Science and Technology,2017,7(3):268-273.
[8] SONG H J,NAGATSUMA T.Present and future of terahertz communications[J].IEEE Transactions on Terahertz Science Technology,2011,1(1):256-263.
[9] JORNET J M,AKYILDIZ I F.Channel modeling and capacity analysis for electromagnetic wireless nanonetworks in the terahertz band[J].IEEE Transactions on Wireless Communication,2011,10(10):3211-3221.
[10] LIN C,LI G Y.Indoor terahertz communications:how many antenna arrays are needed?[J].IEEE Transactions on Wireless Communication,2015,14(6):3097-3107.
[11] TONOUCHI M.Cutting-edge terahertz technology[J].Nature Photon.,2007,1:97-105.
[12] SIEGEL P H.Terahertz technology[J].IEEE Transactions on Microwave Theory & Techniques,2002,50(3):910-928.
[13] HOSAKO I,SEKINE N,PATRASHIN M,et al.At the dawn of a new era in terahertz technology[J].Proceedings of the IEEE,2007,95(8):1611-1623.
[14] JONES S,KIM J Y,DOI Y,et al.Ultra-wideband tunable dual-mode laser for continuous wave terahertz generation[J].Journal of Lightwave Technology,2014,32(20):3461-3467.
[15] KIRAWANICH P,YAKURA S J,ISLAM N E.Study of high-power wideband terahertz-pulse generation using integrated high-speed photoconductive semiconductor switches[J].IEEE Transactions on Plasma Science,2009,37(1):219-228.
[16] YARDIMCI N T,YANG S H,BERRY C W,et al.High power terahertz generation using large area plasmonic photoconductive emitters[J].IEEE Transactions on THz Science Technology,2015,5(2):223-229.
[17] HEBLING J,YEH K L,HOFFMANN M C,et al.High-power THz generation,THz nonlinear optics,and THz nonlinear spectroscopy[J].IEEE Journal of Selected Topies Quantum Electronics,2008,14(2):345-353.
[18] BOOSKE J H,DOBBS R J,JOYE C D,et al.Vacuum electronic high power terahertz sources[J].IEEE Transactions on Terahertz Science & Technology,2011,1(1):54-75.
[19] JOYE C D,COOK A M,CALAME J P,et al.Demonstration of a high power,wideband 220 GHz traveling wave amplifier fabricated by UV-LIGA[J].IEEE Transactions on Electron Devices,2014,61(6):1672-1678.
[20] DIONNE N J.Harmonic generation in octave bandwidth traveling-wave tubes[J].IEEE Transactions on Electron Devices,1970,17(4):365-372.
[21] SONG H J.Packages for terahertz electronics[J].Proceedings of the IEEE,2007,105(6):1-18.
[22] DEAL W R.Solid-state amplifiers for terahertz electronics[M].Anaheim:IEEE,2010.
[23] SAMOSKA L A.An overview of solid-state integrated circuit amplifiers in the submillimeter-wave and thz regime[J].IEEE Transactions on Terahertz Science and Technology,2011,1(1):9-24.
[24] SAMOSKA L,FUNG A,PUKALA D,et al.On-wafer measurements of S-MMIC amplifiers from 400-500 GHz[M].Baltimore:IEEE,2011.
[25] HACKER J,LEE Y M,PARK H J,et al.A 325 ghz inp hbt differential-mode amplifier[J].IEEE Microwave and Wireless Components Letters,2011,21(5):264-266.
[26] DEAL W R,MEI X B,LEONG K,et al.Terahertz monolithic integrated circuits using InP high electron mobility transistors[J].IEEE Transactions on Terahertz Science Technology,2011,1(1):25-32.
[27] HACKER J,URTEAGA M,SEO M,et al.InP HBT amplifier MMICs operating to 0.67 THz[M].Seattle:IEEE,2013.
[28] 孙岩,程伟,陆海,等.300 GHz InP DHBT单片集成放大器[J].固体电子学研究与进展,2017(4):299.
[29] JOHN L,NEININGER P,FRIESICKE C,et al.A 280-310 GHz InAlAs/InGaAs mHEMT power amplifier MMIC with 6.7-8.3 dBm output power[J].IEEE Microwave and Wireless Components Letters,2019,29(2):143-145.
[30] TESSMANN A.A broadband 220–320 GHz medium power amplifier module[M].La Jolla:IEEE,2010.
[31] STARKE P,FRITSCHE D,CARTA C,et al.A 24.7 dB low noise amplifier with variable gain and tunable matching in 130 nm SiGe at 200 GHz[M].Nuremberg:IEEE,2017.
[32] KHATIBI H,KHIYABANI S,AFSHARI E.A 183 GHz desensitized unbalanced cascode amplifier with 9.5-db power gain and 10-GHz band width and -2 dBm saturation power[J].IEEE Solid-State Circuits Letters,2018,1(3):58-61.
[33] PARVEG D,KARACA D,VARONEN M,et al.Demonstration of a 0.325-THz CMOS amplifier[M].Finland:IEEE,2016.
[34] MOMENI O.A 260 GHz amplifier with 9.2 dB gain and -3.9 dBm saturated power in 65 nm CMOS[M].San Francisco:IEEE,2013.
作者信息:
韩江安1,2,程 序1,2
(1.中国工程物理研究院微系统与太赫兹研究中心,四川 成都610299;
2.中国工程物理研究院电子工程研究所,四川 绵阳621900)

