台积电展示新一代封装技术提升AI芯片性能
2024-02-23
来源:财联社
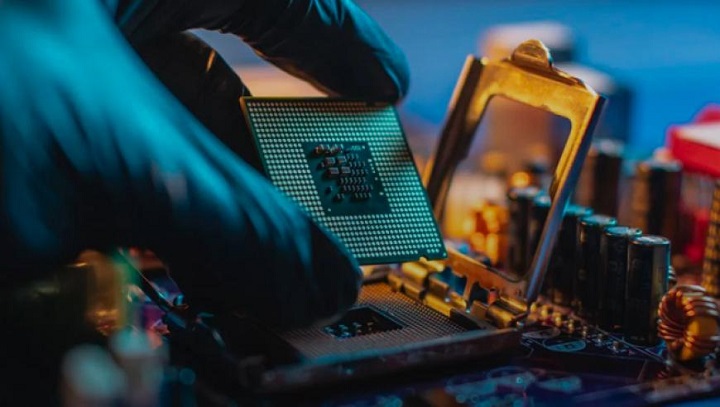
在 2 月 18 日 -22 日召开的 ISSCC 2024 上,台积电又带来了一项新技术。
ISSCC 全称为 International Solid-State Circuits Conference(国际固态电路会议),是学术界和工业界公认的全球集成电路设计领域最高级别会议,更被看作集成电路设计领域的 " 芯片奥林匹克大会 "。
在今年这场大会上,台积电向外界介绍了用于高性能计算与 AI 芯片的全新一代封装技术,在已有的 3D 封装基础上,又整合了硅光子技术,以改善互联效果、降低功耗。
据台积电业务开发资深副总裁张晓强介绍,这项技术旨在帮助封装更多 HBM 与 Chiplet 小芯片,进而提升 AI 芯片的性能。
就目前情况而言,若想增加更多的 HBM 与 Chiplet 小芯片,就必须增加更多零部件与 IC 载板,可能导致连接与能耗方面出现问题——因此便需要硅光子技术。
台积电的这一封装技术,通过硅光子技术,使用光纤替代传统 I/O 电路传输数据。不仅如此,在该封装架构中,异构芯片堆叠在基础芯片顶部,并使用混合键合技术,以最大限度地提高 I/O 性能。

图 | 新一代用于高性能计算与 AI 芯片封装技术平台

图 | 目前用于高性能计算与 AI 芯片封装技术平台
在新一代封装技术平台示意图中,还出现了 CPO。张晓强指出,硅光子是 CPO 的最佳选择。

此外张晓强表示,当今最先进的芯片可容纳多达 1000 亿个晶体管,但有了先进 3D 封装技术,可以扩展至单颗芯片包含 1 万亿个晶体管。

台积电并未透露新一代封装技术的具体商业化时间。
但值得注意的是,去年以来,台积电已频频传出布局硅光及 CPO 的动向。
2023 年 9 月曾有消息称,台积电正与博通、英伟达等大客户联手开发硅光及 CPO 光学元件等新品,最快 2024 年下半年开始迎来大单,2025 年有望迈入放量产出阶段。
彼时业内人士透露,台积电未来有望将硅光技术导入 CPU、GPU 等运算制程当中,内部的电子传输线路更改为光传输,计算能力将是现有处理器的数十倍起跳。
而台积电副总裁之前曾公开表示,如果能提供一个良好的 " 硅光整合系统 ",就能解决能耗与 AI 运算能力两大关键问题," 这会是一个新的典范转移。我们可能处于一个新时代的开端。"
业内分析称,高速资料传输目前仍采用可插拔光学元件,随着传输速度快速进展并进入 800G 时代、未来更将迎来 1.6T 至 3.2T 等更高传输速率,功率损耗及散热管理问题将会是最大难题。而半导体业界推出的解决方案,便是将硅光子光学元件及交换器 ASIC,通过 CPO 封装技术整合为单一模组,此方案已开始获得微软、Meta 等大厂认证并采用在新一代网路架构。


