文献标识码: A
文章编号: 0258-7998(2011)03-0086-05
混合式红外焦平面探测器在军事上有着重要的应用[1]。目前,国内相关的器件研制还不太成熟,其中一个重要的原因就是绝热层结构、电互连可靠性等工艺实现困难[2]。为改变红外焦平面阵列倒装互连工艺困难的状况,本文设计了微型通孔加工及电极互连工艺,即在硅读出电路上进行红外焦平面阵列倒装互连。微电子机械技术进步带动了混合式红外焦平面探测器向小型化、集成化、低成本、高可靠的方向发展,3-D MCM封装的关键技术是IC芯片的垂直互连工艺。硅通孔垂直互连技术作为信号线的引出方式能较好地解决信号延迟这一问题,系统的寄生电容、引线电阻显著减小,从而使系统的总功耗降低30%左右[3],增加电气性能的同时减小器件的尺寸和重量[4]。采用BN-303紫外光刻胶图像反转的剥离工艺,深硅刻蚀实现的贯穿硅通孔技术,可以满足红外焦平面探测器中底电极与引线制备工艺。用于混合式红外焦平面探测器电互连的微金属柱较一般器件中金属引线薄膜厚度要大得多,厚度超过100 μm。由于溅射和蒸发电极属于表面工艺,小尺寸结构侧壁金属粒子附着差,即使采用正胶剥离工艺,胶膜厚度要达到金属电极薄膜厚度的几倍,而胶厚的增加势必降低光刻分辨率,这就无法满足微柱线宽小、电极厚度高的要求,电互连不可靠,也不经济。通孔制备与导电浆料填注通孔电极互连技术是混合式红外焦平面探测器制备技术新的思路。
1 焦平面倒装焊、互连设计
混合式焦平面探测器由铁电材料敏感像元阵列和CMOS读出电路芯片倒装焊电极构成。红外焦平面探测器像元自下而上由硅衬底、绝热结构、下电极、热释电层、上电极和吸收层组成。厚膜结构的探测器在下电极和基底之间加入低热导率的多孔SiO2作为绝热层。采用钛酸锶钡(BST)厚膜制备热释电红外探测器,热释电厚膜红外探测器的灵敏度主要取决于材料热释电系数和衬底热阻,热阻越大,灵敏度就越高。
目前国内外普遍采用像元/衬底间悬空结构[5],该措施绝热效果最佳,像元能承受的过载加速度有限,工艺复杂。具有“桌形”绝热框架支撑的微桥结构像元,减小了微桥的热导率,提高像元的结构可靠性。本文设计像元尺寸为200 μm×200 μm,其中Si层厚240 μm;SiO2层厚1μm;上下Pt/Ti电极层厚0.1μm;BST层厚10 μm;上电极Pt/BST层宽200 μm;微桥/下电极Pt宽300 μm。铁电材料的作用是将红外辐射转变成电信号,倒装焊电极将电信号与集成读出电路连接,将每个探测元的信号读出,变空间分布的电信号为时序信号,以便于实现凝视热成像,微桥结构与电极互连如图1所示。

倒装焊技术在混合式红外焦平面探测器中的应用如下:如图2所示的包含16×16个像元的面阵,每个像元单元至少有一个电输入或输出引脚与逻辑处理电路输入焊盘一一对应,专用CMOS集成电路芯片信号引线连接,仅在几平方毫米的区域中要利用引线键合的方式来实现这上百个输入和输出端口根本是不可能的,倒装焊却完全能够胜任,硅基片微型通孔进行电信号的传输,有助于减小基片单面布线的复杂程度,提高阵列器件的排列密度。

目前,商业化的红外探测器阵列组件的光敏芯片和读出电路是分开制备的。在读出电路表面制备与探测器芯片电极一一对应的铟柱,互连时把探测器芯片上的电极与读出电路上的铟柱面对面一一对准,通常采用重叠影像的方式来实现对准,压焊在一起。
2 硅基片微型通孔加工技术
目前主要有四种不同的硅通孔互连制作技术[6]:湿法刻蚀、激光加工、深层等离子体刻蚀和光辅助电化学刻蚀。光辅助电化学刻蚀可以制造的最小孔径很小,但由于其内壁比较粗糙给电绝缘层的制作带来很多不便;激光打孔是串行操作,加工效率低,更重要的是孔和孔之间相对位置的精确度完全靠进给机构保证,在孔阵列加工时易产生累积误差。光刻工艺加工孔阵列是并行的,可以同时加工出阵列中所有的孔,孔和孔之间相对位置的精确度取决于光刻模板设计的精度以及光刻时的传递精度,是加工大规模孔阵列时的首选方案。深层等离子体刻蚀工艺制作的通孔内壁平滑,对硅片的机械及物理损伤最小,是制作硅通孔的最佳选择之一,但其制作成本较高,仅限用于高密度、小尺寸、深宽比较大的硅基片微型通孔加工;湿法刻蚀是最常规的一种方法,能够比较好地对刻蚀过程进行控制。用于混合式红外焦平面探测器导电通孔,孔径为30 μm~100 μm。不同器件对硅基片的厚度有不同的要求,常见的硅基片的厚度小于300 μm,因此硅基片微型通孔的深宽比一般为几到几十[7]。
KOH溶液的湿法刻蚀是一种低刻蚀温度、低制造成本且适合于批量生产的硅通孔制作工艺。此方法简便易行,而且湿法刻蚀设备是半导体加工和微细加工常见而且必备的设备。由于KOH溶液对硅单晶的各向异性腐蚀特性,这使得刻蚀出的通孔实际上是倒金字塔形,孔壁不与硅片表面垂直,且(111)晶面与(100)晶面间的夹角为54.74°。这就造成通孔两端尺寸差别很大,在硅片背面会被占去很大部分的面积,硅通孔的表面上窗口宽度Wa=Wb+2Lctg54.74°,其中Wb为底平面的宽度,L为腐蚀深度,其结构示意图见图3。因此,其制作的硅通孔为非垂直的且宽度较大,只能满足低到中等引出端数封装的要求。一般厚度为300 μm左右的硅片要采用双面刻蚀的方式,提高硅表面利用效率,有利于改善通孔加工质量。

单晶硅腐蚀用得最多的是四甲基氢氧化铵腐蚀液(简称TMAH)。TMAH腐蚀液去除沾污方便,且腐蚀速度也较快,对SiO2掩膜基本不腐蚀。TMAH与硅的反应机理是,TMAH的水溶液与硅反应,其反应式为:
Si+2OH-+2H2O→ SiO2(OH)2-2+2H2↑
为了获得TMAH优化的腐蚀液配方和腐蚀条件,进行了TMAH腐蚀液配方和温度对硅刻蚀的影响的实验。实验方法是首先在[100]晶向的硅片上生长一层氧化硅,然后光刻形成刻蚀窗口。将实验片放入不同配比腐蚀液和不同温度中腐蚀30 min,然后用台阶测试仪测试腐蚀的深度,从而计算出腐蚀硅的速度。通过比较得到较好的TMAH腐蚀液配方和腐蚀温度工艺如表1所示。

从表1的实验结果可以看出,这种配比的腐蚀液对[100]晶向的硅腐蚀速度较快,腐蚀效果较好,由于TMAH在与硅反应中要释放出氢气,因此在腐蚀液中会产生氢气泡,局部抑制了TMAH对硅接触,造成局部腐蚀速度变慢,从而出现表面有金字塔形的小丘[8,9]。为了降低或消除这种金字塔形的小丘,在腐蚀液中加入异丙醇,利用异丙醇的挥发性尽快带走反应产生的氢气,抑制氢气泡的产生,使腐蚀液腐蚀速度均匀,避免出现金字塔小丘的现象,异丙醇过量,硅表面发黑[10,11]。
由Technical University of Denmark[12](丹麦技术大学)开发的,用KOH湿法刻蚀制作硅通孔的工艺,KOH溶液的浓度为25%、刻蚀温度为80℃、刻蚀速率为1.25 μm/min。其开发的硅通孔互连的体电阻为40 mΩ、对硅衬底的寄生电容为2.5 pF,被设计应用于高端便携式产品的三维封装中。斯坦福的CHOW E M等人[13]用双面刻蚀的方式在厚400 μm的硅片上加工出直径为20 μm的通孔,深宽比达20。
3 焦平面探测器阵列电极工艺
红外焦平面探测器敏感元上、下电极的图形化制备,通常采用金属Pt作为底电极,由于没有合适的溶液对它们进行有效腐蚀的同时又不破坏保护层(即光刻胶),故采用剥离技术解决电极的图形化问题[13]。
剥离技术(lift-off)是将Si/SiO2基片用标准的硅片清洗工艺进行清洗,在衬底上涂覆一层较厚的光刻胶,光刻形成图形;接着在其上溅射或蒸度淀积金属薄层,存在窗口的地方金属就会淀积到基底上。为了实现良好的金属剥离,金属膜厚不能超过剥离层膜厚的2/3[14],同时光刻窗口的剖面必须整齐且形成下宽上窄的正“八”字图形。Lift-off工艺制备Pt/Ti电极是在光刻工艺的基础上增加了溅射或蒸度金属膜和去胶工艺,流程如图4所示。
图5所示即为利用lift-off工艺得到的Si基Pt/Ti电极微细图形,引线宽度为20 μm,厚度为100 nm。从图中可以看出,线条边缘较为齐整,总体缺陷较少。经过后续工艺中加热至800℃的测试证明,线条附着性良好,没有出现翘边等现象,电性能也满足使用要求。
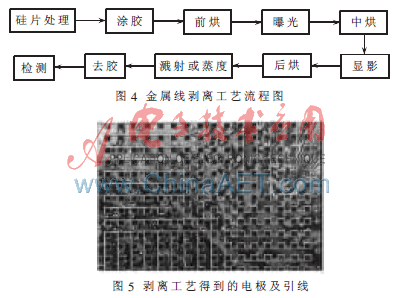
红外焦平面探测器制作过程中,常常需要将阵列电极和信号处理电路连接,即要实现接触孔的电互连结构,在接触孔和上层传感器结构之间建立一个金属互连柱。采用剥离技术来制作金属互连柱是不可行的,实验证明:金属电极剥离技术是平面工艺,溅射或蒸发制备金属薄膜台阶覆盖能力差,互连金属柱高小于2.0 μm,孔、槽内壁金属薄膜生长能力差,不能满足电性能互连。
4 微型笔直写技术制备电极互连
红外焦平面阵列探测器大规模集成,小批量生产,现有的互连工艺不能满足要求。器件的不断小型化要求互连线更窄、芯片的集成度更高,互连导线出现短路或者断路的几率明显加大,产品废品率大幅度上升。目前,红外焦平面阵列探测器电极互连布线最有可能使用的工艺有:(1)厚膜丝网印刷工艺;(2)Fodel光刻成图技术;(3)微型笔直写技术。
厚膜丝网印刷工艺指使用漏网或掩模按照给定的图案有选择地沉积厚膜材料,形成电路的制备技术。目前厚膜集成电路工艺已达到线宽/间距150~200 μm,印刷厚膜电路使用的浆料,其主要成分为金、银、铂、钯等,一般来说掩模制作周期长,费用高;掩模一旦制成后,不能再修改,对于出现问题的电路板,也不易进行修复。 Fodel光刻成图技术是美国Dupont公司光敏浆料系列的一个品牌,是一种适合制造细线条、小间距导体材料的电子浆料。该电子浆料在普通的厚膜材料中加入光敏聚合物,使之可利用光致抗蚀原理,通过掩模紫外曝光,水显影而获得电路。采用Fodel材料及工艺可以制作通常要用昂贵的薄膜工艺方能制作的电路,该类材料有各类Au、Pt/Ag导电浆料,线宽/间距为20 μm~100 μm,烧结膜层厚度为5 μm~6 μm。微型笔直写技术是一种新型的厚膜制备技术,它无需光刻、掩模制版等成膜工艺准备过程,只要利用CAD的数据就可以在各种基板上直写导体、电阻、电容等电子元器件,最小线宽30 μm[15]。
将传统的激光熔覆技术与直写技术相结合,提出了一种新的布线技术——激光微细熔覆柔性布线技术。该技术与传统的厚膜电路工艺相比,具有精度高、工艺简单灵活、制作周期短、无污染等优点。该工艺具有产品研制周期短、工艺参数易控制、线条细密均匀且分辨率高、修改设计便捷、工艺更灵活更经济等优点[16]。
实验装置如图6所示,该系统由气源、微型笔、计算机控制系统、工作台和监视系统等主要部件构成。微型笔的工艺原理借鉴了注射成型的原理,把浆料腔内的浆料挤压出微型笔头,并以注射式涂覆的方式在系统控制单元的控制下,将浆料直接沉积在基板上,从而得到预先设计的图案。

直写基片采用硅基板,导电浆料为自配置的高温银导体浆料,导线及电极选用方阻为4 mΩ的Ag-Pd导体浆料,黏度为300 Pa·s。激光器为波长1.07 μm连续Ytterbium光纤激光器,激光功率50 W以下连续可调,最小光斑直径20 μm,扫描速度≥2 mm/s,实验主要工艺流程如图7所示。线宽是衡量电路集成度的一个重要指标。激光直写工艺下导线理论最小线宽应等于激光光斑的大小,本实验中所使用激光器最小聚焦光斑为20 μm,由于不可避免的激光热区扩散影响的存在,目前实验最小线宽可做到30 μm。除激光器本身光斑大小影响外,预置涂层厚度、激光功率和激光扫描速度对导体线宽有很大的影响。

厚膜电阻浆料最为常用的是Ag-Pd电阻浆料及钌系电阻浆料。其固态成分主要是:导电相、Ag-Pd或者二氧化钌及钌酸盐;粘结相,硼硅酸铅玻璃;少量为改善电阻浆料性能而添加的金属氧化物,如Al2O3,MnO2等。其液态成分主要是有机粘合剂,如松油醇、乙基纤维素等,典型的烧成温度850℃。激光扫描的作用主要是实现初步的附着,而要想最终得到性能稳定、结合牢靠的电阻还需要利用传统的高温烧结方法回炉中烧结。
微型笔直写互连导线微观形貌与导电通孔示意如图8所示,线条清晰均匀[17]。经测试,导体附着完整,与传统工艺制备的导体相当,可满足工业实际要求。电气性能优良,方阻<6 mΩ,可满足市场要求,可焊性好。成分相似的浆料制备的导体导电性能区别不明显,即导电性的衡量参数-方阻值主要取决于浆料本身。目前激光直写导体厚度2~10 μm,可做到的最小线宽/间距为30 μm/30 μm,微型笔直写灌注Ag-Pd电子浆料及钌系电子浆料填充微通孔相对经济适用。

探测器噪声强度取决于互连线中信号传输的热噪声和互连线阻抗不均匀或与功能块的阻抗不匹配产生的反射噪声。微型通孔垂直互连技术是一个实现互连线长度最短的封装形式,由于减少了互连线的长度,因此也减少了噪声,改善信号延迟。
与传统封装相比,微型通孔垂直互连技术可使系统尺寸与重量降低到原来的1/40~1/50;提高了硅片的使用效率,与平面引线互连比较,效率从50%提高90%。硅通孔互连技术提高硅片表面应用效率,提高像元占空比,减小红外焦平面尺寸和体积,改善信号延迟、降低噪声和功耗。硅通孔互连技术依然面临更小通孔的制作、通孔内无缺陷金属化和互连线与硅衬底电绝缘的形成等技术上的挑战,通过改善工艺,硅通孔互连技术能为混合式红外焦平面阵列电极互连提供更优的解决方案。
参考文献
[1] 苏吉儒,魏建华,庄继胜.赴向21世纪的非制冷热成像技术[J].红外与激光工程,1999,28(3):41-45.
[2] 袁宁一,李格,李金华,等.微测辐射热计的红外热响应模拟[J].红外与毫米波学报,2006,25(3):183-187.
[3] 杨建生.BGA多芯片组件及三维立体封装(3D)技术[J].电子与封装,2003,3(1):34-38.
[4] BIOHK.EMC-3D联盟瞄准经济的TSV互连[J].集成电路 应用,2007,19(5):47-48.
[5] SENESAE L R,CORBEILA J L,RAJIC S,et al. IR imaging using uncooled microcantilever detectors[J].Ultramicroscopy, 2003,97(4):51-58.
[6] SATOH A. Interconnection of stacked layers by bumpless wiring in wafer-level three-dimenstional device[J].IEICE Trans Electron,2001,(VE84-C):1746-1755.
[7] CHOW E M,CHANDRASEKARAN V,PARTRIDGE A,et al.Process compatible polysilicon based electrical through-wafer interconnects in silicon substrates[J].Journal of Microelecromechanical Systems,2002(11):631-640.
[8] RASMUSSEN F E, HESCHEL M, HANSEN O. Clave test on anisotropic conductive joints[J]. Microelectronics Reliability, 2003(43):279-285.
[9] CHOW E M, PARTRIDGE A,QUATE C F,et al. Throughwafer electrical interconnects compatible with standard semiconductor processing[A].Solid-State Sensor Actuator Workshop 2000[C]. Clevelan (USA):Transducers Res Found,2000:343-346.
[10] TAN S, REED M, HAN H,et al. Mechanisms of etch hillock formation[J]. Microelectromechanical Systems,1996:66-72.
[11] NIJDAM A J,VEENENDAAL E V,CUPPEN H M. Formation and stabilization of pyramidal etch hillocks on silicon(100) in anisotropic etchants:experiments and monte carlo simulation [J]. Journal of Applied Physics,2001,89(7):4113-4123.
[12] TANAKA H, YAMASHITA S. Fast etching of silicon with a smooth surface in high temperature ranges near the boiling point of KOH solution [J]. Sensors and Actuators A,2004,114:516-520.
[13] YANG C R, CHEN P Y. Effects of various ion-typed surfactants on silicon anisotropic etching properties in KOH and TMAH solutions [J]. Sensors and Actuators A,2005, 119: 271-281.
[14] BARKER N S,REBEIZ G M. Distributed MEMS truetime delay phase shifter and wide-band switches[J]. IEEE Trans on MTT,1998,46(11):1-10.
[15] 刘敬伟,曾晓雁.激光直写技术的现状和展望[J].激光杂志,2001,22(6):15-18.
[16] LI Hui Ling,ZENG Xiao Yan,LI Hui Fen, et aL.Research on film thickness of conductive line formed by laser microfine cladding and flexibly direct writing technique[J]. Chinese Optics Letters,2004,2(11):654-657.
[17] 祁晓敬,李祥友,曾晓雁.线路板表面激光微细熔覆金属有机浆料直写布线技术研究[J].中国激光,2004,31(7):883-887.

