文献标识码: A
文章编号: 0258-7998(2013)03-0064-03
目前,功率MOSFET管广泛地应用于开关电源系统及其他功率电子电路中。实际应用中,特别是在一些极端的边界条件下,如系统的输出短路及过载测试、输入过电压测试以及动态的老化测试中,功率MOSFET管有时候会发生失效损坏。工程师将损坏的功率MOSFET管送到半导体原厂做失效分析后,分析报告的结论通常是过电性应力EOS,却无法判断是什么原因导致MOSFET的损坏。
本文将通过功率MOSFET管的工作特性,结合失效分析图片中不同的损坏形态,系统地分析过电流损坏和过电压损坏。同时根据损坏位置不同,分析功率MOSFET管的失效发生在开通的过程中或发生在关断的过程中,从而为设计工程师提供一些依据,找到系统设计中的问题,提高电子系统的可靠性。
1 过电压和过电流测试电路
过电压测试的电路图如图1(a)所示,选用40 V的功率MOSFET:AON6240,DFN5?鄢6封装。通过开关来控制,将60 V的电压直接加到AON6240的D极和S极,熔丝用来保护测试系统,功率MOSFET损坏后,将电源断开。测试样品数量为5片。

过电流测试的电路图如图1(b)所示,选用40 V的功率MOSFET:AON6240,DFN5?鄢6封装。首先合上开关A,用20 V的电源给大电容充电,电容C的容值为15 mF,然后断开开关A,合上开关B,将电容C的电压加到功率MOSFET管的D极和S极,使用信号发生器产生一个电压幅值为4 V、持续时间为1 s的单脉冲,加到功率MOSFET管的G极。测试样品数量为5片。
2 过电压和过电流失效损坏
将过电压和过电流测试损坏的功率MOSFET管去除外面的塑料外壳,露出硅片正面失效损坏的形态的图片,分别如图2(a)和图2(b)所示。
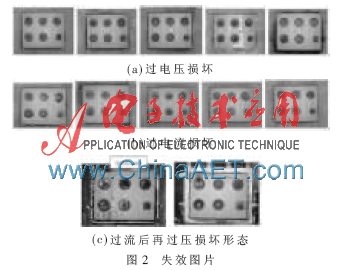
从图2(a)可以看到,过电压的失效形态是在硅片中间的某一个位置产生一个击穿小孔洞,通常称为热点,其产生的原因就是因为过压而产生雪崩击穿,在过压时,通常导致功率MOSFET管内部的寄生三极管导通[1]。由于三极管具有负温度系数特性,当局部流过三极管的电流越大时,温度越高。而温度越高,流过此局部区域的电流就越大,从而导致功率MOSFET管内部形成局部的热点而损坏。硅片中间区域是散热条件最差的位置,也是最容易产生热点的地方,可以看到,图中击穿小孔洞(即热点)正好都位于硅片的中间区域。
从图2(b)可以看到,在过流损坏的条件下,所有的损坏位置都发生在S极,而且比较靠近G极。这是因为电容放电形成大的电流流过功率MOSFET管,所有的电流汇集于S极,此时温度最高,最容易产生损坏。
功率MOSFET管内部由许多单元并联形成,如图3(a)所示。其等效的电路图如图3(b)所示。在开通过程中,离G极越近的区域,VGS的电压越高,流过该区域的单元电流越大,在瞬态开通过程承担的电流就越大。因此,离G极近的S极区域温度更高,更容易因过流产生损坏。

3 过电压和过电流混合失效损坏
在实际应用中,单一的过电流和过电流的损坏通常很少发生,更多的损坏发生在过流后,由于系统的过流保护电路工作,关断功率MOSFET,而在关断的过程中常发生过压(即雪崩)。图2(c)即为功率MOSFET管先发生过流,然后进入雪崩发生过压的损坏形态。与过流损坏形式类似,过压多发生在靠近S极的地方。但是也存在因为过压产生的击穿洞坑远离S极的情况。这是因为在关断的过程,距离G极越远的位置,在瞬态关断过程中,VGS的电压越高,承担电流也越大,因此更容易发生损坏。
4 线性区大电流失效损坏
在电池充放电保护电路板上,一旦负载发生短线或过流电,保护电路将关断功率MOSFET管,以免电池产生过放电。与短路或过流保护快速关断方式不同,功率MOSFET管是以非常慢的速度关断,如图4所示。功率MOSFET管的G极通过一个1 MΩ的电阻,缓慢关断。从VGS波形上看到,米勒平台的时间高达5 ms。米勒平台期间,功率MOSFET管工作在放大状态,即线性区。
功率MOSFET管开始工作的电流为10 A,使用器件为AO4488,失效的形态如图4(c)所示。当功率MOSFET管工作在线性区时,它是负温度系数[2],局部单元区域发生过流时,同样会产生局部热点。温度越高,电流越大,致使温度进一步增加,导致过热损坏。可以看出,其损坏的热点的面积较大,这是因为该区域经过了一定时间的热量的积累。另外,破位的位置离G极较远。损坏同样发生于关断过程,破位的位置在中间区域,同样也是散热条件最差的区域。
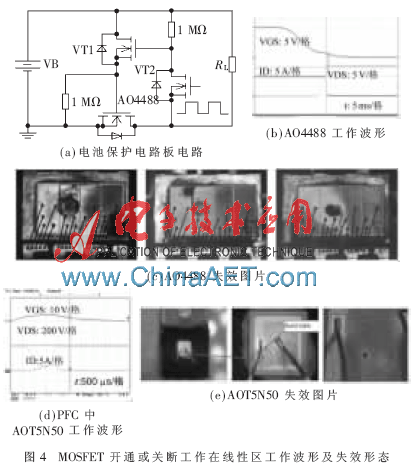
另外,在功率MOSFET管内部,局部性能弱的单元,其封装形式和工艺都会对破位的位置产生影响。
不仅如此,一些电子系统在起动的过程中,芯片的VCC电源(也是功率MOSFET管的驱动电源)建立比较慢。如在照明中,使用PFC的电感绕组给PWM控制芯片供电,在起动的过程中,功率MOSFET管由于驱动电压不足,容易进入线性区工作。在进行动态老化测试时,功率MOSFET管不断地进入线性区,工作一段时间后,就会形成局部热点而损坏。
使用AOT5N50作测试,G极加5 V的驱动电压,做开关机的重复测试,电流ID=3 A,工作频率为8 Hz。重复450次后,器件损坏,波形和失效图片如图4(b)和图4(c)所示。可以看到,器件形成局部热点,而且离G极比较近。因此,器件是在开通过程中,由于长时间工作于线性区而发生损坏。
图4(e)是器件 AOT5N50在一个实际应用中,在动态老化测试过程发生失效的图片。起动过程中,MOSFET实际驱动电压为5 V,MOSFET工作在线性区,失效形态与图4(c)相同。
功率MOSFET单一的过电压损坏形态通常是在中间散热较差的区域产生一个局部的热点,而单一的过电流的损坏位置通常是在电流集中的靠近S极的区域。实际应用中,通常先发生过流,短路保护MOSFET关断后,又经历雪崩过压的复合损坏形态。如果损坏位置距离G极近,则开通过程中损坏的几率更大;如果损坏位置距离G极远,则关断开通过程中损坏几率更大。功率MOSFET管在线性区工作时,产生的失效形态也是局部的热点,热量的累积影响损坏热点洞坑的大小。散热条件是决定失效损坏发生位置的重要因素,芯片的封装类型及封装工艺影响芯片的散热条件。另外,芯片生产工艺产生单元性能不一致而形成性能较差的单元,也会影响到损坏的位置。
参考文献
[1] 刘松.基于漏极导通区特性理解MOSFET开关过程[J]. 今日电子,2008(11):74-75.
[2] 刘松.理解功率MOSFET的开关损耗[J].今日电子,2009(10):52-55.
[3] 刘松,葛小荣.理解功率MOSFET的电流[J].今日电子,2011(11):35-37.
[4] 刘松.理解功率MOSFET的Rds(on)温度系数特性[J].今日电子,2009(11):25-26.
[5] 刘松,葛小荣.应用于线性调节器的中压功率功率MOSFET的选择[J].今日电子,2012(2):36-38.
[6] 刘松,陈均,林涛.功率MOS管Rds(on)负温度系数对负载开关设计影响[J].电子技术应用,2010,36(12):72-74.

