英伟达AI芯片Rubin Ultra放弃4-Die封装方案
2026-04-02
来源:IT之家
4 月 1 日消息,集邦咨询 Trendforce 昨日(3 月 31 日)发布博文,报道称英伟达调整其人工智能芯片 Rubin Ultra,放弃 4-Die 激进方案,转而采用成熟的 2-Die 架构,并预估 2027 年推向市场。
Die(中文常称为裸片、裸晶、晶粒或芯片)是指从一整片圆形硅晶圆(Wafer)上,通过精密切割(Dicing)工艺分离下来的、单个含有完整集成电路(IC)功能的小方块。
该媒体指出,英伟达放弃 4-Die 方案的主要原因,是先进封装的物理极限,如果强行采用 4-Die 架构,芯片的封装尺寸将急剧膨胀,其面积会达到光罩极限的 8 倍左右。
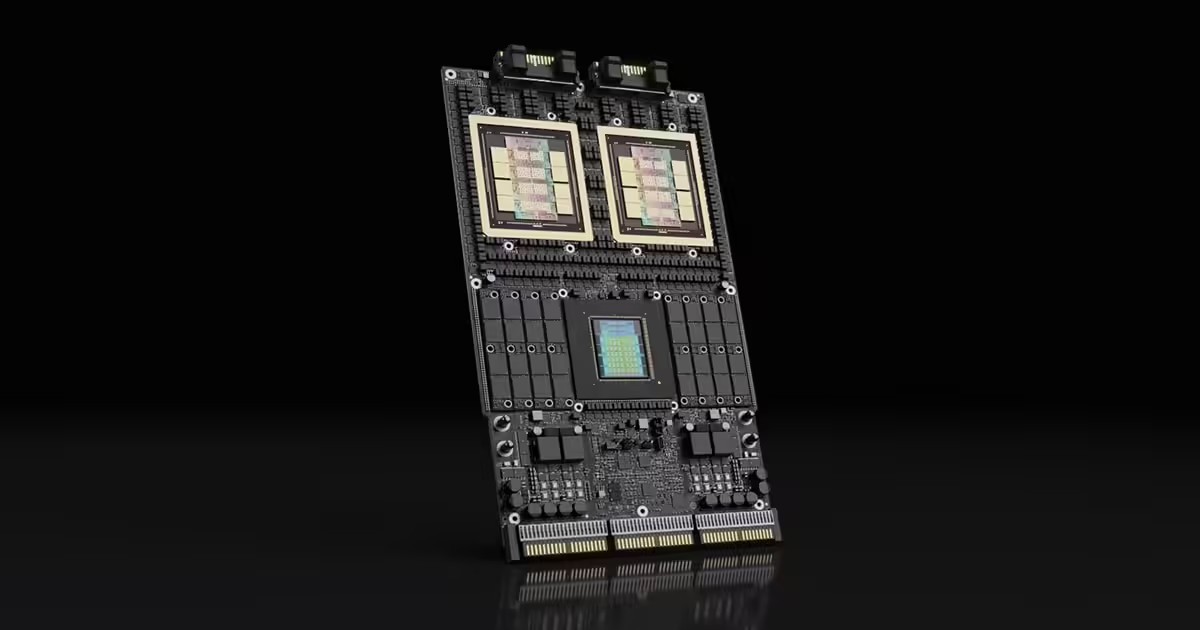
而更大的封装尺寸会拖累制造良率,进而推高生产成本,因此回归 2-Die 架构方案,能更好兼顾制造成本与量产效率。
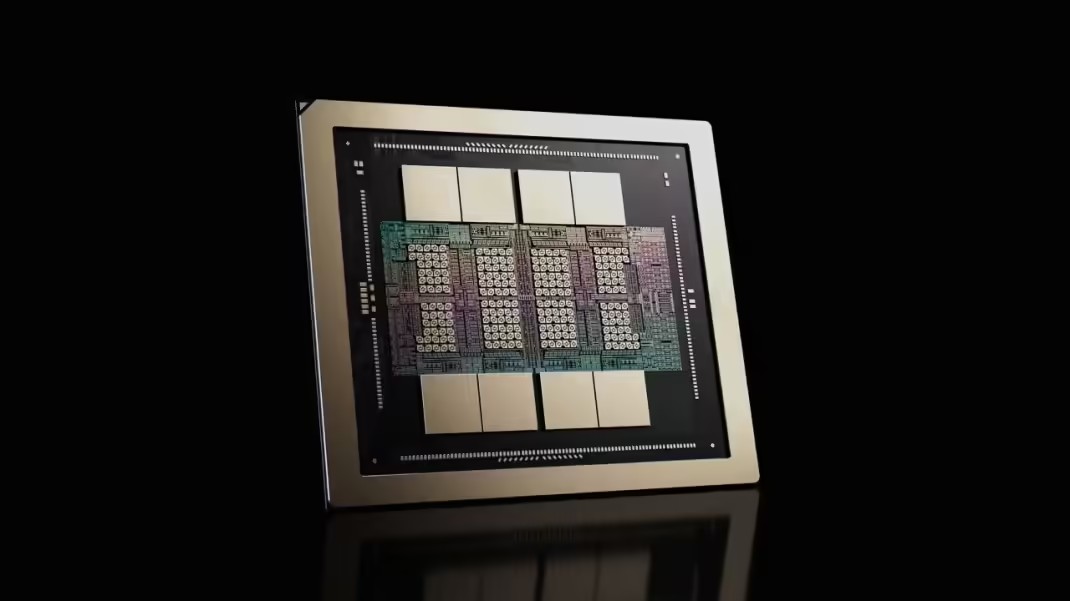
在制造工艺方面,Rubin Ultra 将采用台积电 N3P 工艺节点,结合 CoWoS-L 先进封装技术。英伟达目前并未削减台积电的晶圆代工订单。英伟达正在微调投片策略,将更多产能向当前的 Blackwell 架构倾斜。
此前报道,台积电 3 纳米工艺节点的产能需求极度旺盛,人工智能核心芯片对先进制程的消耗量急剧攀升。数据显示,明年人工智能芯片仅占 3 纳米产能的百分之五。但到后年,这一比例将直接飙升至 36%。

本站内容除特别声明的原创文章之外,转载内容只为传递更多信息,并不代表本网站赞同其观点。转载的所有的文章、图片、音/视频文件等资料的版权归版权所有权人所有。本站采用的非本站原创文章及图片等内容无法一一联系确认版权者。如涉及作品内容、版权和其它问题,请及时通过电子邮件或电话通知我们,以便迅速采取适当措施,避免给双方造成不必要的经济损失。联系电话:010-82306118;邮箱:aet@chinaaet.com。

