I. 简介
一种用于射频和微波测试仪器的高性能GaAsSb基区,InP集电区双异质结双极晶体管集成电路(DHBT IC)工艺被成功研发。其特有的高射频功率和单位面积增益,出色的增益和开启电压一致性,大的跨导,低的1/f 和相位噪声使得HBT IC成为一种对于测试仪器极具吸引力的先进技术。

InP 技术拓展了原有InGaP/GaAs 异质结双极晶体管集成电路HBT IC技术 [1][2],在不牺牲可靠性和可制造性的基础上使得测试仪器的性能达到67GHz和54Gb/秒。与GaAs相比InP具有非常优异的材料特性,例如更高的饱和及峰值电子速率,更高的热导率,更低的表面复合速率,以及更高的击穿电场强度。然而,在传统的GaInAs 基区/InP 集电区双异质结双极晶体管DHBT中存在集电结异质界面导带不连续。解决这种 I 型半导体能带结构所带来的问题需要认真设计能带梯度以消除低偏置下集电区电子的阻塞。与之相比,选择GaAsSb作为基区,InP 作为集电区能够形成没有阻塞效应的 II 型半导体能带结构,同时保持窄的基区带隙所具有的低开启电压和低功耗特性[3]. 结合其在复杂电路中良好的热学特性,以GaAsSb/InP为 基区/集电区的高速、高击穿电压异质结双极晶体管HBT非常适用于测试仪器产品。
II. 制备工艺
制备工艺采用1 µm 临界尺寸G-线分步光刻。在半绝缘InP衬底上通过分子束外延方法生长异质结双极晶体管 HBTs各外延层,形成 1 × 3 µm² 最小尺寸发射极和自对准蒸发基极金属电极。 采用选择性和非选择性湿法腐蚀工艺,以及非选择性Cl2/Ar-基电感应耦合等离子体(ICP) 干法刻蚀工艺制备发射极台面,基区欧姆接触电极,基区/集电区台面,次集电区隔离台面。等离子体增强化学气相淀积(PECVD)Si3N4 作为钝化介质。晶体管集成了22欧姆/sq Ta2N 电阻, 250 欧姆/sq WSiN 电阻和PECVD淀积Si3N4 的0.58 fF/µm² 金属-介质-金属MIM 电容。聚苯丙环丁烯(BCB)用来实现器件表面平坦化,发射极、基极、集电极欧姆接触电极以及其他无源单元通过电极孔淀积金属实现金属互联。金属互联采用3层TiPtAu:前两层为6 µm 电极接触孔,第三层为8 µm电极接触孔(Fig. 1)。衬底被减薄到90 µm.。通过刻蚀背面通孔和电镀金实现背面接地(Fig. 2)。背面通孔通过掩膜版和HBr-基ICP刻蚀实现[4] 。
文献[5] [12]介绍了一些其它InP 双异质结双极晶体管集成电路DHBT IC技术,它们都采用GaInAs 作为基区。 GaAsSb-基区双异质结双极晶体管DHBT在高速射频分立器件[13][14]和集成电路 [15][16] 方面均不断地有相关的研究结果予以报导。本项工作首次报导了在生产环境下制备的具有高击穿电压,200 GHz工作,以GaAsSb为基区的 InP双异质结双极晶体管集成电路 DHBT IC工艺。

III. HBT 直流和射频特性
典型HBT 共发射极直流特性 (集电极电流—集电极偏置,基极电流间隔30 µA)显示出这些器件具有良好的电流-电压特性 (Fig. 3)。在工作电流密度为1.5 mA/µm²下,HBT 器件实现了fT = 185 GHz,fmax = 220 GHz 以及峰值 fT > 200 GHz。 在比InGaP/GaAs HBT 大的多的电流密度范围内截至频率保持在很高的水平(Fig. 4).
共基极模式开态击穿压(BVcbx)发生在集电极—基极电压为9 V,集电极电流为JC = 1.3 mA/µm²时。共发射极模式开态击穿(BVceo) 发生在集电极—发射极电压接近7V时。
IV. 可生产性


工艺的设计考虑到性能、可靠性和可生产性之间的平衡。从成品率损失Pareto 图 Fig. 5 中可以看出发射区/基区短路是影响成品率的主要原因,基区电极柱损失是影响远小于发射区/基区短路的第二个原因。影响成品率的其它失效模式的影响相对较小,都在测试不确定范围内。由500个晶体管组成的典型电路所达到的成品率已能够满足小规模仪器的应用应用。
一种新的工艺技术对于Agilent复杂且规模较小的生产其晶片成品率大都如此。造成晶片成品率损失的原因主要有程序错误、晶片破裂、工艺和/或仪器问题。我们的经验显示GaAsSb/InP双异质结双极晶体管DHBTs并不存在异于其它化合物半导体的特有失效机制和更低的可生产性。

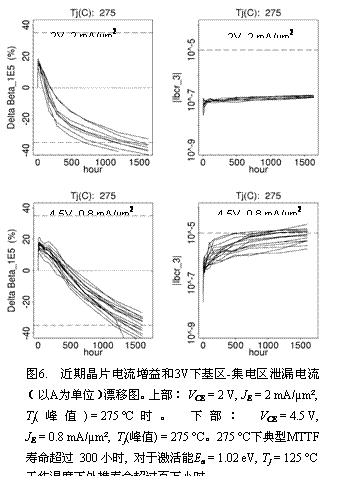
所有晶片工艺环节都由具有自动处理晶片功能的设备完成,以最大限度的减小人为因素造成的片与片、批与批之间的差异。具体的工艺步骤需要不断调整输入参数(例如,每一次要根据测试得到的目标层厚度进行离线计算),数据被不断收集以使统计工艺控制软件进行编程来指导操作者操作。
V. 可靠性
可靠性通过对分立的自对准1 × 3 µm² 漂移是主要的可靠性失效模式。利用测试得到的激活能Ea, 其值大约为1.02 eV, 外推得到Tj =)bHBTs进行高温寿命测试(HTOL)来确定,电流增益( 125 °C.温度下MTTFs 寿命超过106 的下半部显示双异质结双极晶体管结构(例如,InP集电区)可在VCE6以上。图03值始终保持在 b,这一标准保证了6作为失效标准同样示于图 %5漂移 b。以电流增益6集电区电流泄漏(位列第二的主要可靠性失效模式)示于图漂移和基区 )b小时。电流增益( = 4.5 V 下保持高可靠性工作,这一电压值比InP衬底单异质结双极晶体管高出 2 3 V。
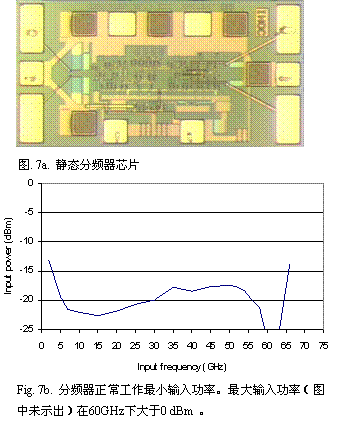
VI. 电路性能
A. 2 60 GHz 一比二静态分频器
静态分频器性能和芯片照片示于图7。双极晶体管HBT 用作静电放电保护。其输入灵敏度窗口非常宽,单端正弦波输入状态下一比二除法功能可在2GHz到60GHz范围内实现。输入和输出可采用差分和单端方式。90 mA时偏置电压为-3.4V。典型输出功率从低频时的. 0 dBm 到高频60GHz时的 3 dBm 。
B. 差分限幅放大器
由50个晶体管组成的差分限幅放大器照片示于图8a。限幅放大器采用两级Cherry-Hooper,一级cascode和一对有几级发射极跟随器缓冲的差分输出结构,低频小信号差分增益大于32dB, 单端(S-E)输入电压窗口为± 700 mV 最大单端(S-E)输出幅度500 mVpp 。 放大器从+1 V 到 4.1 V电源消耗0.59 W功率。偏置端采用 双极晶体管HBT 进行静电放电保护。输入输出均有差分失调/直流监测以及common-mode pull-up 能力.
图8b 显示了典型的在片增益特性,低频S-E 增益26.8±0.5 dB , 3 dB 带宽46.8±0.4 GHz.。达到65 GHz时群
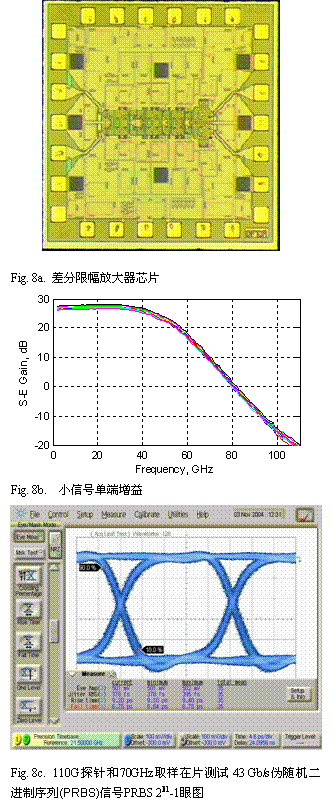
延时变化小于5 ps。典型 43 Gb/s 眼图输出信号如图8c 所示,其幅度为0.50 Vpp S E, 10%-90% 上升时间为9.2 ps, 总 RMS抖动378 fs。 295 fs RMS 抖动1 Vpp 差分PRBS 231-1 NRZ输入信号由以同样技术制作的半速retimer 提供。
C. 线性相位检测器
这一电路在文献[18]中单独有详细介绍。它使用了超过200个最小尺寸的晶体管,并以HBT作为静电放电保护,3级互联,高值和低值电阻,电容,背面通孔。对于这样的复杂电路其在线成品率是合乎预期的。
ACKNOWLEDGMENT
We would like to thank Sue Harris and Denise Davis for technical R&D assistance, and the Tech Center operations and engineering team for their manufacturing support.
REFERENCES
[1] T.S. Low, C.P. Hutchinson, P.C. Canfield, T.S. Shirley, R.E. Yeats, J.S.C. Chang, et al., “Migration from an AlGaAs to an InGaP emitter HBT IC process for improved reliability,” in Proc. GaAs IC Symposium 1998, pp. 153-156, 1998.
[2] B. Yeats, P. Chandler, M. Culver, D. D’Avanzo, G. Essilfie, C. Hutchinson, et al., “Reliability of InGaP-emitter HBTs,” in Proc. GaAs Mantech 2000, pp. 131-135, 2000.
[3] C.R. Bolognesi, N. Matine, M.W. Dvorak, X.G. Xu, J. Hu, and S. P. Watkins, “Non-blocking collector InP/GaAsSb /InP double heterojunction bipolar transistors with a staggered lineup base–collector junction,” IEEE Electron Device Lett., vol. 20, no. 4, pp. 155-157, 1999.
[4] M. Huffman, T. Engel, N. Pfister, G. Arevalo, T. Brown, M. Farhoud, et al., “Dry etching of deep backside vias in InP,” in Proc. GaAs Mantech, pp.269-272, 2003.
[5] G. He, J. Howard, M. Le, P. Partyka, B. Li, G. Kim, et al., “Self-aligned InP DHBT with fT and fmax over 300 GHz in a new manufacturable technology,” IEEE Electron Device Lett., vol. 25, no. 8, pp. 520-522, 2004.
[6] S. Tsunashima, K. Murata, M. Ida, K. Kurishima, T. Kosugi, T. Enoki, et al., “A 150-GHz dynamic frequency divider using InP/InGaAs DHBTs,” in Proc. GaAs IC Symposium 2003, pp. 284-287, 2003.
[7] J. Godin, A. Konczykowska, M. Riet, P. Berdaguer, J. Moulu, V. Puyal, et al., “InP DHBT mixed-signal specific ICs for advanced 40 Gb/s transmitters,” in Proc. CSICS 2004, pp. 89-92, 2004.
[8] D.A. Hitko, T. Hussain, J.F. Jensen, Y. Royter, S.L. Morton, D.S. Matthews, et al., “A low power (45mW/latch) static 150GHz CML divider”, in Proc. CSICS 2004, pp. 167-170, 2004.
[9] R. E. Makon, K. Schneider, R. Driad, M. Lang, R. Aidam, R. Quay, and Q. Weimann, “Fundamental low phase noise InP-based DHBT VCOs with high output power operating up to 75 GHz”, in Proc. CSICS 2004, pp. 167-170, 2004.
[10] D. Sawdai, E. Kaneshiro, A. Gutierrez-Aitken, P.C. Grossman, K. Sato, et al., “High performance, high yield InP DHBT production process for 40 Gbps applications,” in Proc. IPRM 2001, pp. 493-496, 2001.
[11] Z. Griffith, M. Dahlstrom, M.J.W. Rodwell, X.-M. Fang, D. Lubyshev, Y. Wu, et al., “InGaAs-InP DHBTs for increased digital IC bandwidth having a 391-GHz fT and 505-GHz fmax,” IEEE Electron Device Lett., vol. 26, no. 1, pp. 11-13, 2005
[12] M. Urteaga, R. Pierson, P. Rowell, B. Brar, Z. Griffith, M. Dahlstrom, et al., “Wide bandwidth InP DHBT technology utilizing dielectric sidewall spacers,” in Proc. IPRM 2004, pp. 667-670, 2004.
[13] M.W. Dvorak, C.R. Bolognesi, O.J. Pitts, and S.P. Watkins, “300 GHz InP/GaAsSb/InP double HBTs with high current capability and BVceo ≥ 6V,” IEEE Electron Device Lett., vol. 22, no. 8, pp. 361-363, 2001.
[14] B.F. Chu-Kung and M. Feng, “InP/GaAsSb type-II DHBTs with fT > 350 GHz,” Electron. Lett., vol. 40, no. 20, pp. 1305-1306, 2004.
[15] X. Zhu, J. Wang, and D. Pavlidis, “First demonstration of low-power monolithic transimpedance amplifier using InP/GaAsSb/InP DHBTs,” in Proc. MTT-2005, Paper TU1D-6, 2005.
[16] A. Konczykowska, M. Riet, P. Berdaguer, P. Bove, M. Kahn, and J. Godin, “40 Gbit/s digital IC fabricated using InP/GaAsSb/InP DHBT technology,” Electronics Lett., vol. 41, no. 16, pp. 123-123, 2005.
[17] E.M. Cherry and D.E. Hooper, “The design of wide-band transistor feedback amplifiers,” Inst. Elec. Eng. Proc., vol. 110, no. 2, pp. 375-389, 1963
[18] R. Karlquist, C. Hutchinson, T. Marshall, and R. Van Tuyl, “A frequency agile 40 Gb/s half rate linear phase detector for data jitter measurement,” in Proc. CSICS 2005, to be published.

