文献标识码: A
DOI:10.16157/j.issn.0258-7998.190961
中文引用格式: 伍文俊,兰雪梅. GaN FET的结构、驱动及应用综述[J].电子技术应用,2020,46(1):22-29,38.
英文引用格式: Wu Wenjun,Lan Xuemei. Overview on GaN FET structure, driving and its application[J]. Application of Electronic Technique,2020,46(1):22-29,38.
0 引言
氮化镓(GaN)为第三代宽禁带半导体材料,在高温、高压、高频等应用场合其半导体器件的特性都要优于Si基半导体器件,因此,在电力电子的应用领域备受瞩目。
用GaN材料制成的功率器件GaN FET具有低的击穿电压、低的阈值电压、低的栅极电荷Qg,其开关频率高,导通电阻小。GaN FET优越的特性与其器件结构有极大的关系。但是它的缺点也不可忽视,在高频应用场合表现极为明显,比如其对寄生参数极其敏感,高频使用时极易使栅极电压产生振荡,引起栅极过电压,导致器件工作不稳定,甚至不安全。因此相较于传统的Si基半导体器件的驱动电路,GaN FET的驱动要求更为严苛。GaN FET的进步、应用的发展与其器件结构和驱动电路有密不可分的联系,因此,其器件结构和驱动电路的研究很有意义。本文将对当前国内外GaN FET的器件结构、驱动电路及其在电机驱动、LED驱动、光伏逆变器、POL等场合中的应用进行综述。
1 GaN FET的器件结构及工作原理
GaN FET器件的结构目前主要有耗尽型(Depletion mode,D-mode)和增强型(Enhancement mode,E-mode)。增强型GaN FET又分单体GaN和Cascade GaN(共栅共源)。
1.1 耗尽型GaN FET
耗尽型GaN FET的器件结构如图1所示。耗尽型GaN FET采用Si材料作为GaN FET的基片,在Si基片基础上生长出高阻性的GaN晶体层,即氮化镓通道层(GaN channel)。一般在GaN层和Si衬底层之间添加氮化铝(AIN)绝缘层作为氮化镓缓冲层(GaN buffer),将器件和衬底隔离开来。AlGaN层存在GaN层和栅极(G)、源极(S)和漏极(D)之间;AlGaN层和GaN层之间可以产生具有高电子迁移率、低电阻特性的二维电子气(Two-Dimensional Electron Gas,2DEG),且它的浓度随AlGaN厚度先线性增加,然后达到饱和。

与Si传统器件不同,耗尽型GaN FET由于氮化物极强的极化效应,AlGaN/GaN异质结可以通过自发极化和压电极化效应在其界面形成很高浓度2DEG导电沟道,在零栅压下,器件处于导通状态。因此往往需要负压关断。耗尽型GaN FET不同于Si MOSFET的是,由于其栅极下方不存在与S极连接的P型寄生双极性区,因此没有寄生体二极管,故而器件开关损耗小、具有对称的传导特性。因此GaN FET可由正栅源电压VGS或正栅漏电压VGD驱动。
1.2 增强型GaN FET
对于耗尽型GaN FET,要关断器件,必须加负栅压。这意味着电路中一旦有耗尽型GaN FET,就会增加栅极驱动设计的复杂性,而且易发生误导通,有直通的潜在威胁,使电路稳定性和安全性降低。增强型GaN FET则相反,只有加正偏压才会导通,减小了电路复杂性,稳定性和安全性也较好。目前,增强型GaN FET主要是在耗尽型高电子迁移率晶体管(Gallium Nitride High Electron Mobility Transistor,GaN HEMT)结构的基础上改进而成。目前主要的增强型GaN FET结构方案包括:P型栅、凹槽栅、Cascode结构等。
1.2.1 P型栅结构
有很多学者研究P型栅结构的GaN FET,如图2所示[1-2]。与耗尽型不同的是,P型栅结构是在AlGaN势垒层上生长了一个带正电的P型GaN栅极,如图2中的P-GaN层。P型GaN层可以拉升AlGaN势垒层的能带,起到耗尽2DEG的作用,以实现常断特性。当施加足够的正VGS时,使栅源电压大于阈值电压,P-GaN层的内电场被削弱,2DEG浓度上升,形成导通沟道,GaN FET器件导通。随着VGS的降低且小于阈值电压,沟道又逐渐关闭,GaNFET器件关断。因此,这种结构主要是通过控制P型栅极势垒的电位,升降AlGaN势垒层的能带,使2DEG的浓度改变来实现对GaNFET器件的通断控制。

文献[3]在P型栅结构的基础上,采用在P-GaN层上沉积TiN金属,形成三层掩膜的栅极结构,从而实现肖特基接触,如图3所示。这种结构存在栅极场板,可增加高压应用场板设计的灵活性。实验证明,这种结构具有低栅极电阻、降低高漏源电压VDS时的导通电阻RDS-ON等优势,且相比采用欧姆接触的P-GaN结构,此结构降低了栅极漏电流。

1.2.2 凹槽栅结构
凹槽栅[4]结构如图4所示,此结构通过电感耦合等离子体(Inductively Couple Plasma,ICP)干法刻蚀技术刻蚀掉栅极下方区域一定厚度的AlGaN势垒层,当AlGaN势垒层厚度减薄到一定程度时,沟道内的2DEG浓度会足够低[5]。凹型栅极下方的整个AlGaN势垒层被去除,栅极下的2DEG消失,栅极金属下沉积了Al2O3膜作为栅极电介质,可防止由于器件尺寸越来越小而引发严重栅极漏电流、击穿电压过低等问题。在零栅压下,2DEG浓度小到可以忽略,器件处于关断状态。只有施加正栅压后,导电通道才会恢复,实现器件导通,即实现增强型特性。但除去栅极下方的势垒层,AlGaN势垒层其他区域的未被减薄,2DEG浓度保持原有水平。因此,凹槽栅技术制成的GaN FET在饱和电流和跨导方面较有优势。

1.2.3 Cascode结构
Cascode结构是由高压耗尽型GaN HEMT和低压增强型Si MOSFET(金属氧化物半导体场效应晶体管)级联构成的,如图5所示。
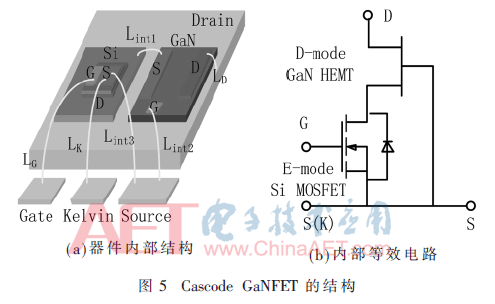
从结构可知,当器件不加栅压且漏源电压大于零时,工作在正向阻断模态;当栅压大于Si MOSFET的阈值电压时,器件正向导通;一旦Si MOSFET反向导通,器件将工作在反向导通模态。又因为Si MOSFET的漏源电压Vds_Si给GaN HEMT的栅源电压Vgs_GaN提供负偏置电压,因此控制Si MOSFET的通断即可控制GaN HEMT的通断。当然,这种结构由于引入了硅基器件,因此对封装的要求较高,体积也较大。
与其他结构GaNFET相比,Cascode GaNFET的结构,电压等级较高、驱动电压范围较宽,但对dv/dt和di/dt敏感,特别是在高频时,共源电感过大[6]可能会使器件损坏。Andrew等人通过将智能栅极驱动与Si MOSFET集成,驱动耗尽型GaN HEMT,形成智能Cascade GaNFET,如图6所示。该智能Cascade GaNFET内置电流检测、可调输出电阻、可调电流检测率和智能数字控制[7]。实验表明,此改进的Cascode结构通过利用动态开关技术,可以减少栅极振荡、降低高电压和电流转换速率、解决dv/dt和di/dt问题,优化EMI。
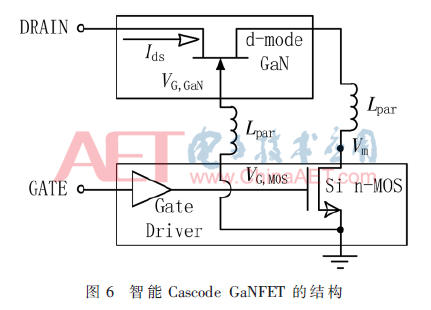
2 GaN FET的产品现状
目前,生产耗尽型GaN FET的公司主要有美国Cree,其产品主要的参数如表1所示,为推广耗尽型GaNHEMT的应用,Transphorm公司推出了Cascode结构的GaN FET。从表1可知Cree公司的GaN FET的阈值电压为负值,充分体现了它在零栅压下的常通特性。

增强型GaN FET的生产商则相对较多,主要包括中国香港的EPC、加拿大的GaN Systems、日本Panasonic公司等,它们的主要参数见表2。从表2可知,在增强型GaN FET产品中,GaN Systems公司的电压电流等级较高,但阈值电压较小;EPC公司的电压等级较低,驱动电压范围最窄,导通损耗较大,但漏极电流等级最多;Panasonic公司的电压和电流等级最少,阈值电压最低,但开通较快;Transphorm公司的电压等级较高,驱动范围最广,阈值电压较高[8],使用较安全。
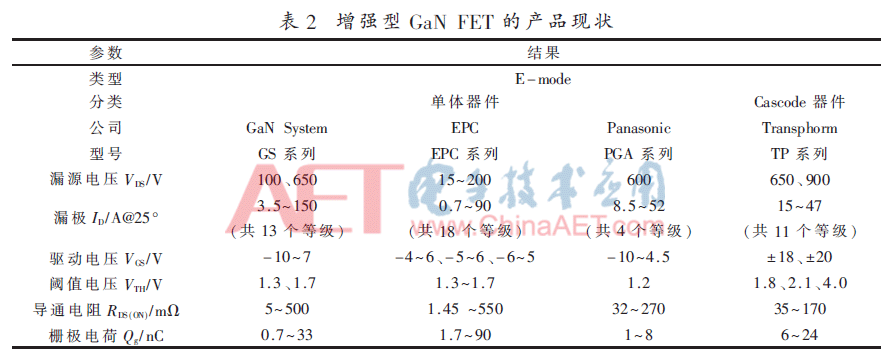
表3是GaN FET主要的封装形式,从表可知,增强型GaN FET的封装结构中贴片式的使用较多,直插式的较少。贴片式的外部引脚寄生效应影响较小,但不利于散热;直插式则相反,其散热能力较好,但高频时往往易受寄生参数影响。
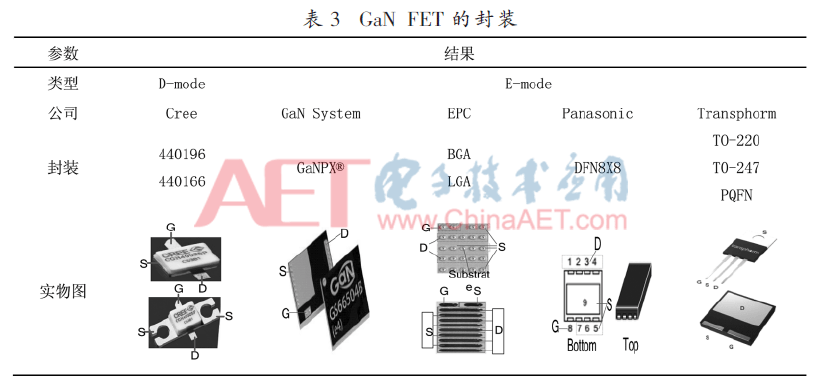
此外,除单体GaN器件,还有集成式GaN模块产品。目前GaN集成形式最多的是GaN半桥模块,主要有EPC和GaN Systems在生产。其中EPC2104(100 V,30 A)、GS66508T(650 V,30 A)分别是两家公司等级最高的GaN半桥模块产品。
3 GaN FET的驱动
3.1 隔离方式
驱动电路位于主电路与控制电路之间,其输出与主电路有耦合关系,其输入与控制电路相连。因此,驱动电路往往需要隔离设计。一般的隔离方式主要分为光耦隔离和变压器隔离。目前,相较于变压器隔离,GaN FET驱动电路的隔离中用光耦隔离[9-10]的较多。光耦隔离的参数设计较简单,但其输出需要隔离驱动电源。目前,GaN FET驱动电路的分类主要是由分立元件构成的驱动电路和以集成器件为主构成的驱动电路。
3.2 驱动电路的基本要求
增强型GaN FET的低栅源电压VGS、低阈值电压VTH以及寄生参数等影响,使得传统的Si驱动电路不再适用于GaN,GaNFET的驱动要求更为严格,其驱动电路至少具备以下三个功能:
(1)驱动信号可靠性。驱动信号的可靠性对于驱动电路来说是很重要的,驱动信号一旦不稳定极有可能损坏GaN器件。因此,一定要保证驱动信号可靠传输。一般在通信系统中或使用频率在兆赫兹等级以上时,常用微波驱动(Drive-by-Mcrowave,DBM)技术来传输驱动信号[11]。
(2)抗扰性能。GaN FET的低阈值电压使其对di/dt、dv/dt和寄生电感极其敏感,若驱动的抗扰性不好,开关频率的增加不仅使器件损耗增多,严重时还会损坏器件。因此,驱动需要较好的抗扰性。一般采取减小共源电感、增加驱动电阻等方法提高驱动抗扰性。
(3)漏源回路寄生电感小。GaN FET栅极信号的噪声[12]和振荡很强,一旦回路寄生电感过大会导致关断时出现过电压和寄生振荡,导致额外的损耗。因此可优化驱动回路,减小寄生电感。
3.3 分立式GaN FET驱动电路
增强型GaN FET一般的分立式驱动电路如图7所示。分立式驱动电路由驱动电源VCC、PWM信号、隔离和栅极电阻RG等基本部分组成。前面几部分主要是给GaN FET提供驱动电压VGS。

图8为GaN FET峰值箝位驱动电路。通过加入二极管-电阻-电容网络对栅极进行箝位保护[13],此箝位电路可以有效抑制开通过程的栅极电压峰值和漏极电流峰值。其中,R1和C1可使器件快速开关并抑制栅极电压峰值,但在关断过程会产生负的栅极电压尖峰;故用D1、R3支路提高关断时C1的放电速率,且R3越大,C1放电越快。
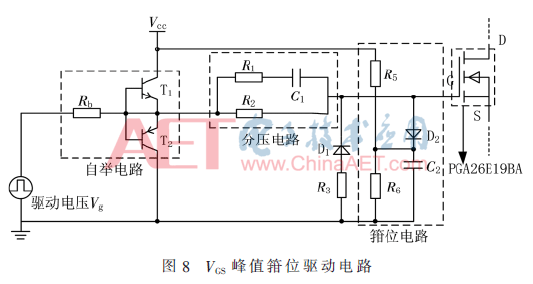
文献[14]提出了一种降低反向导通损耗的GaN FET的新型栅驱动电路,如图9所示。作者在分压型驱动的基础上加入了由电阻R3、电容C3、P沟道MOSFET自激开关Q1和二极管Dg组成的电路,如图9虚线部分所示。其中,C3、R3的值要比C2、R2的值大得多,因此,C2比C3充放电快得多。关断时,未改进前的分压驱动中,分压电容C2存储的电荷会产生高负VGS使反向导通损耗增加。改进后,加入的虚线部分电路可使C2放电,使VGS几乎降为零。另外,VGS受二极管Dg的正向压降限制。因此,该驱动设计有效减少了器件反向特性引起的损耗。

文献[15]基于Transphorm公司的双向GaN,设计具有抗dv/dt的双向GaN FET驱动电路,如图10所示。数字隔离器具有高共模瞬态抗扰度,可防止高dv/dt的影响;铁氧体磁珠用来抑制栅极电压的振荡;缓冲电路放在器件附近可以抑制浪涌电压。
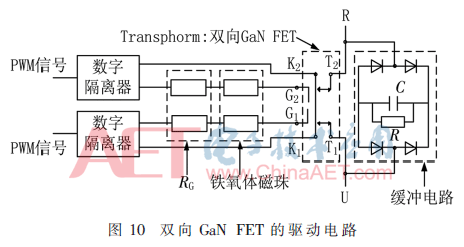
目前,已有的可变栅极驱动在瞬态期间或之外只能改变每次开关事件的一次单驱动参数,而文献[16]设计的有源驱动在开关瞬态期间,可激活0.12 Ω~64 Ω间的任意上拉或下拉栅极驱动输出电阻,且达到6.7 GHz的有效电阻更新率,电路如图11所示。实验表明,开环有源栅极驱动能保持低开关损耗,减少过冲、振荡和EMI。

3.4 集成式GaN FET驱动电路
一般的分立式驱动电路分立元件多,电路结构较复杂,导致保护也复杂,从而可靠性变差。因此,实际应用中大多采用集成驱动电路。集成式驱动电路主要由驱动芯片和其他元件组成,如图12所示。而在GaN FET的集成驱动中,常用的驱动芯片有LM5113[17-22]、UCC27611[9,21]、UCC21520[23]等。

3.4.1 LM5113集成式驱动电路
LM5113是专为驱动同步buck或半桥配置的高端和低端增强型GaN FET而设计的驱动芯片。该芯片采用自举技术生成高端偏置电压,并在内部将其箝位在5.2 V,防止栅极电压超过GaN FET 的最大栅源电压额定值。
文献[22]提出了三电平驱动技术,驱动电路如图13所示。只有当在死区时间,CON为高信号时,下管Vgs变为Vx(Vx<Vth)。理论上,当Vx接近Vth时,反向导通压降为0。实验证明,与两电平驱动相比,该驱动使GaN FET反向导通压降得到有效降低,从而提高了变换器的效率。

3.4.2 UCC27611集成式驱动电路
UCC27611是单通道高速栅极驱动器,驱动电压VREF被内部线性稳压器精确稳压至5 V。其具有最低寄生电感的封装和引脚分配,减少了上升和下降时间并限制了振铃。文献[21]采用的集成驱动电路如图14所示,此电路的回路面积只有原来的1/30,有效减少了寄生电感,从而减少了对驱动电压的干扰。

文献[9]基于UCC17611设计的集成驱动不同于图14,其设计的电路在驱动桥壁上管时驱动信号先经通用CMOS锁相环集成电路CD4046,再经光耦数字隔离器Si8610BC后才由UCC27611驱动,而下管驱动信号则不隔离直接经过UCC27611驱动。这种方式可以避免桥壁直通,因为上管的驱动信号经过光耦等元件后,必定与下管驱动信号不同步,有延时。
3.4.3 UCC21520集成式驱动电路
UCC21520是隔离双通道栅极驱动器,输出的两通道驱动信号互补。当PWM信号INA为高电平时,输出OUTA驱动上管开通;INB为高电平时,输出OUTB驱动下管,且INA与INB是互补信号。文献[23]采用UCC21520设计了含有源箝位的GaNFET驱动如图15所示。由于芯片内部集成有死区电路,所以可通过改变驱动电路中外接电阻R29的阻值来调节死区。磁珠起减缓栅极电路中产生较大电压振荡的作用;稳压管用来防止栅源电压VGS波动太大使开关损坏;箝位三极管V6可抑制干扰导致误开通的现象。可见,该集成驱动电路的抗扰性较好。
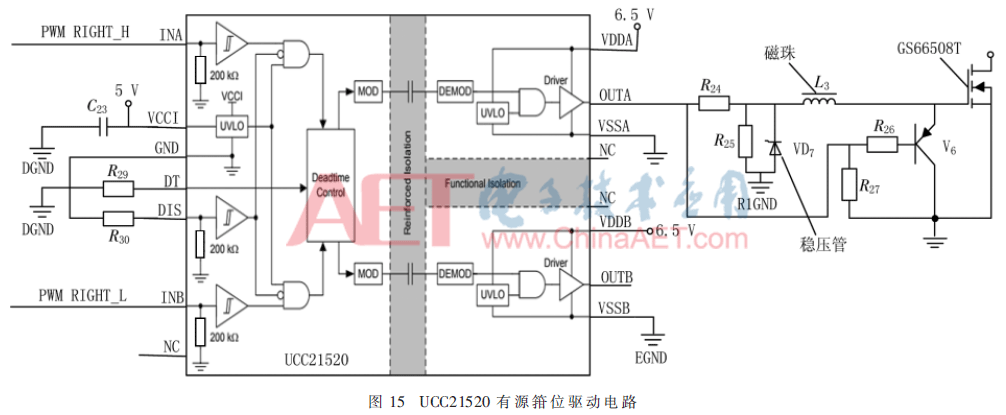
4 GaN FET的典型应用
4.1 在电机驱动中的应用
众所周知,在电力工业中60%以上负载是电机。在节能减排的大环境下,电机的驱动变换器向低功耗、高功率密度、高效率发展。为实现这些目标,人们把目光转向GaN等功率器件,利用GaN FET的特性提高电机驱动变换器的性能。
文献[1]针对5 kW三相电机,采用了GaN 3×3逆变模块完成了矩阵变换器的控制,大大减小了系统的损耗和体积。在10 kHz工作时,变换器效率达到96%,功耗低于1 W,体积减少不少于1%。
同样在5 kW电机驱动中,由于传统隔离栅极驱动器在高温下光耦的使用寿命短,因此文献[24]设计了适于高温的带隔离的微波驱动半桥栅极驱动器。此驱动采用PGA26C09DV,使得GaN逆变器工作在1 MHz时,开关损耗恒为0.9 W,效率达到了94%[11],且在140°的环境温度中也能提供足够的栅极功率。
文献[25]通过对采用型号为TPH3206LD的GaN FET和型号为IPL60R185P7的Si MOSFET的三相逆变器的性能比较后发现,开关频率在10 kHz~100 kHz变化时,GaN逆变器的开关损耗占总损耗的12%~55%、效率在97.8%~96.4%之间;而Si的损耗为36%~77%,10 kHz时效率只有96.9%。可见,GaN逆变器应用到电机驱动中,其性能要优于Si的,也更有潜力。
4.2 在LED驱动中的应用
LED寿命长、效率高、节能等优势使其越来越受欢迎,但LED是直流供电,因此变换器成为其必不可少的一部分。由于变换器极贴近LED灯,这要求变换器小型化、能在高温下运行。而小型化需要开关频率在兆赫兹范围,因此GaN等新型宽禁带半导体在LED驱动中有潜在的市场。
Eric等人提出一种小而简单的模拟磁滞控制谷底开关(准谐振)浮动Buck变换器[26],该变换器使用了GaN FET器件。并通过实验证明,600 V GaN FET在MHz频率等级的优越开关性能使得变换器尺寸有效减小,从而进一步提高了功率密度,并使20 W的LED在2.5~4.4 MHz时效率达到91.2%。可见,GaN FET在LED驱动应用的前景非常可观。
4.3 其他应用场合
4.3.1 光伏逆变器
光伏电池板与电网存在电气连接,逆变器的高频行为所导致的共模电压通过光伏板与大地之间的寄生电容,形成共模电流,而共模电流会引起并网电流的畸变,产生电磁干扰,严重时会对人的安全产生威胁。因此,需要抑制或消除非隔离型光伏并网系统中的共模电流,基于型号TPH3006PS的GaN双buck并网逆变器有效解决了这个问题。经实验证明,其效率达到98.63%[27]。
4.3.2 POL
随着负载点技术(Point of Load,POL)在信息通信技术ICT设备中的应用,开关频率达到30 MHz时,减少寄生阻抗成为GaN基同步DC/DC变换器的最大挑战[28]。Akagi等人通过设计栅极驱动IC并在上面加入3D堆叠电源SoC(Stacked-on-Chip),使变换器在30 MHz下最大效率达到了59%,优化后最高效率预计为85%。可见,型号为EPC8002的GaN FET在高频上颇有优势。
目前,GaN FET在电力电子装置应用广泛。研究者主要是利用GaN FET高的开关频率、低的开关损耗等优势,通过提高变换器工作频率减小装置体积,进而提高装置效率、降低装置成本、增加收益。
表4给出了GaN FET变换器在其他方面的应用研究情况。从表中可以看到,GaN FET目前多用在中小功率变换器上,随着开关频率的提高,变换器效率降低,但基本在90%及以上。实验证明,效率的降低与开关损耗机理有关[29]。当然,除了提高效率,用GaN FET设计的功率1 kW以上的变换器,输出电压和电流纹波很小[30-31]。此外,采用GaN FET并联技术[32-34]有可能使其应用到10 kW及以上的大功率场合。可见,GaN FET在变换器的应用前景广阔。

5 结论
通过对GaN FET的器件结构、驱动电路以及应用的研究,可以看出只要解决GaN FET高频下独特的栅极振荡问题,就能极大地推动它的发展。一般可从两方面着手,一是设计性能更好的器件结构;二是设计更合理的驱动电路。虽然GaN FET目前在中小功率场合更有优势,但未来,随着对GaN FET性能的不断改进和提高,更多大功率场合也必然有GaN FET的一席之地。
参考文献
[1] OTSUKA N,KAWAI Y,NAGAI S.Recent progress in GaN devices for power and integrated circuit[C].IEEE 12th International Conference on ASIC(ASICON),2017:928-931.
[2] FENG J,HE Z,EN Y,et al.The ESD behavior of enhancement GaN HEMT power device with p-GaN gate structure[C].IEEE International Power Electronics and Application Conference and Exposition(PEAC),2018:1-4.
[3] POSTHUMA N E,YOU S,STOFFELS S,et al.Gate architecture design for enhancement mode p-GaN gate HEMTs for 200 and 650V applications[C].IEEE 30th International Symposium on Power Semiconductor Devices and ICs(ISPSD),2018:188-191.
[4] 赵勇兵,程哲,张韵,等.具有高阈值电压和超低栅漏电的400 V常关型槽栅AlGaN/GaN金属氧化物半导体高电子迁移率晶体管[J].电工技术学报,2018,33(7):1472-1477.
[5] 白欣娇,袁凤坡,李晓波,等.增强型GaN HEMT凹槽栅刻蚀技术研究进展[J].微纳电子技术,2018,55(10):762-767,774.
[6] CHEN Z,GUITART J R.Dv/dt Immunization Limit of LV MOSFET in Cascode GaN FET and Dv/dt Safe Chart for MOSFETs[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2017:1946-1949.
[7] YU J,ZHANG W J,SHORTEN A,et al.A smart gate driver IC for GaN power transistors[C].IEEE 30th International Symposium on Power Semiconductor Devices and ICs(ISPSD),2018:84-87.
[8] HARI N,LONG T,SHELTON E.Investigation of gate drive strategies for high voltage GaN HEMTs[J].Energy Procedia,2017,117:1152-1159.
[9] GUAN Y,WANG Y,XU D,et al.A 1 MHz half-bridge resonant DC/DC converter based on GaN FETs and planar magnetics[J].IEEE Transactions on Power Electronics,2017,32(4):2876-2891.
[10] KIM D S,JOO D M,LEE B K,et al.Design and analysis of GaN FET-based resonant DC-DC converter[C].IEEE 9th International Conference on Power Electronics and ECCE Asia(ICPE-ECCE Asia),2015:2650-2655.
[11] CHE S,NAGAI S,NEGORO N,et al.A 1 W power consumption GaN-based isolated gate driver for a 1.0 MHz GaN power system[C].IEEE 29th International Symposium on Power Semiconductor Devices and IC′s(ISPSD),2017:33-36.
[12] AHMAD B,MARTINEZ W,KYYRA J.Common mode noise analysis for a high step-up converter with GaN devices[C].IEEE Energy Conversion Congress and Exposition(ECCE),2018:1240-1246.
[13] WU H,FAYYAZ A,CASTELLAZZI A.P-gate GaN HEMT gate-driver design for joint optimization of switching performance,freewheeling conduction and short-circuit robustness[C].IEEE 30th International Symposium on Power Semiconductor Devices and ICs(ISPSD),2018:232-235.
[14] UMEGAMI H,HATTORI F,NOZAKI Y,et al.A novel high-efficiency gate drive circuit for normally off-type GaN FET[J].IEEE Transactions on Industry Applications,2014,50(1):593-599.
[15] HIROTA T,INOMATA K,YOSHIMI D,et al.Nine switches matrix converter using Bi-directional GaN device[C].IEEE International Power Electronics Conference(IPEC-Niigata 2018-ECCE Asia),2018:3952-3957.
[16] DYMOND H C P,WANG J,LIU D,et al.A 6.7-GHz active gate driver for GaN FETs to combat overshoot,ringing, and EMI[J].IEEE Transactions on Power Electronics,2018,33(1):581-594.
[17] 羊志强,徐大伟,李新昌,等.基于GaN HEMT同步整流Buck变换器研究[J].电力电子技术,2017,51(9):20-23.
[18] SUN B,BURGOS R,BOROYEVICH D.Ultralow input-output capacitance PCB-embedded dual-output gate-drive power supply for 650 V GaN-based half-bridges[J].IEEE Transactions on Power Electronics,2019,34(2):1382-1393.
[19] ELRAJOUBI A M,GEORGE K,ANG S S.Design and analysis of a new GaN-based AC/DC topology for battery charging application[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2018:2959-2964.
[20] UMETANI K,MATSUMOTO R,HIRAKI E.Prevention of oscillatory false triggering of GaN-FETs by balancing gate-drain capacitance and common-source inductance[J].IEEE Transactions on Industry Applications,2019,55(1):610-619.
[21] 陈雷雨,和军平,俞作良,等.基于增强型氮化镓器件的两级DC/DC变换器设计[J].电力电子技术,2017,51(9):12-15.
[22] 任小永,季澍,穆明凯.氮化镓功率晶体管三电平驱动技术[J].电工技术学报,2013,28(5):202-207.
[23] 罗智文,王奎,张新燕,等.基于高压GaN器件的双有源桥设计[J].电力电子技术,2017,51(9):16-19.
[24] NAGAI S,KAWAI Y,TABATA O,et al.A high-efficient driving isolated drive-by-microwave half-bridge gate driver for a GaN inverter[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2016:2051-2054.
[25] LAUTNER J,PIEPENBREIER B.Performance comparison of cascode GaN HEMT and Si MOSFET based inverter for motor drive applications[C].IEEE 12th International Conference on Power Electronics and Drive Systems(PEDS),2017:81-87.
[26] FARACI E,SEEMAN M,GU B,et al.High efficiency and power density GaN-based LED driver[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2016:838-842.
[27] 闫琪,李艳,王路.基于GaN器件的双Buck逆变器共模与损耗[J].电工技术学报,2017,32(20):133-141.
[28] AKAGI T,MIYANO S,ABE S,et al.A silicon based multi-tens MHz gate driver IC for GaN power devices[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2017:1978-1982.
[29] HOU R,LU J,CHEN D.Parasitic capacitance eqoss loss mechanism, calculation, and measurement in hard-switching for GaN HEMTs[C].IEEE Applied Power Electronics Conference and Exposition(APEC).IEEE,2018:919-924.
[30] MORSY A S,BAYERN M,ENJETI P.High power density single phase inverter using GaN FETS and active power decoupling for google little box challenge[C].IEEE 3rd Workshop on Wide Bandgap Power Devices and Applications(WiPDA),2015:323-327.
[31] 唐刚,刘军,黄森,等.氮化镓器件在四相交错并联DC/DC变换器上的应用[J].自动化应用,2018(3):94-96.
[32] LU J L,HOU R,CHEN D.Opportunities and design considerations of GaN HEMTs in ZVS applications[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2018:880-885.
[33] 卢俊诚,陈迪.氮化镓器件在大功率电力电子系统中的应用[J].电力电子技术,2017,51(9):1-2.
[34] LU J L,CHEN D.Paralleling GaN E-HEMTs in 10 kW-100 kW systems[C].IEEE Applied Power Electronics Conference and Exposition(APEC),2017:3049-3056.
[35] GAMAND F,LI M D,GAQUIERE C.A 10-MHz GaN HEMT DC/DC boost converter for power amplifier applications[J].IEEE Transactions on Circuits and Systems II:Express Briefs,2012,59(11):776-779.
[36] YAJING Z,ZHENG T Q,YAN L.Loss analysis and soft-switching characteristics of flyback-forward high gain DC/DC converter with GaN FET[C].IEEE International Power Electronics Conference(IPEC-Hiroshima 2014-ECCE ASIA),2014:2899-2903.
[37] PUUKKO J,XU J,LIU L.Consideration of flyback converter using GaN devices[C].IEEE 3rd Workshop on Wide Bandgap Power Devices and Applications(WiPDA),2015:196-200.
[38] 张雅静,郑琼林,李艳.考虑寄生参数的高压GaN高电子迁移率晶体管的逆变器动态过程分析[J].电工技术学报,2016,31(12):126-134.
[39] 李艳,张雅静,黄波,等.Cascode型GaN HEMT输出伏安特性及其在单相逆变器中的应用研究[J].电工技术学报,2015,30(14):295-303.
作者信息:
伍文俊,兰雪梅
(西安理工大学 自动化与信息工程学院,陕西 西安710048)

