热超声倒装键合机的视觉系统定位精度实验研究
2009-04-13
作者:李建平, 刘 涛, 邹中升
摘 要: 简要说明了视觉定位原理及定位实验数据的采集过程,并对倒装键合实验台的视觉定位系统的误差进行了理论分析。以热超声倒装键合实验台为平台,应用HexSight图像处理软件,对实验用1mm×1mm的表面有8个凸点的芯片进行定位实验。根据测得的实验结果,分别对定位系统的平移误差和旋转误差进行了分析。采用对5次识别结果取平均值的优化方法,使角度误差减小到0.023 766°,单项误差减小到0.183μm,综合误差减小到0.554μm。试验结果表明,该视觉定位系统达到了热超声倒装键合过程中芯片与基板之间的定位精度的要求。
关键词: 热超声倒装; 视觉定位; 误差分析
在微电子封装领域中,倒装技术主要有热超声倒装键合、回流焊接、热压键合、导电胶键合[1]等。其中热超声倒装键合技术由于其具有封装可靠性高、连接效率高、工艺简单、成本低、适应性强等优点,同时又是一种无铅的绿色焊接,而被认为是满足下一代芯片封装要求的具有发展潜力的新工艺和新技术[2-3]。针对热超声倒装键合的研究,人们主要着眼于键合功率、温度、时间、压力和超声功率等键合参数对键合强度和可靠性的影响 [4-5]。对于倒装键合这样微米级定位的要求,只有通过视觉定位系统才能满足其定位精度,其精度决定了机械部分最终的对准精度。因此,对识别精度进行估计,根据需要进行合理的优化是非常必要的[6-7]。本文对视觉系统误差进行了理论分析,并以中南大学自主开发的热超声倒装键合实验台为平台,对实验用1mm×1mm的表面有8个凸点的芯片进行定位实验。最后对定位实验结果采用取平均值的优化方法,使定位系统的定位精度达到了亚像素级别。
1 视觉定位原理
本视觉系统采用双CCD摄像头光学系统,其中一个摄像头安装在Z向固定支架上,在整个键合过程中不作任何运动,在芯片吸取、芯片与基板对中过程中提供参考,在吸取和键合前,调整芯片XY位置及轴旋转角度,使其与摄像头靶心对准。另一个摄像头与芯片吸附台和键合工作台固定,共同进行XY平面运动,在芯片吸取后获取芯片偏移情况,对基板进行微小调整。其定位原理图如图1所示。

开始键合工作前,芯片与基板放置在指定工作台上,如果芯片与基板不在视觉系统的视觉范围内,则驱动平动台按指定算法搜索芯片与基板;待获取芯片位置后,驱动平动台移动一固定位差,完成芯片与基板的物理对准。但实验中发现,在芯片被拾取的过程中会发生偏移,所以必须在芯片运动到基板正上方对准之前再次启动视觉系统从下方仰视被吸附后的芯片,获取芯片被吸附后的实际位置,实现芯片凸点与基板焊盘的对准。通过坐标变换实现对准精确无误、在物理上仍相差一固定位差,程序记录后由机械运动机构实现物理对准,主要包括XY平面的位置运动控制、Z轴竖直方向的位置运动控制以及芯片旋转定位轴、基板旋转定位轴的旋转角度控制。本系统中,位置反馈信号由光栅尺提供,属于闭环控制。上位机进行路径规划,将运动指令和位置数据传给伺服控制器,伺服控制器进行插补、加减速控制,生成路径。
2 实验数据采集
热超声倒装键合技术是芯片在一定的压力、温度和超声波能量共同作用下,凸点与基板的焊盘产生结合力,从而实现芯片与基板的键合。
本实验是在自主开发的热超声倒装键合实验台上展开的,采用的芯片夹持方式为压力约束模式,倒装工具是实心的钨钢圆柱体,试验采用的芯片是1mm×1mm的硅芯片,表面有8个直径约50μm、高度约30μm、对称分布的键合凸点,试验用的基板是铜基板,如图2所示。热超声倒装键合试验台的键合力在0~11.76N可调;基板温度在0℃~400℃可调;超声功率在0~5W可调;键合时间在0~500ms可调;声频率为60kHz±2kHz。

采集到的光信号经双CCD摄像头转换成电信号,再由图像采集卡(型号为Matrox Meteor-II/Stan-dard)将摄像机采集到电信号转换成计算机能处理的数字信号,最后通过由Adpat公司开发的HexSight软件对图像数据进行分析处理。热超声倒装键合实验台的视觉定位系统构成如图3所示。

3 视觉系统误差理论分析
识别定位误差由平移误差和旋转误差[8-9]组成。平移误差是指芯片识别位置与其真实位置半径T之间的误差,如图4所示。


式中,ext为沿X轴的误差分量,eyt为沿Y轴的误差分量。
旋转误差是指识别结果与当前芯片、基板的真实位置之间的角度误差,如图5所示。为了简化分析,利用芯片封装角的位移近似表示这种误差,可利用下列等式求得:


式中,R为旋转误差引起的真实位置偏移;L为从芯片中心到封装角的距离;θ为识别位置到芯片真实位置最大角度偏离。
旋转误差在X、Y轴上的投影误差分量分别为ext、eyt,其表达式为:

4 视觉系统定位精度的实验研究
4.1热超声倒装键合台系统误差的确定
在芯片键合过程中,需要在三个工步完成对象的识别:首先芯片台拾取芯片时对芯片进行定位,控制键合头将芯片吸附;其次,在芯片台与基板台之间,根据芯片定位标志对芯片进行精确定位;最后根据芯片拾取后的位置,对基板位置进行调整。将三个图像的模式在同一个模式库中建立,在系统初始化时同时加载,通过在各图像模式中添加不同个数的参考点来区别当前对象。
在建立好对象搜索模式库后,对芯片的摆放位置不做任何调整,保持芯片在建立搜索模式库时的初始位姿,这时芯片位置应该为0°,采集其图像进行识别定位。在采集数据过程中,采用拉依达法则判断数据是否存在异常值。
测量结果分别如表1、表2、表3所示。采集到的角度数据存储到文件,经Matlab编程处理后,结果如图6所示。


从图6可知,由拉依达法则判断为粗大误差值的个数很少,说明识别结果数据具有较好品质。
采用同样的测量方法,对X、Y方向上的识别精度分别采用不同的模式库进行测量,其结果分别如表4、表5、表6所示。采集到的角度数据存储到文件后,经过Matlab编程处理后,分别如图7、图8、图9所示。




通过分析以上建立的三个搜索模式库进行识别的结果可知,在X、Y方向上的识别精度是不等的,调整照明系统可使X、Y方向上的识别精度尽量趋于一致。
4.2 任意位姿的芯片识别精度分析
调定照明系统后,通过Hexsight图像处理软件对任意位姿的芯片进行识别精度分析。被测位姿分别为位姿1、位姿2、位姿3,识别结果分别如表7、表8、表9所示。


选取上述识别结果中最坏一组数据为例计算其综合误差,结果如表10所示。
通过校准后,单个像素的大小为10μm,测量误差为0.683μm,因此定位结果仅仅为1/20~1/10像素。
4.3 识别结果的优化
从实验分析的结果可以得出,其精度与视觉系统所要求的5?滋m的对准精度误差差距较大,要进一步提高识别精度,必须对识别结果进行优化。本文采用求平均值的方法,对识别结果进行优化,对n个连续识别的结果取平均值,减小某次测量结果的偶然性。n的取值是一个关键性问题,n过大,可以提高识别结果,但是大大降低了其执行速度; n太小,则没有起到对结果进行合理优化的效果。
下面是任意取3组数据,分别计算当采用不同值时的平均值与真值(多次结果的平均值)的对比结果,分别如图10、图11、图12所示。
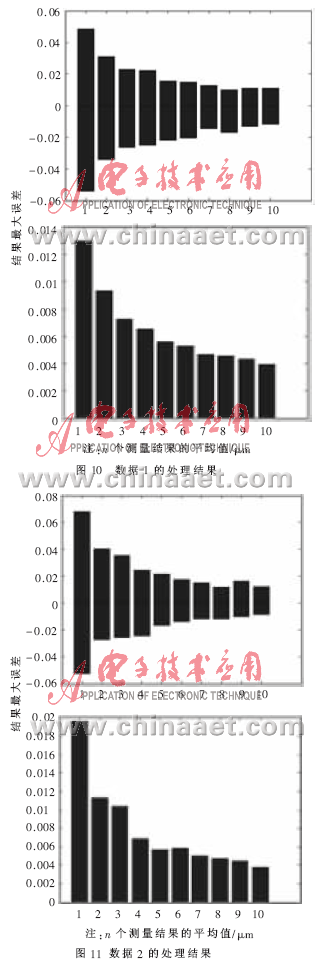

以上仅为部分数据的处理结果。从处理结果可以看出,当对4组取平均值时可以得到很好的效果。因此,从提高系统效率的角度出发可以选择采用对4组采集到的结果进行平均值处理后作为最终的结果,但当考虑标准偏差时,从上面的结果分析来看,取5次平均值作为最终结果,其单次结果更为稳定。因此,将5次实验误差的平均值,作为最终的识别结果。再次进行定位实验,得其误差如表11所示。

通过对结果进行优化后,系统识别综合误差大大减小,根据单个像素的大小为10μm,测量误差为0.183μm,其定位结果达到了1/50像素。
实验所用视觉定位系统采用双CCD成像光路,通过图像处理和模式识别的方法实现了对芯片焊盘图像的识别定位。本文对倒装键合实验台的视觉定位系统的误差进行了理论分析,并以热超声倒装键合实验台为平台,对实验用1mm×1mm的表面有8个凸点的芯片进行定位实验。根据实验结果,对视觉定位系统的平移误差和旋转误差进行了分析,并采用对5次识别结果取平均值的优化方法,从而将角度误差减小到0.023 766°,单项误差减小到0.183μm,综合误差减小到0.554μm,从而使其定位精度达到了热超声倒装键合过程中芯片与基板之间的定位精度的要求。
参考文献
[1] 葛劢冲.微电子封装中芯片焊接技术及其设备的发展[J]. 电子工业专用设备,2000(12).
[2] LUK C F,CHAN Y C,HUNG K C.Development of gold to gold interconnection flip chip bonding for chip on the suspension assemblies[J].Microeletronics Reliability,2002,42(3):381-389.
[3] KIM Y G. Thermocompression bonding effects on bumppad adhesion[J]. Microelectronics and Reliability,1996,36(4):550-556.
[4] 王福亮,李军辉,韩雷,等.压力约束模式下热超声倒装键合的试验. 中国机械工程,2006,17(18):1944-1947.
[5] 王福亮,李军辉,韩雷,等. 热超声倒装键合振动传递与键合强度形成研究.中国机械工程, 2006,17(22):2350-2353.
[6] LI Jian Ping, ZOU Zhong Sheng, WANG Fu Liang. The design and realization of machine vision system in flipchip bonder. 2006, 7th International Conference on Electronics Packaging Technology.2006:707-711.
[7] 雷源忠,雒建斌,丁汉,等.先进电子制造中的重要科学问题.中国科学基金,2002:204-209.
[8] 李建平,邹中升,王福亮.热超声倒装键合机视觉系统的设计与实现.中南大学学报(自然科学版),2007,38(1):
116-121.
[9] 张文典. 实用表面组装技术.北京:电子工业出版社,2002:213-221.

