文献标识码: A
DOI:10.16157/j.issn.0258-7998.181139
中文引用格式: 王福鑫,国凤娟,牛玉成,等. 基于SiP技术的微系统设计与实现[J].电子技术应用,2018,44(12):17-19,24.
英文引用格式: Wang Fuxin,Guo Fengjuan,Niu Yucheng,et al. Design and implementation of microsystem based on SiP technology[J]. Application of Electronic Technique,2018,44(12):17-19,24.
0 引言
随着电子技术的迅猛发展,对半导体芯片的小型化、高性能、轻量化和低成本的需求愈发迫切。系统级封装(System in Package,SiP)技术是将不同功能的芯片在外壳内进行多种形式的组合安装,从而构成完整系统的封装技术。与PCB相比,SiP具有重量轻、系统体积小、系统开发成本低、研制周期短及可靠性高等特点。
1 系统的总体设计
1.1 产品功能概述
微系统的电路功能框图如图1所示。该系统以FPGA和ARM为核心,ARM作为系统的控制单元,完成整个系统的AD采集,完成SRAM的控制,实现了16路数字量输入输出及2路RS-485总线。FPGA作为系统的桥接单元,实现了16路数字量输入输出,1路RS-485总线及1路校时模块等。与常规系统不同,SiP系统级封装设计选用的所有器件均为裸芯片,在该系统设计中,ARM处理器采用的是ST公司的STM32F103ZE,FPGA选用APA600,系统的SRAM、PROM、AD及接口电压转换均采用相应裸芯片。该微系统的封装形式为CQFP208。并且该微系统所有功能信号,如ARM下载、FPGA下载、电源信号均已引入到CQFP208的引脚上,在设计中芯片预留了ARM和FPGA的通用I/O管脚,可实现对微系统的充分利用。
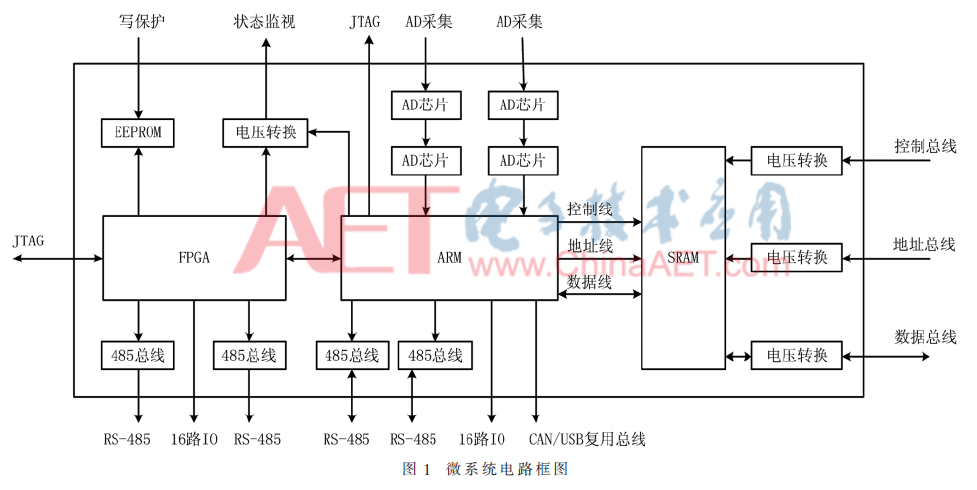
1.2 ARM电路
微系统采用STM32F103ZE作为系统的主控单元,STM32F103ZE以Cortex-M3为内核,具有512 KB的闪存存储器,通用的DMA通道,支持很多通用接口。根据需要,将2路RS-485总线、USB/CAN复用总线及16路IO通道引到了SiP的外部管脚上。ARM和FPGA的数据交换采用串行通信的方式进行。
1.3 模拟量输入电路
微系统具有8路模拟信号采集功能,可实现0~10 V内信号采集,且可同时对8路模拟信号采集,信号经过跟随处理,最终被微系统中的ARM识别。实现框图如图2所示。

1.4 SRAM电路
微系统中采用的SRAM,左右两个读写端口各自具有独立的读写控制信号,SRAM的左端口由微系统中ARM控制,右侧端口通过电平转换电路,由外部系统进行控制。
结构框图如图3所示。

1.5 结构设计方案
微系统采用中电13所的多层氧化铝高温共烧陶瓷(HTCC)外壳制造工艺,设计上下两个独立腔体,引线采用四面扇出(QFP208)方式,封装外形尺寸如图4所示。

微系统最终采用10层氧化铝高温共烧陶瓷技术,将封装外壳设计为上下两个独立腔体,采用微组装工艺进行了封装。
按照功能模块划分,上腔体内部集成FPGA、E2PROM、485总线芯片、电平转换芯片,下腔体集成ARM、SRAM、485总线芯片、电平转换芯片、AD模块。ARM和FPGA间采用内部走线互联。模块内部采用芯片均为裸芯片。
2 SiP产品实现
微系统产品的实现框图如图5所示,首先采用SiP技术对由裸芯片组成的微系统进行设计,根据SiP输出的生产文件,投产陶瓷外壳,最后进行组装、封装。

2.1 SiP产品设计
SiP设计主要包括建立中心库、原理图设计、工艺参数设置、裸芯片布局、引线键合、布线、输出生产文件、工艺设计等。
中心库:是SiP设计的基础资源,需要根据裸芯片上die pad和成品芯片的对应关系建立。
布局:SiP布局是三维设计,在本产品中主要用到了平铺模式和上下双腔体模式。
引线键合(wire bonding):是通过金丝键合的方式将裸芯片的die pad与陶瓷基板上的bonding pad连接起来。引线键合的合理性和准确性决定了产品的组装难度、良品率、可靠性。die pad是芯片厂家定义的,很多时候是集成度较高的芯片,厂家不提供裸芯片上die pad和成品芯片的管脚对应关系,需要根据成品芯片的X光照片,编辑die pad和die pin关系表。bonding pad和boning wire需要设计者根据工艺水平进行设计。
布线:本产品采用中电13所的HTCC工艺要求进行布线,主要工艺流程包括生瓷带制备、打孔、填孔、图形印刷、叠片、层压、排胶、烧结、电镀等几十道生产工序。
组装工艺流程主要包括外壳清洗、芯片粘接、引线键合、激光打标密封等。
产品的3D视图如图6所示。

2.2 产品工艺兼容性设计
双腔体陶瓷结构封装的电路组装,在组装时考虑双面组装顺序、多种焊接/粘接工艺、自动/手动金丝键合等,需遵循工艺温度递减原则,避免焊点重熔导致质量隐患。组装过程涉及到清洗、导电胶粘接、绝缘胶粘接、再流焊、金丝键合、平行缝焊等多种微组装工艺,按照元器件在模块上下腔的设计布局位置,先进行上腔体的组装,再进行下腔体的组装。上腔体芯片粘接采用温度较高的导电胶,固化温度比较高,下腔体的组装温度相对上腔体固化温度稍低,选用温度较低的锡铅焊料和粘接胶,达到上下腔体组装工艺的兼容性。同时为提高金丝键合可靠性,避免金丝键合点经受高温冲击,在上下腔体内芯片粘接固化后,再开展上下腔体内芯片的金丝键合。
2.3 产品组装
电路微组装后实物照片如图7、图8所示,解决了产品组装密度大、空间尺寸小、工艺复杂的难题。电性能指标满足用户使用要求。

3 结论
SiP技术是实现高密度系统集成的重要途径之一,能够满足航天设备对系统集成电路空间尺寸和功能集成的要求,结合现有成熟的微组装工艺,实现了电子产品的轻小型化、高度集成化,研制出的产品可靠性满足军用等级要求。
参考文献
[1] 拉奥R·图马拉,马达范·斯瓦米纳坦.系统级封装导论-整体系统微型化[M].刘胜,等,译.北京:化学工业出版社,2014.
[2] 李扬,刘杨.SiP系统级封装设计与仿真[M].北京:电子工业出版社,2012.
[3] 李凯瑞,恩洛.混合微电路技术手册-材料、工艺、设计、试验和生产(第2版)[M].朱瑞廉,译.北京:电子工业出版社,2004.
作者信息:
王福鑫,国凤娟,牛玉成,詹兴龙
(山东航天电子技术研究所,山东 烟台264003)

