文献标识码: A
DOI:10.16157/j.issn.0258-7998.199801
中文引用格式: 郭方金,王维波,陈忠飞,等. 太赫兹固态放大器研究进展[J].电子技术应用,2019,45(8):19-25.
英文引用格式: Guo Fangjin,Wang Weibo,Chen Zhongfei,et al. Research progress of THz solid state amplifier[J]. Application of Electronic Technique,2019,45(8):19-25.
0 引言
广义上,太赫兹(THz)波指频率处于100 GHz~10 THz(即对应波长为3 mm~30 ?滋m)范围内的电磁波。太赫兹波处在毫米波到红外之间的过渡区域,是宏观经典理论向微观量子理论的过渡,如图1所示[1]。由于大功率源以及相关检测设备的缺乏,这个频段很长一段时间没有被科学家和工程师进行相关研究,被称为“太赫兹空隙”(THz gap)[1-6]。
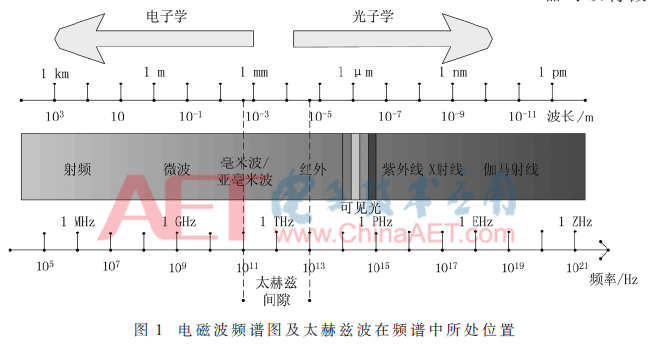
由于处于微波和光波之间的位置,太赫兹波综合了电子学以及光子学的一些特征,同时又有着它独特的特性:(1)穿透性:太赫兹波可以以不同的衰减率穿过不同介质。大气对于太赫兹波有着复杂的吸收作用,在0.1 THz~1 THz之间的太赫兹频段分布着多个大气窗口,如140 GHz、220 GHz、340 GHz、410 GHz、667 GHz等频率附近为大气窗口。(2)分辨率:成像分辨率随着电磁波波长减小而提高,将太赫兹波用于成像时分辨率好于微波。(3)光谱学:不同固体和气体材料对0.5 THz~3 THz的太赫兹波有不同的光谱特征,许多生物蛋白、半导体中电子和纳米结构共振频率落在太赫兹频段,使得太赫兹波可以用于材料无损检测。(4)非电离性:因为太赫兹波光子能量低,并不会激发物体电离效应,使得太赫兹波应用具有安全性。
正是因为以上特性,使得太赫兹波在太赫兹通信、太赫兹成像、无损探测、雷达、电子对抗和精确制导等方面有广阔的应用空间。体积小并且能够产生足够输出功率、频率灵敏度的太赫兹源是太赫兹技术发展面临的最大瓶颈之一。在电子学向光学过渡的太赫兹频段,信号可以由电真空器件、固态器件以及光学技术等多种方法产生,如图2所示[1]。其中电真空器件能产生足够高的输出功率,但是体积较大,工作需要高电压,使用寿命和长期可靠性差;光学太赫兹源具有极宽的输出频谱,且可调谐性能较好,输出功率也较高;而固态器件的主要优点是体积小、集成度高、可靠性高、规模化生产后成本低且供电要求低。
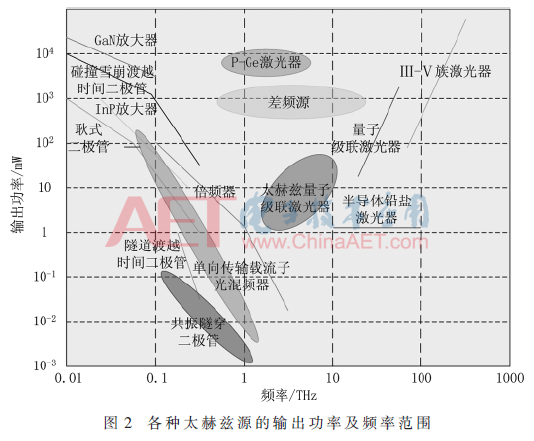
固态器件主要指采用基于半导体的固态电子器件构成的微电子集成电路,这些电路可以实现太赫兹源,以及对太赫兹信号进行混频、倍频和放大等功能,实现对特定频率的太赫兹波的产生与探测。目前通过固态器件可以获得频率超过2 THz的太赫兹源和达到THz的信号探测和处理[6]。在太赫兹系统中,由于信号很微弱,因此增益和输出功率是THz系统最为重要的资源。放大器可以将微弱的太赫兹信号进行放大,它决定了系统的作用距离、抗干扰能力以及通信质量和灵敏度,是太赫兹系统最关键的部件之一,用各类半导体实现的固态放大器可以使太赫兹系统集成度高、体积小、重量轻、能耗低。所以,太赫兹固态放大器成为了最具发展和应用前景的太赫兹电路。
本文将介绍基于化合物半导体的太赫兹固态放大器的研究进展,重点介绍基于GaN HEMT工艺、InP HEMT工艺和InP HBT/DHBT工艺的太赫兹单片放大器研究进展。
1 半导体材料和器件分类
按照时间顺序,可以将以Ge、Si为代表的半导体划为第一代半导体,第一代半导体以大的晶体尺寸和窄的线条宽度为技术水平标志,其产品以大规模、超大规模集成电路为代表,覆盖了绝大部分的电子产品,推动了信息社会的快速发展。以砷化镓(GaAs)、InP等Ⅲ-Ⅴ族化合物为代表的半导体可以划为第二代半导体,第二代半导体以通信速度、信息容量和存储密度为技术水平标志,其产品形式以微波、光发射和接收器件为主,大大推动了微波、光通信产业的发展。以碳化硅(SiC)、GaN、氮化铝(AlN)以及金刚石为代表的化合物可以划为第三代半导体,第三代半导体主要以宽禁带材料为主,禁带宽度一般介于2 eV~7 eV之间。表1列出了Si、锗化硅(SiGe)、GaAs、InP以及GaN半导体材料的特性参数,可以看出,与第一代、第二代半导体相比,由于固有的宽禁带宽度、高热导率、高二维电子气浓度、快的电子迁移率、高的击穿电场等特性,使得以宽禁带半导体材料为基础的第三代半导体器件具有大功率密度、抗辐射、耐高温、超高频等优异性能[7-8]。

用于太赫兹频段放大器的半导体器件,可以按照半导体材料简单地分成两类,一类是Si基器件,另一类是Ⅲ-Ⅴ族化合物基器件。Si基器件主要为互补金属氧化物半导体(Complementary Metal Oxide Semiconductor,CMOS)器件和SiGe双极互补金属氧化物半导体(Bipolar CMOS,BiCMOS)器件,Ⅲ-Ⅴ族化合物器件主要包括GaAs赝配型高电子迁移率晶体管(Pseudomorphic HEMT,PHEMT)器件、GaAs改性高电子迁移率晶体管(Metamorphic HEMT,MHEMT)器件、InP HEMT器件、InP HBT器件和GaN HEMT器件。
在100 GHz以下频段,尤其是RF频段,Si基器件在半导体市场中占据主导地位,然而在太赫兹频段应用时,Ⅲ-Ⅴ族化合物基器件比Si基器件更有优势,主要表现在:
(1)Ⅲ-Ⅴ族化合物基器件比Si基器件有更高的电子迁移率,所以使得化合物基器件可以工作在更高的频率;
(2)Ⅲ-Ⅴ族化合物基衬底材料电阻率比Si基衬底材料的电阻率高几个数量级,所以在Ⅲ-Ⅴ族化合物基衬底上制作的传输线、电感等损耗更低,尤其对于功率放大器而言,低电阻率的衬底可以降低器件效率,由于趋肤效应引起的寄生参数和衬底损耗可以使得最大振荡频率fMAX下降至少36%~50%,也会降低器件在高频的增益[9]。
(3)Ⅲ-Ⅴ族化合物基材料往往是宽带隙材料,所以Ⅲ-Ⅴ族化合物基器件一般比Si器件具有更大的击穿电压。
然而相比Si基器件,Ⅲ-Ⅴ族化合物基器件也有自己明显的劣势,主要表现在电路集成度低、成本高、长期可靠性差、器件模型不够精确和可用仿真软件少等。
虽然Si基器件主要应用在100 GHz以下频段,但是随着工艺的进步,器件特征尺寸越来越小,器件最大振荡频率越来越高,使得Si基器件也可以应用在太赫兹频段。另外,CMOS绝缘衬底上硅(Silicon on Insulator,SOI)技术和SiGe技术可以从很大程度上减少衬底损耗,并且SiGe器件也可以提供大的功率密度,这些改善都使得Si基器件在太赫兹频段的应用非常有潜力,只不过目前从性能上来说,Ⅲ-Ⅴ族化合物基器件仍然优于Si基器件。
2 基于GaN HEMT器件的太赫兹放大器研究进展
20世纪90年代中期GaN HEMT诞生。GaN是宽禁带材料,具有电子饱和速度高、击穿场强高、SiC衬底导热性好、抗辐照等特点,且在AlGaN/GaN界面上存在自极化和压电等新的物理效应,其二维电子气密度高达2×1013 cm-2,因此GaN HEMT器件具有高功率密度的能力。但是,由于GaN相对较低的电子迁移率、频率特性不是很好,因此GaN HEMT器件可以用来进行THz低频段功率放大器的设计。
美国HRL实验室在GaN HEMT器件和电路的研究上处于国际领先地位,该实验室报道的用于毫米波、THz频段的GaN HEMT T型栅器件性能如表2所示,表中列出了3种不同栅长T型器件的电流增益截止频率fT、最大振荡频率fMAX、击穿电压Vbrk和50 GHz处最小噪声系数Fmin。其中T4A器件fT=329 GHz和fMAX=558 GHz为目前已知的具有最高电流增益截止频率和最大振荡频率的GaN HEMT器件。

2014年,文献[10]报道了HRL实验室应用T3器件设计的单级G波段功率放大器,放大器测试结果表明,输出功率密度296 mW/mm,电路增益4.5 dB,效率3.5%,这是报道的第一款GaN G波段功率放大器。文献[11]报道了采用同样的T3器件,实现了一款110~170 GHz的宽带功率放大器,增益>25 dB,噪声系数大约6 dB,饱和输出功率12 dBm,可以看出GaN HEMT器件不仅具有高的饱和输出功率,而且具有相对较小的噪声系数。文献[12]报道了采用T2器件设计的G波段功率放大器,电路采用4级电路结构,每级管芯大小为4 μm×25 μm,电路在149 GHz处有最大增益8.7 dB,测得芯片最大输出功率为18.2 dBm,这是已报道的G波段最大输出功率的GaN MMIC功放。
应用GaN HEMT器件的太赫兹功率放大器报道很少,除了HRL实验室的上述相关报道外,大部分报道集中在太赫兹频段低端,也就是100 GHz附近。2006年,HRL实验室在文献[13]中第一次报道了W波段GaN功放,从此,关于W波段的GaN功放报道逐渐增多。2010年HRL实验室报道了一款W波段功放,连续波条件下饱和输出功率为842 mW,功率附加效率为14.7%,功率增益为9.3 dB[14]。2015年Quinstar公司报道了一款宽带的W波段功放,电路工艺为HRL公司的T2工艺,芯片采用片上行波功率合成网络,连续波工作条件下,在75~100 GHz频段最小输出功率为2 W,峰值输出功率为3 W,脉冲工作状态下峰值输出功率为3.6 W。芯片照片如图3所示[15]。
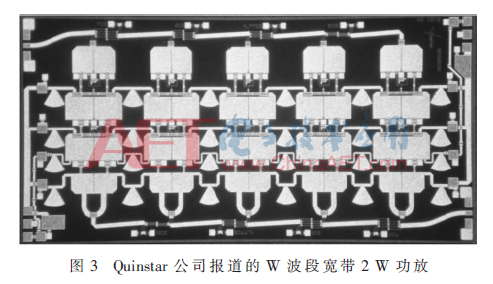
2017年德国IAF(Fraunhofer Institute for Applied Solid-State Physics)研究所报道了第一款采用三维栅GaN HEMT器件的W波段功放,采用三维栅结构器件可以有效克服传统平面栅引起的短沟道效应。报道的功放在86~94 GHz频段输出功率为30.6 dBm,功率附加效率为8%,功率增益为12 dB[16]。
2018年美国加州大学圣巴巴拉分校报道了一款N-ploar型GaN HEMT器件,器件栅长为75 nm,fT=113 GHz,fMAX=238 GHz,工作电压20 V时,功率密度为8 W/mm@94 GHz,是目前为止报道的W波段最高功率密度的GaN器件[17]。
与国外相比,国内在太赫兹GaN功放研究方面也取得了一系列成果,与国外差距不大。2016年中国电科55所报道了一款W波段功放[18],采用0.1 μm GaN HEMT器件,器件fT=90 GHz,fMAX=210 GHz,芯片在90 GHz最大输出功率为1.17 W,功率附加效率为13 %,功率增益为11 dB,输出功率密度为2.3 W/mm。2017年中国电科55所又报道了一款平衡式W波段功放[19],功放采用0.1 μm GaN HEMT工艺制造,电路采用三级结构,在88~93 GHz频段,小信号增益大于15 dB,输出功率大于2.5 W,91 GHz实现峰值输出功率3.1 W,输出功率密度为3.23 W/mm,这是目前为止国内报道的最高功率的W波段功放,功放芯片图和性能曲线如图4所示。中国电科13所公布了一款G波段功放产品,在210~220 GHz频段,小信号增益大于15 dB,输出功率大于10 dBm。中国电科55所研制的一款G波段功放采用50 nm GaN HEMT工艺,在150~170 GHz频段,小信号增益大于25 dB,是目前为止国内最高增益的G波段GaN功放。
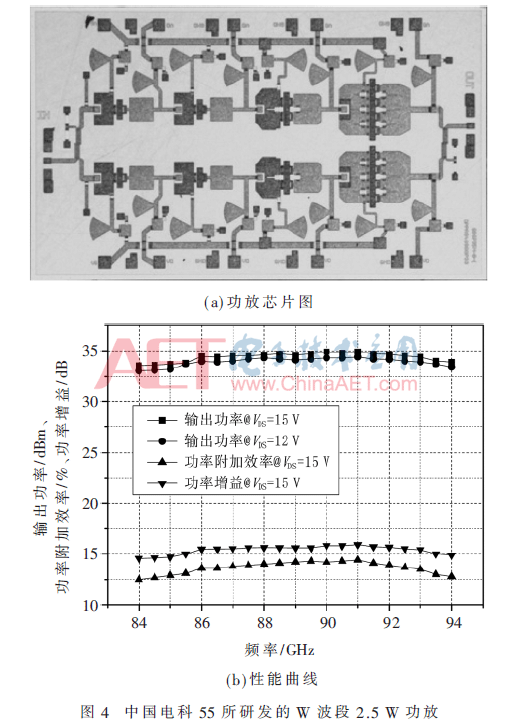
3 基于InP HEMT器件的太赫兹放大器研究进展
InP是重要的Ⅲ-Ⅴ族化合物材料之一,是发展太赫兹频段芯片的首选材料。由表1可以看出,相比其他材料,InP电子迁移率具有很大优势,但是禁带宽度较小,所以InP基器件可以用来进行THz高频、高增益、低噪声的小信号放大器设计。InP基器件主要分为InP HEMT和InP HBT两种,凭借优异的频率和增益性能,是用于THz芯片设计的最佳选择。
近年来基于InP HEMT器件的太赫兹技术发展迅速,已经开发出了100 nm、50 nm、35 nm、30 nm、25 nm栅长的典型器件,器件的fT、fMAX不断提高,fMAX已经可以达到1.5 THz,已经研制了频率在0.48 THz、0.67 THz、0.85 THz和大于1 THz的电路,在InP HEMT电路研究方面,美国诺格公司(Northrop Grumman)处在行业领先的位置。
2008年德国IAF研究所采用50 nm栅工艺技术制备了210 GHz低噪声单片电路。该工艺采用沟道InGaAs含量为0.8的MHEMT材料,制备的管芯最大电流密度及最大跨导分别达到1 200 mA/mm及1 800 mS/mm。其管芯的fT和fMAX分别可达380 GHz及500 GHz,该电路可在180 GHz~210 GHz频段内增益达到16 dB,噪声系数达到4.8 dB[20]。美国诺格公司(Northrop Grumman)2008年研制的35 nm InP HEMT器件,其fMAX达到了1.2 THz。2011年,诺格公司研制的0.65 THz低噪放在629~638 GHz增益达10 dB,在640 GHz其饱和输出功率达到1.7 mW。该器件采用的是30 nm T型栅,材料是InAs/InGaAs组合沟道,管芯的最大电流密度和最大跨导分别达到900 mA/mm及2 300 mS/mm,其fT和fMAX分别为0.6 THz和1.2 THz[21]。2015年,诺格公司进一步研制的1 THz低噪放,器件采用的是25 nm T型栅,其fT和fMAX分别为0.61 THz和1.5 THz,在1 THz处最大可用增益为3.5 dB。采用该工艺制备的10级CPW集成电路放大器,每级采用2 μm×4 μm管芯结构,测试结果显示在1 THz处放大器增益为9 dB,在1.05 THz处增益为7 dB,这是目前为止报道的第一款可以工作在大于1 THz的放大器,电路照片和测试结果如图5所示。该结果表明InP HEMT基放大器在THz高频段潜力巨大,是未来THz放大器发展的重要方向[22]。2010年诺格公司报道了一款采用亚50 nm InP HEMT工艺的功放,芯片采用8路片上功率合成的方式,在217.5 GHz~220 GHz实现了输出功率大于50 mW,是目前已报道的最大输出功率的InP HEMT功放[23]。
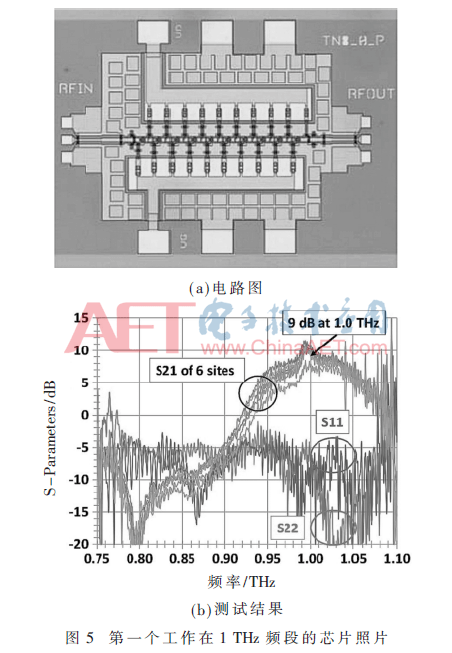
国内在InP HEMT器件和电路方面也进行了许多卓有成效的工作,主要研究单位有中国电子科技集团公司第55、第13研究所、中国科学院微电子研究所等,2016年中国电科第55研究所报道了基于自主70 nm InP HEMT工艺的W波段低噪声放大器,芯片在75~110 GHz频段,增益大于20 dB,噪声系数小于3.5 dB。中国电科55所目前已经成功开发了35 nm InP HEMT工艺,35 nm InP HEMT器件fT>400 GHz,fMAX>550 GHz。中国电科13所报道了基于90 nm InP HEMT工艺的220 GHz低噪声放大器,增益为20 dB,噪声系数为7.5 dB。
总体上,相比国外,国内无论是在InP HEMT工艺水平还是电路性能上都差距比较大,今后还要加强在这一方向的研究。
4 基于InP HBT/DHBT器件的太赫兹放大器研究进展
InP HBT/DHBT器件由发射极、集电极和基极组成,目前国外InP HBT器件发射极线宽已缩小到250 nm、200 nm、130 nm,fMAX>1 THz。InP HBT器件具有高频率、高功率的特点,因而可以用来进行THz功放的设计,InP HBT器件还具有相位噪声低、频带宽、集成能力高的特点,因而可以用来进行线性功放和超高速电路的设计,美国Teledyne公司在THz InP HBT电路研究方面处于行业领先的位置。
2011年美国Teledyne公司报道了130 nm InP DHBT技术,发射区结面积为0.13 μm×2 μm,fT>520 GHz,fMAX>1.1 THz,共发射极击穿电压为3.5 V,这是当时HBT器件的最高水平[24]。2013年Teledyne公司报道了采用130 nm InP DHBT工艺研制的670 GHz InP HBT放大器,在600~680 GHz频段增益为20 dB,在片功率测试表明,585 GHz下饱和输出功率为-4 dBm,670 GHz时饱和输出功率为-7.5 dBm,这是已报道的工作频率最高的放大器[25]。2015年,NGAS公司报道了600 GHz功率放大器,在传统的200 nm InP HBT器件工艺基础上将器件结构从InP衬底转移至SiC衬底,有效降低了HBT的结温,提高了器件的高频性能,制作的9级共发射极放大器小信号增益为9 dB,5级共基极放大器小信号增益为19 dB,这是目前报道的工作频率最高的进行了衬底转移的放大器[26]。2014年诺格公司报道了一款220 GHz频段的功率放大器,芯片采用250 nm InP HBT工艺,总的发射极面积为18 μm2,放大器在210~230 GHz频段实现增益大约5 dB,在210 GHz实现最大饱和输出功率90 mW,功率附加效率10%,这是在该频段报道的最大功率附加效率的放大器[27]。2014年Teledyne公司报道了一款200 GHz左右的功放,功放采用250 nm InP HBT工艺,采用低插损的威尔金森功分器实现了3级16路功率单元的合成,芯片在10 dBm注入功率条件下,在210 GHz实现了23.2 dBm的功率输出,在235 GHz实现了21 dBm的功率输出,功率增益大于11 dB,在206~243 GHz频段小信号增益大于24 dB,这是到目前为止第一款报道的在200 GHz以上频段实现大于200 mW的MMIC芯片,代表了目前THz频段大功率单片的最高水平[28]。
国内在THz InP HBT/DHBT技术方面起步较晚,研制的电路主要集中在THz低频段,研究单位主要包括中国科学院微电子研究所、中国电子科技集团公司第55、第13研究所。近年来,国内在InP HBT工艺和器件研究方面不断进步,器件fT、fMAX不断提高,InP HBT功率放大器频率达330 GHz左右,中国电子科技集团公司第55研究所代表了国内最高水平[29]。2013年,55所报道了采用台面结构和平面化技术在3英寸InP衬底上设计和制作了InGaAs/InP DHBT,fMAX=325 GHz,击穿电压为10.6 V,适合开发THz低频段电路。2015年,该团队制作出了共基极四指In-GaAs/InP DHBT,发射极线宽缩短为0.5 μm,fMAX提高到535 GHz,击穿电压降至4 V[30]。2016年,55所报道了一款140 GHz左右HBT功率放大器,芯片采用0.5 μm InP DHBT工艺,电路拓扑结构采用四级共射放大电路结构,采用威尔金森功分器进行四路功率合成,放大器在140~160 GHz频段内,小信号增益大于20 dB,140 GHz时饱和输出功率达13.6 dBm[31]。2018年,55所报道了一款工作在H波段的HBT功率放大器,芯片采用0.5 μm InP DHBT工艺,工作频带为275~310 GHz,在300 GHz增益大于7.4 dB,在280 GHz实现最大增益12.5 dB,这是国内报道的第一款工作在H波段的 InP HBT功放[32],芯片图和S参数测试结果如图6所示。
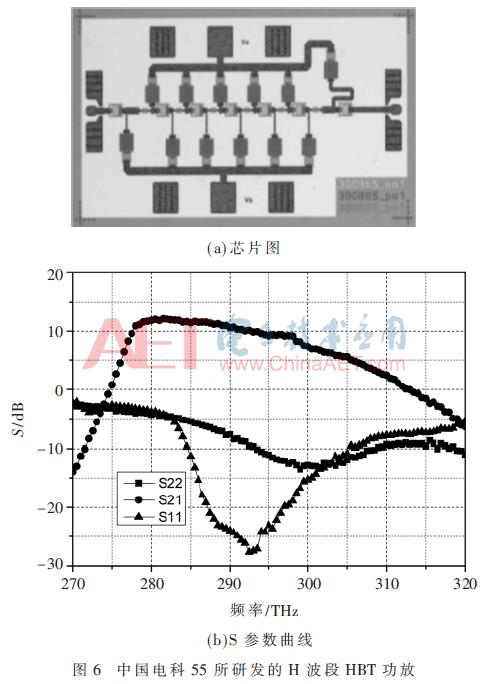
5 结论
THz固态放大器的发展是基于半导体技术和微波技术的共同进步,目前Ⅲ-Ⅴ族化合物基THz固态放大器的研究已经进入THz频段,以GaN HEMT、InP HEMT和InP HBT为代表的Ⅲ-Ⅴ族化合物基器件的技术进步推动着固态放大器向THz频域的不同方向发展。
GaN HEMT基器件特征尺寸目前已经可以达到20 nm,器件最大振荡频率可以达到558 GHz,在G波段已经可以实现18.2 dBm的功率输出。所以未来一段时间内,GaN HEMT基固态放大器的发展主要集中在THz的低频段,包括W、D、G甚至H频段。GaN HEMT基固态放大器除了可以实现高功率放大器外,还可以实现相比GaAs、InP等具有高P-1、耐大功率的低噪声放大器,是未来实现THz收发一体多功能芯片的首选。
InP HEMT基器件特征尺寸目前已经可以达到25 nm,器件最大振荡频率可以达到1.5 THz,在1 THz处已经研制成功了放大器芯片,增益为9 dB。所以未来InP HEMT基固态放大器是实现THz频段高频、低噪声放大器芯片的第一选择。另外,在THz低频段,InP HEMT基固态放大器通过片内合成的方式,也可以实现小功率的放大器芯片。
InP HBT基器件特征尺寸已经可以达到130 nm,器件最大振荡频率大于1.1 THz,已经实现670 GHz频段 HBT芯片,另外InP HBT基放大器实现了200 GHz附近大于200 mW的功率输出。所以未来在200 GHz~1 THz频段进行高功率、高增益、宽带、高线性放大器研究,InP HBT基放大器一定会成为优先选择。
国内在THz固态放大器研究上已经取得了一定的基础和成果,但是与欧美等发达国家相比,还有很大差距,在THz半导体材料设计、THz器件结构设计、THz器件建模、THz电路设计、THz测试技术以及THz电路可靠性等一系列关键技术上,国内还有很大差距,目前国内还没有可以批量工程化应用的THz芯片。未来,随着5G/6G技术、物联网、信息感知等技术的发展,太赫兹技术必将成为影响国民经济、国防现代化的关键技术,未来需要太赫兹领域相关从业者不断努力,共同推进国内太赫兹技术的进步。
参考文献
[1] 李骁.太赫兹InP DHBT收发芯片关键技术研究[D].成都:电子科技大学,2018.
[2] SIEGEL P H.Terahertz technology[J].IEEE Transaction on Microwave Theory and Technique,2002,50(3):910-928.
[3] HOSAKO I,SEKINE N.At the dawn of a new era in terahertz technology[J].Proceedings of IEEE,2007,95(8):1611-1623.
[4] 刘盛纲,姚建铨,张杰,等.太赫兹科学技术的新发展[C].第270次香山会议,北京,2005.
[5] 牧凯军,张振伟,张存林.太赫兹科学与技术[J].中国电子科学研究院学报,2009,6(3):221-230.
[6] 金智,苏永波,张毕禅,等.InP基三端太赫兹固态电子器件和电路发展[J].太赫兹科学与电子信息学报,2013,11(1):43-49.
[7] 姜霞.AlGaN/GaN HEMT模型研究及MMIC功率放大器设计[D].天津:河北工业大学,2011.
[8] 李欧鹏.太赫兹InP HBT非线性模型及单片放大器研究[D].成都:电子科技大学,2017.
[9] LIU I,MA K,MOU S,et al.A review of recent power amplifier IC[C].2017 10th Global Symposium on Millimeter-Waves,Hong Kong,2017:87-91.
[10] MARGOMENOS A.GaN technology for E,W and G-band applications[C].2014 IEEE Compound Semiconductor Integrated Circuit Symposium(CSICS),La Jolla,CA,2014:1-4.
[11] KURDOGHLIAN A.First demonstration of broadband W-band and D-band GaN MMICs for next generation communication systems[C].2017 IEEE MTT-S International Microwave Symposium(IMS),Honololu,HI,2017:1126-1128.
[12] FUNG A.Gallium nitride amplifiers beyond W-band[C].2018 IEEE Radio and Wireless Symposium(RWS),Anaheim,CA,2018:150-153.
[13] MICOVIC M.GaN HFET for W-band power applications[C].2006 International Electron Devices Meeting,San Francisco,CA,2006:1-3.
[14] MICOVIC M.W-Band GaN MMIC with 842 mW output power at 88 GHz[C].2010 IEEE MTT-S International Microwave Symposium,Anaheim,CA,2010:237-239.
[15] SCHELLENBERG J M.A 2-W W-band GaN traveling-wave amplifier with 25-GHz bandwidth[J].IEEE Transactions on Microwave Theory and Techniques,2015,63(9):2833-2840.
[16] TURE E.First demonstration of W-band Tri-gate GaN-HEMT power amplifier MMIC with 30 dBm output power[C].2017 IEEE MTT-S International Microwave Symposium(IMS),Honololu,HI,2017:35-37.
[17] ROMANCZYK B.Demonstration of constant 8 W/mm power density at 10, 30, and 94 GHz in state-of-the-art millimeter-wave N-Polar GaN MISHEMTs[J].IEEE Transactions on Electron Devices,2018,65(1):45-50.
[18] 吴少兵,高建峰,王维波,等.W波段GaN单片功率放大器研制[J].固体电子学研究与进展,2016,36(4):266-269.
[19] SHAOBING W.W-band AlGaN/GaN MMIC PA with 3.1 W output power[C].2017 14th China International Forum on Solid State Lighting:International Forum on Wide Bandgap Semiconductors China(SSLChina:IFWS),Beijing,2017:219-223.
[20] TESSMANN A.Metamorphic HEMT MMICs and modules for use in a high-bandwidth 210 GHz radar[J].IEEE Journal of Solid-State Circuits,2008,43(10):2194-2205.
[21] RADISIC V,LEONG K M K H,MEI X,et al.Power amplification at 0.65 THz using InP HEMTs[J].IEEE Transactions on Microwave Theory and Techniques,2012,60(3):724-729.
[22] MEI X.First demonstration of amplification at 1 THz using 25-nm InP high electron mobility transistor process[J].IEEE Electron Device Letters,2015,36(4):327-329.
[23] RADISIC V.A 50 mW 220 GHz power amplifier module[C].2010 IEEE MTT-S International Microwave Symposium,Anaheim,CA,2010:45-48.
[24] URTEAGA M,PIERSON R,ROWELL P,et al.130 nm InP DHBTs with ft >0.52 THz and fmax>1.1 THz[C].69th Device Research Conference,Santa Barbara,CA,2011:281-282.
[25] HACKER J,URTEAGA M,SEO M,et al.InP HBT amplifier MMICs operating to 0.67 THz[C].2013 IEEE MTT-S International Microwave Symposium Digest(MTT),Seattle,WA,2013:1-3.
[26] RADISIC V.InP HBT transferred substrate amplifiers operating to 600 GHz[C].2015 IEEE MTT-S International Microwave Symposium,Phoenix,AZ,2015:1-3.
[27] RADISIC V,SCOTT D W,CAVUS A,et al.220-GHz high-efficiency InP HBT power amplifiers[J].IEEE Transactions on Microwave Theory and Techniques,2014,62(12):3001-3005.
[28] GRIFFITH Z,URTEAGA M,ROWELL P,et al.A 23.2 dBm at 210 GHz to 21.0 dBm at 235 GHz 16-Way PA-Cell combined InP HBT SSPA MMIC[C].2014 IEEE Compound Semiconductor Integrated Circuit Symposium(CSICS),La Jolla,CA,2014.
[29] 王淑华.THz InP HEMT和HBT技术的最新研究进展[J].微纳电子技术,2018,55(6):381-387.
[30] NIU B,WANG Y,CHENG W,et al.Common base four-finger InGaAs/InP double heterojunction bipolar transistor with maximum oscillation frequency 535 GHz[J].Chinese Physics Letters,2015,32(7):175-178.
[31] 孙岩,程伟.140 GHz InP DHBT功率放大器[C].2016微波集成电路与移动通信学术年会,上海,2016.
[32] Sun Yan.A 300 GHz monolithic integrated amplifier in 0.5-um InP double heterojunction bipolar transistor technology[C].2018 International Conference on Microwave and Millimeter Wave Technology,ICMMT 2018-Proceedings,December,2018.
作者信息:
郭方金,王维波,陈忠飞,孙洪铮,周细磅,陶洪琪
(南京电子器件研究所,江苏 南京210016)

