东工大研发激光加工超薄晶圆技术,切片留白宽度缩小至原来四分之一
2020-08-21
来源:与非网
京工业大学科学技术创成研究院特种功能集成研究小组的特聘教授 -- 大场隆之教授于 2020 年 6 月宣布,研发了不会损伤超薄晶圆、晶圆切片留白(Dicing Street)宽度缩小至原来四分之一的激光切片加工技术。
根据日媒 Eetimes.jp 报道,此次新技术是以东京工业大学为主导,与研究小组“WOW 联盟”(由从事半导体元件设计、相关生产设备、材料的企业组成)合作研发的。
围绕半导体元件的高性能、低功耗技术研发在不断推进。比方说,晶圆厚度做到微米级别,运用 TSV(Through-Silicon-Via)排线技术做到三维压层等。
为了实现三维压层,切割薄膜晶圆时,需要消除晶圆边上的裂纹(Chippping)、且缩小切片留白(Dicing Street)的宽度。其中,被称为隐形切割(Stealth Dicing, SD)的激光切割技术颇受关注。
研发小组在此次研发中着重致力于薄膜晶圆切割工程中的“晶圆损伤程度与发生位置的定量分析”、“削减切片留白(Dicing Street)”。
在实验中,实验小组制作了线宽、线距分别为 1um 的 TEG(Test Element Group)检测晶圆。此款用于测试的芯片的 A1 和 Ti 的成膜厚度分别为 30nm。此外,为了检出晶圆的损害位置,在激光加工区域(即 Dicing Street 区域)平行地设计了间距为 1um 的“监测线路”。在切片后,计算了各个监测线路的阻值变化率,并评价了激光加工引起的损害。

左上为 TEG 晶圆,左下为排线结构、中间为排线的扩大图,右边为排线的断面构造图 (图片出自:东京工业大学)
实验中,使用了 TEG 晶圆,模拟“SDBG(Stealth Dicing Before Grinding)”工艺,使用波长为 1099nm 和 1342nm 的激光进行加工,评价了对厚度为 50um 的晶圆的损害程度。
实验表明,用波长为 1099nm 的激光进行加工后,排线的阻值没有增加,没有对晶圆造成损害。与之相对,用波长为 1342nm 的激光进行加工后,作业中心附近的排线阻值大幅度增加,且晶圆的加工中心附近被破坏。

左图:用波长为 1342nm 的激光切割后的排线阻值,右图:用波长为 1099nm 的激光切割后的排线阻值 (图片出自:东京工业大学)
同时也比较了用 SD 方法进行切割后的切片留白(Dicing Street)的宽度。在以往的 DBG(Dicing Before Grinding)工艺中,切片留白的宽度为 60um。此次使用 SDBG 工艺后,切片留白的宽度为 15um,宽度缩短了四分之一。芯片的面积越小,宽度的缩短越对提高芯片良率有益。
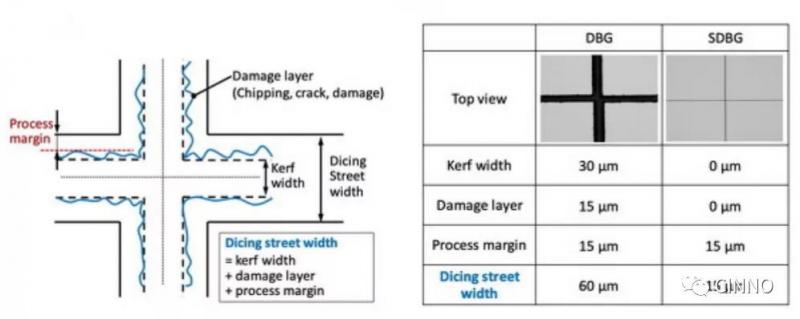
切片留白(Dicing Street)的宽度,左侧为概略图,右侧为 DBG 和 SDBG 的比较图 (图片出自:东京工业大学)

将留白宽度从 60um 缩短至 15um 后的芯片数量增长率(图片出自:东京工业大学)
未来,针对此次研发的 Damage Less Dicing(晶圆无损切割)技术的实用化,此研究小组的目标是尽快制造出波长为 1099nm 的激光专用光学引擎。

