ASML研究超级NA光刻机!2036年冲击0.2nm工艺
2024-02-18
来源:快科技
2月17日消息,ASML已经向Intel交付第一台高NA EUV极紫外光刻机,将用于2nm工艺以下芯片的制造,台积电、三星未来也会陆续接收,可直达1nm工艺左右。
那么之后呢?消息称,ASML正在研究下一代Hyper NA(超级NA)光刻机,继续延续摩尔定律。
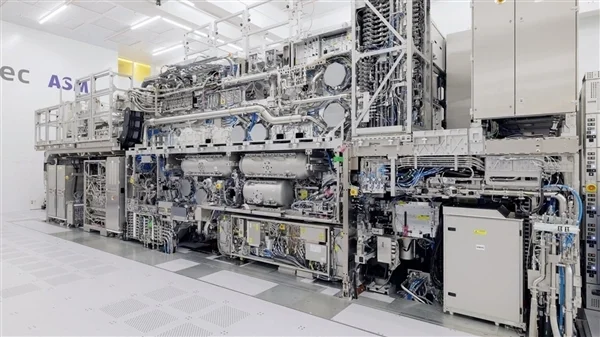
ASML第一代Low NA EUV光刻机只有0.33 NA(孔径数值),临界尺寸(CD)为13.5nm,最小金属间距为26nm,单次曝光下的内连接间距约为25-30nm,适合制造4/5nm工艺。
使用双重曝光,可将内连接间距缩小到21-24nm,就能制造3nm工艺了,比如台积电N3B。
第二代EUV光刻机提高到了0.55 NA,临界尺寸缩小到8nm,金属间距最小约为16nm,可制造3-1nm,比如Intel就透露会在1.4nm节点上首次使用。
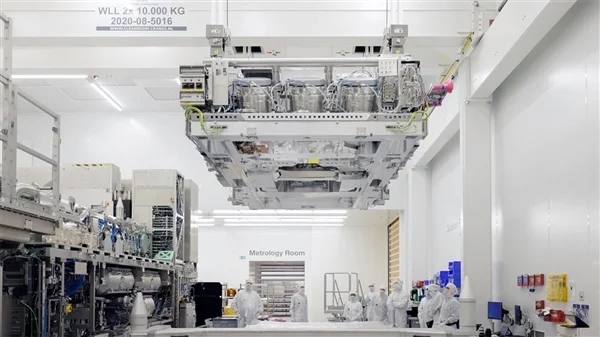
ASML CTO Martin van den Brink在接受采访时确认,ASML正在调查开发Hyper NA技术,继续推进各项光刻指标,其中NA数值将超过0.7,预计在2030年左右完成。
它表示,这种新型EUV光刻机适合制造逻辑处理器芯片,相比高NA双重曝光成本更低,也可用来制造DRAM内存芯片。
ASML已披露的数据显示,低NA光刻机的成本至少1.83亿美元,高NA光刻机更是3.8亿美元起步。

根据微电子研究中心(IMEC)的路线图,2030年左右应该能推进到A7 0.7nm工艺,之后还有A5 0.5nm、A3 0.3nm、A2 0.2nm,但那得是2036年左右的事儿了。
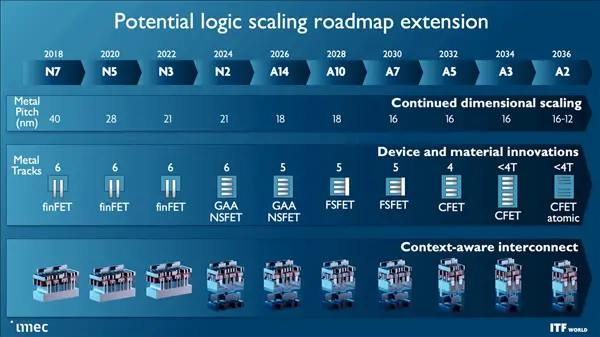

本站内容除特别声明的原创文章之外,转载内容只为传递更多信息,并不代表本网站赞同其观点。转载的所有的文章、图片、音/视频文件等资料的版权归版权所有权人所有。本站采用的非本站原创文章及图片等内容无法一一联系确认版权者。如涉及作品内容、版权和其它问题,请及时通过电子邮件或电话通知我们,以便迅速采取适当措施,避免给双方造成不必要的经济损失。联系电话:010-82306118;邮箱:aet@chinaaet.com。

