文献标识码: A
DOI:10.16157/j.issn.0258-7998.180945
中文引用格式: 张海华,吕玉菲,鲁中轩. 基于CMOS-MEMS工艺的高深宽比体硅刻蚀方法的研究[J].电子技术应用,2018,44(10):32-36,40.
英文引用格式: Zhang Haihua,Lv Yufei,Lu Zhongxuan. Etching technique of high aspect ratio silicon trenches based on CMOS-MEMS process[J]. Application of Electronic Technique,2018,44(10):32-36,40.
0 引言
近年来,随着军事、通信、汽车电子、航空航天工业、医疗和其他消费品等领域对传感器提出了更多更高的需求,微机电系统(MEMS)传感器凭借成本低、体积小、功耗低和发展多样等优势成为研究热点。进而在MEMS传感器设计制造和微电子封装过程中,刻蚀工艺成为了MEMS传感器加工的关键工艺,直接决定高精度、小体积、高集成度的传感器和传感器阵列设计制造的成败。其中,深硅刻蚀工艺在微电子封装中已被提出,即在硅圆片上制作出许多垂直互连深孔来实现不同芯片之间的电互连,硅深孔刻蚀工艺是MEMS加工领域一个重要技术。
在硅片上形成高深宽比沟槽或孔并具有垂直侧壁结构是现在先进MEMS器件或3D TSV封装常见工艺步骤。Bosch工艺是目前最常用的获得高深宽比刻蚀的方法。由于该工艺循环地进行刻蚀而且钝化交替加工来提高刻蚀的选择性,因此刻蚀的侧壁会出现锯齿状表面。对于TSV封装来说锯齿状表面影响不大,但是在MEMS器件阵列中用于制作支撑结构和隔离结构的深硅刻蚀来说,锯齿尖角形貌对于亚微米的微细结构性能影响已成为不可忽略的因素。
在MEMS器件加工过程中,想要得到高深宽比的硅槽,本文拟采用RIE、Bosch工艺以及RIE和Bosch工艺结合的方法获得槽侧壁非常光滑的深槽形貌。
1 实验与分析
在一种MEMS传感器阵列中,采用CMOS兼容工艺进行制备,但是普通的CMOS工艺不能满足器件结构体微加工的工艺要求,因此需要基于CMOS工艺进行部分MEMS工艺的开发。首先,隔离深槽作为器件隔离结构中最重要的一部分,其深宽比的设计要求为25/0.8,刻蚀的开口尺寸要求为0.8 μm,可填充深度大于25 μm,并且对侧壁光滑度和开口处形貌有较高的要求。
1.1 RIE单步工艺刻蚀方法
对于深宽比为25 μm/0.8 μm的深槽,最开始采用单步工艺的方法进行开发。对于单步工艺方法,即采用RIE单晶硅刻蚀方法,分为3个步骤:第一步是预刻蚀,用于去除自然氧化层和表面污染物来获得均匀的刻蚀,减少微掩蔽层污染物带来的表面缺陷;第二步是主刻蚀,使用气体SF6/O2进行硅刻蚀;第三步是过刻蚀,用于去除刻蚀残留物。
为了实现高深宽比图形刻蚀,要降低工作压力和温度,以增加分子和离子的平均自由程,从而有效减少影响图形剖面控制的碰撞。主刻时间200 s后,刻蚀深度为6.677 μm,开口尺寸为0.675 μm,剩余硬掩膜厚度为942 nm,如图1(a)所示。此时可以通过增加刻蚀时间来继续增加刻蚀深度,增加刻蚀时间为550 s,刻蚀深度为17.6 μm,开口尺寸为0.813 μm,剩余硬掩膜厚度为317 nm,如图1(b)所示,估算硅/氧化硅的刻蚀选择比约为16:1。当刻蚀时间增加到800 s时,硬掩膜已经完全损失,导致无掩膜的全区域刻蚀,如图1(c)所示。
为了解决硬掩膜厚度不足引起无掩膜刻蚀的问题,将硬掩膜厚度增加至2.2 μm,并设定刻蚀时间为900 s,其深度虽然基本达到了器件要求的深度,但是由于刻蚀基已经难以进入高深宽比的槽中并使刻蚀生成物从槽中出来,刻蚀速率降低并实际停止于图形底部,开口处由于离子轰击的作用而出现缺陷,开口尺寸达到1.386 μm,如图1(d)所示,因此不能够运用到器件中。
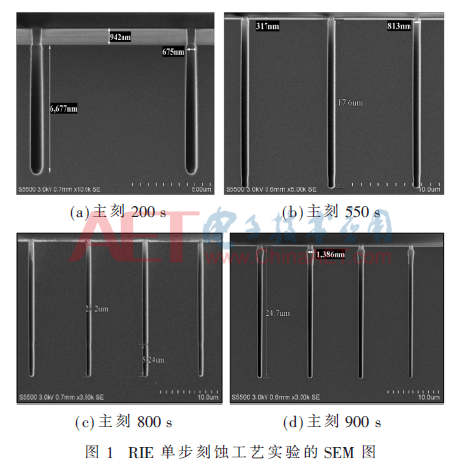
1.2 Bosch工艺刻蚀方法
由上节实验可知,RIE方法的刻蚀线条(开口尺寸)控制得很好,但是深度有限,对氧化硅掩膜的选择比很低,针对增加刻蚀深度的要求,采用Bosch工艺进行深刻蚀。Bosch工艺是一种深反应离子刻蚀(DRIE)方法,它采用高浓度的等离子体源,其工艺方法为刻蚀与聚合物屏蔽沉积不断交替,可以取得深宽比很高的刻蚀形貌,甚至可用于硅穿孔(TSV)的技术,且Bosch工艺对硅/氧化硅的选择比较高,刻蚀速率较快。在实验中采用SF6作为刻蚀反应气体,在等离子体中产生SxFy离子和F活性自由基,离子在电场作用下几乎垂直加速进入衬底,首先将沟槽底部钝化层打穿,而侧壁尚留有钝化膜,此时F自由基与硅反应。经过短暂的刻蚀之后,就开始钝化层的聚合,使用C4F8作为聚合阶段的反应气体。C4F8在等离子体中产生CF2活性自由基,在沟槽侧壁与底部沉积形成钝化层,由于自由基是电中性,不受电场作用,没有方向性,因此聚合物在沟槽底部和侧壁都是均匀分布的。然后重复刻蚀步骤,这样交替进行,实现深刻蚀。
在进行Bosch工艺深槽刻蚀的实验中,探索了刻蚀与聚合交替时间和循环次数、腔体工作压力、源射频功率、偏置射频功率以及C4F8/SF6气体流量等因素对刻蚀形貌的影响,并且对比了带光刻胶掩膜与不带胶掩膜的实验结果。
首先考虑用一步Bosch工艺完成刻蚀,即沉积步DS(Deposition Step)和刻蚀步ES(Etching Step)都只有一种控制条件,其刻蚀结果如图2所示,其刻蚀深度到19.2 μm时,底部已经成为锥形,很难往下刻蚀,而且此时开口宽度已经为943 nm,调节刻蚀条件的窗口很小,若减小聚合的沉积,就会牺牲开口尺寸。因此在实验中采用了两步Bosch工艺完成深槽的刻蚀,第一步工艺实现沟槽上部的刻蚀,主要是要最大程度上保证开口尺寸的控制;第二步改变控制条件,适当减少聚合物或者加大刻蚀量来实现深度刻蚀,并保证侧壁形貌。

为了减小深槽的开口尺寸,对第一步Bosch工艺的刻蚀条件进行探索和验证。C4F8作为沉积物的供给气体,其流量的变化对沉积步的影响非常大,且其流量的大小是相对图形负载而言的,流量不足会使横向钝化层过薄,刻蚀时保护不足,造成开口尺寸的损失,如果流量过大会造成底部钝化层过厚,刻蚀步很难移除聚合物,造成刻蚀速率成倍数下降甚至出现刻蚀停止的情况。实验中改变C4F8流量来探索其对开口尺寸的影响,如图3所示,图3(b)的沉积步C4F8流量比图3(a)增加了30%,开口尺寸由1.8 μm缩至1.24 μm,变化非常明显。

SF6是提供刻蚀离子SxFy的主要气体,其流量的大小也是相对图形负载来说的,SxFy的浓度变化直接影响刻蚀步的速率,即如果SxFy的浓度过大会使各向同性刻蚀效果明显,即横向腐蚀会有所增加,对硅/氧化硅的刻蚀选择比下降,但整体的刻蚀速率会加快。图3(d)的刻蚀步中SxFy的浓度比图3(c)减少了约30%,开口尺寸由1.15 μm缩至0.98 μm,变化也较为明显。
刻蚀步与沉积步的循环时间也是影响深槽线宽和刻蚀速率的重要因素之一。减小刻蚀步时间,理论上刻蚀时间缩短,单循环内各向同性刻蚀半径减小,深槽宽度也就得到控制。由于刻蚀步时间的减小,钝化层的厚度也需要相应减小,来配合更加快速的循环。图3(e)的DS和ES时间分别为1.2 s和1.5 s,图3(f)的DS和ES时间分别为1 s和1 s,对比两图SEM图片可见,单循环的刻蚀深度由362 nm减小至184 nm,开口尺寸由0.839 μm减小到0.804 μm,槽宽变化并不是很大,实验结果与理论预估结果一致。
实验中,DS中并不只有C4F8,ES中也并不只有SF6,在主导气体中都会掺有少量的对方气体。如DS中掺杂的少量SF6,在偏置电场很小的时候几乎不起作用,但是如果DS偏置电场增强,少量的SF6就会发挥刻蚀作用,图3(g)是在图3(d)的基础上增大DS偏置电场,少量SF6在DS的刻蚀作用也会使深槽宽度发生很大的变化,实验结果显示DS偏置功率增大1.5倍,槽宽增大0.3 μm。注意到图3(g)顶部出现Notching现象,这种现象一般发生在沟槽的开口处而非中间位置,至今没有较好的解决方法,只能通过降低偏置功率、增加钝化气体流量和钝化时间来缓解。
由以上实验对比,图3(e)和图3(f)是最优化的第一步Bosch工艺的实验结果,可用于进一步开发。由于图3(e)和图3(f)的开口尺寸差别不大,但是过快的DS与ES交替频率会造成DS聚合物沉淀不完全、不均匀,沟槽侧壁出现刻蚀损伤,如图3(h)方框内所示,图3(h)为图3(f)的中部形貌图,因此选择在图3(e)的刻蚀条件上进行进一步的工艺调整。在第一步Bosch工艺中为了保证开口尺寸尽量降低了刻蚀步ES的偏置电场,即减小物理轰击能量,导致刻蚀速率减慢和刻蚀深度有限,因此在完成控制开口尺寸的第一步Bosch工艺后,可以改变刻蚀条件,加深沟槽深度,加快刻蚀速率等。在第二步Bosch工艺的探索过程中,第一步Bosch工艺采用图3(e)的条件,刻蚀循环次数为40 cycles。
改变刻蚀循环次数对刻蚀深度影响较大,如图4(a)和图4(b)所示,刻蚀时间增加20 cycles,深槽深度由22.3 μm增加到26.5 μm,但是沟槽宽度平均增大120 nm。图4(c)为在图4(b)的基础上沉积步中增加20%的C4F8流量的刻蚀结果,可见在减小深槽尺寸的同时,深槽的刻蚀深度也变小了,对比图4(a),图4(c)的优点在于深槽底部尺寸有减小的趋势。以上实验都是在有光刻胶做掩膜的情况下进行的。光刻胶是有机物,在刻蚀过程中也会产生聚合物,与C4F8的产物一样具有钝化作用,实验中为了验证光刻胶掩膜在深刻蚀中的影响,做了一组去胶后刻蚀的对比实验,如图4(c)~图4(f)所示。对比发现去胶后刻蚀深度由23.8 μm增加到27.7 μm,深槽宽度均匀增大,均值约为160 nm,而由顶部放大照片可见,深槽的开口尺寸变化不大,且氧化硅硬掩膜的剩余厚度足够厚,硅/氧化硅的刻蚀选择比为40:1,因此可以采用去胶后刻蚀的方法。
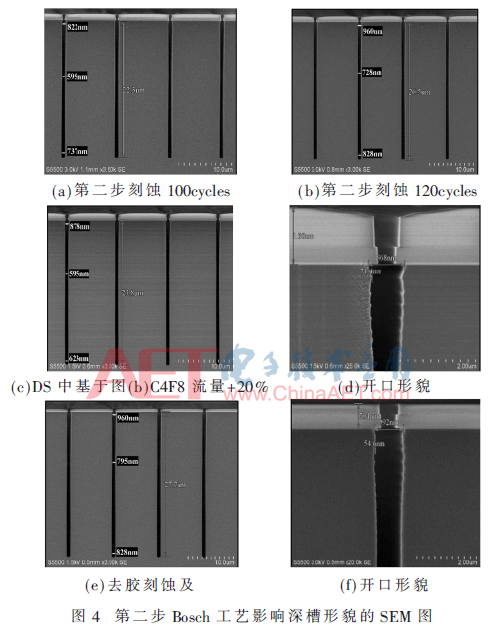
在第一步Bosch工艺中论证了沉积步(DS)中激活少量存在的SF6会使沟槽变宽并出现严重的Notching现象,而在第二步Bosch中要验证的是刻蚀步(ES)中增加C4F8的流量对深槽形貌的影响,图5(a)、图5(b)和图5(c)、图5(d)分别是在图4(e)、图4(f)的基础上增加10%和30% C4F8流量的实验结果,对比发现,增加C4F8后沟槽深度变浅,宽度稍有变窄,但是开口尺寸基本不变,因此改变该参数对整体刻蚀影响不大。
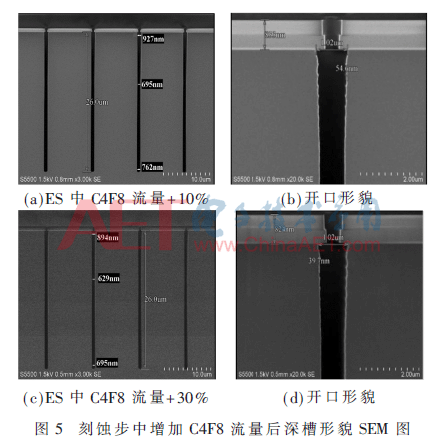
在Bosch工艺参数确定过程中,在图4(e)、图4(f)的基础上,减小偏置射频功率来优化菜单,偏置射频功率减小10%和30%时,深度分别由27.7 μm减小为27.3 μm和24.2 μm,深槽宽度也减小,但主要体现在底部收紧的趋势,如图6所示,而由图6(b)和图6(d)顶部放大照片可见,开口尺寸基本不变,硅/氧化硅的刻蚀选择比基本稳定。
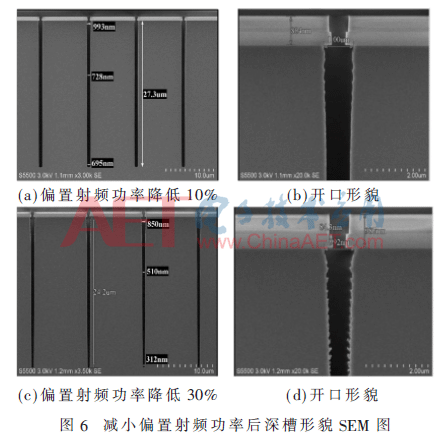
经过优化实验,选择图4(e)和图4(f)的实验结果进行下面的流程,包括氧化层硬掩膜的去除和深槽的填充与回刻。经过初步实验发现:第一,在刻蚀硬掩膜的过程中会造成深槽开口线宽损失,由图7(b)可见,线宽增大为1.18 μm。这是因为在刻蚀硬掩膜的过程中,采用RIE方法,深槽转角处受到的物理轰击更强烈,所以开口处被打开;另一个原因是硬掩膜刻蚀中产生的聚合物会沉淀在深槽侧壁上,如图7(a)所示,厚度高达40 nm,去除深槽内聚合物时,采用的清洗方法是将DHF和O3吹入槽内,O3氧化侧壁的硅,使其变为SiO2,然后DHF就可以将SiO2和聚合物一起漂掉,该工艺造成的侧壁硅损失约10 nm。第二,深槽刻蚀顶部螺纹的存在会造成顶部填充空隙,在非晶硅回刻时可能造成槽内填充物的损失,如图7(b)所示。

1.3 两种工艺结合刻蚀
为了进一步改善深槽开口尺寸和螺纹形貌,采用了RIE刻蚀方法与Bosch工艺结合的方法刻蚀,这种方法不仅可以缩小开口尺寸,而且可以通过Bosch工艺增大沟槽深度,如图8(a)~图8(c)所示,由SEM照片可知,槽深可以达到26.8 μm,深槽的槽宽非常均匀且侧壁光滑,在刻蚀完硬掩膜之后,开口最宽处只有0.8 μm,槽的深宽比可以达到35:1,图8(c)显示了RIE刻蚀工艺与Bosch工艺衔接处的侧壁形貌,有螺纹存在,但对深槽的功能无影响。图8(d)是在图8(b)的基础上进行Liner氧化、HARP填充和非晶硅填充的步骤,再回刻非晶硅和HARP氧化硅的实验结果,可见其最终开口为0.937 μm,槽上部填充结果致密,可最终应用于器件中。

2 结论
基于以上RIE单步工艺刻蚀方法、Bosch工艺刻蚀方法及RIE和Bosch工艺结合刻蚀方法的实验研究,最终通过RIE和Bosch工艺结合的刻蚀方法得到了高深宽比(开口<1 μm)的侧壁形貌理想的体硅深槽。该方法可以有效地消除深槽开口处及顶部一定高度上引起的锯齿形貌,弱化了刻蚀底切(undercut)现象,进而有效地提高了器件的可靠性,而且,该深槽经过Liner氧化、HARP填充和非晶硅填充,以及再回刻非晶硅和HARP氧化硅的步骤,可最终应用于MEMS传感器阵列中。
参考文献
[1] TAKAMURO D,MAEGAWA T,SUGINO T,et al.Development of new SOI diode structure for beyond 17 μm pixel pitch SOI diode uncooled IRFPAs[C].Proceedings of SPIE-The International Society for Optical Engineering,2011,8012(19):1779-1781.
[2] BRAND O,FEDDER G K.Advanced micro and nanosystems.Vol.2.CMOS-MEMS[M].Weinheim:WILEY-VCH Verlag GmbH & Co. KGaA,2005.
[3] QUIRK M,SERDA J.半导体制造技术[M].北京:电子工业出版社,2011.
[4] 刘恩科,朱秉升,罗晋生.半导体物理学[M].北京:国防工业出版社,2012.
[5] SENTURIA S D.微系统设计[M].刘译文,王晓红,黄庆安,等,译.北京:电子工业出版社,2004.
作者信息:
张海华1,吕玉菲2,鲁中轩1
(1.北京空间飞行器总体设计部,北京100094;2.北京航天时代激光导航技术有限公司,北京100094)

