文献标识码: A
DOI:10.16157/j.issn.0258-7998.2015.09.005
中文引用格式: 曹合适,粟雅娟,张斌珍,等. 微纳机电开关研究现状[J].电子技术应用,2015,41(9):21-24,32.
英文引用格式: Cao Heshi,Su Yajuan,Zhang Binzhen,et al. Research progresses on MEMS/NEMS switch[J].Application of Electronic Technique,2015,41(9):21-24,32.
0 引言
互补金属氧化物半导体(CMOS)的出现为半导体行业的发展提供了强大的动力,在制作微型化、快速、低成本的电子产品方面取得了巨大的成功[1]。随着大规模集成电路的发展,CMOS晶体管的特征尺寸进入纳米级别,CMOS正面临巨大的发展瓶颈,栅极泄漏、短沟道效应、结漏等[2-3]极大地阻碍了微电子技术的发展,微纳机电开关的出现在很大程度上弥补了半导体开关的不足。微纳机电开关是在微机电系统的基础上发展起来的特征尺寸在微米或纳米量级内的机械开关,包括微机电(MEMS)开关和纳机电(NEMS)开关。微纳机电开关具有体积小、速度快、功耗低等特点,由于物理气隙的存在,其断路时的泄漏电流几乎为0,而且具有延迟效应。随着科技的进步,航空航天、通信、计算机等高端前沿领域对低功耗微型器件的需求变得尤为迫切,在传统的半导体开关已不能满足这种需求的同时,微纳机电关极可能担当起这一重要使命。
1 微纳机电开关应用
微纳机电开关的研究受到了各国学者的重视,目前,部分微纳机电开关已经实现商业化应用,特别是在MEMS开关与射频器件的结合方面。随着通信技术的发展,小体积、低功耗、高性能、多功能的射频设备成为无线电领域的发展趋势,射频器件朝着微型化和集成化的方向发展,对电感、电容、滤波器等的Q值、阻抗匹配、隔离度提出了更高的要求。MEMS开关在射频器件上的应用为解决上述问题提供了突破口,RF MEMS开关具有宽带、低损耗、线性等优点。经过20余年的发展,RF MEMS开关已经成为射频器件中不可或缺的一员,其应用领域也扩展到防御应用的雷达系统、卫星通信系统、无线电通信系统、仪器系统等。MEMS开关在射频领域内的应用已经趋于成熟,性能也得到了大幅度的提升。Babak Yousefi Darani等人在2011年研制的微机电射频开关通过增加驱动电极的面积使驱动电压降到了1.3 V,且电学性能良好,能够通过共面波导传输线应用在2 GHz~6 GHz频段中,插入损耗仅为-0.16 dB,而断开时的隔离度则高达-35 dB[4]。RF MEMS开关在不停的循环工作中容易诱发疲劳失效,因此对稳定性有较高的要求。2013年David等人制作了一种RuO2-Au接触开关,接触电阻小于4 Ω,在10 GHz的工作频段下插入损耗为0.4 dB,隔离度28 dB[5],能够连续工作100亿次,极大地提高了使用寿命。国内的学者在RF MEMS开关的研究中也做出了突出贡献,东南大学的研究者将射频微机电开关的应用频率提高到了40 GHz,同时工作电压降到了0.3~0.55 V之间,插入损耗小于-0.5 dB,隔离度大于-30 dB,这种开关能够应用在甚宽带通信设备中[6]。随着研究的进一步深入,相信MEMS开关在射频器件中的应用会得到更宽的扩展。
在过去的几十年中,最先进的微处理芯片上晶体管数量已经从4.2×108增加到了3×1010[7]。随着CMOS晶体管的尺寸进入纳米量级,功耗逐渐成为CMOS晶体管不可忽视的问题[8],而且电子元器件经常性充放电所造成的泄漏功耗也将降低系统的使用寿命。作为一种机械开关,NEMS开关不存在CMOS晶体管在纳米量级内所面临的问题。与MEMS开关相比,NEMS开关的体积更小、速度更快。目前,NEMS开关的应用主要集中在数字逻辑电路和非易失存储器上。虽然NEMS开关还处在实验研究阶段,但是已有相关学者在该领域取得了重大突破。Weon Wi Jang等人在2007年研制的一种适用于记忆芯片的NEMS静电开关[9]可以克服泄漏电流对场效晶体管的限制,应用在非易失存储器中。测试结果表明,该微型开关具有良好的开/关特性,亚阈值摆幅接近于零(约为4 mV/decade),开关的闭合时间达到了3 μs。2013年国外的Daesung Lee用一种NEMS开关成功组合成了一个2-1逻辑转换门电路[10],并可以根据二元决策图实现任何逻辑功能,Daesung Lee的研究工作展示了NEMS开关在逻辑电路中的巨大潜能。
2 微纳机电开关分类
微纳机电开关根据不同的形式可以分为很多类。按照尺寸的大小可以分为微机电(MEMS)开关和纳机电(NEMS)开关,微机电开关的特征尺寸在微米量级,而纳机电开关的特征尺寸在纳米量级。根据驱动方式的不同则可以分为热驱动型、压电型、电磁型和静电型[11]。相比其他类型的微型开关,静电驱动型微机械开关结构简单、控制方便,而且功耗小、响应频率高、便于集成,这类开关的研究起始早,原理成熟,是目前微纳机电开关的研究热点。
微纳机电开关根据驱动方向的不同又可以分为横向型和纵向型,这两种类型的微纳开关也有各自的优缺点。最初的研究多集中在纵向型,纵向结构更符合微细加工自上而下的工艺方式,可以方便地优化弹性梁结构,驱动电极面积、气隙大小等结构参数,驱动电压能降到很低,但同时也会增加器件尺寸、加大制作难度。其制作工艺往往需要多次光刻,由此产生的套准误差将影响开关的性能。近年来对于微型开关的研究越来越趋向于横向驱动型。与纵向型微型开关相比,横向驱动纳机电静电开关有很大的优势[12]:(1)大多数的横向微型开关仅需要一次光刻,工艺简单,不存在多次光刻产生的对准误差;(2)尺寸和形状选择性大;(3)容易封装;(4)便于集成。但是横向开关只能制作一些简单结构,对异形梁等复杂结构则无能为力,且其气隙是由光刻精度决定的,因此横向驱动的微纳机电开关受工艺限制较大。图1和图2分别为两种不同类型的微纳机电开关。
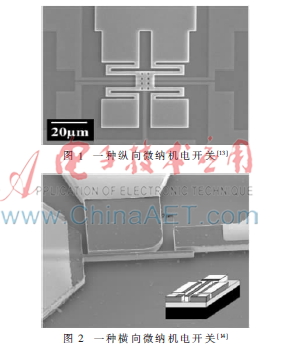
根据端口数量,微纳机电开关可以分为两端口型、三端口型和四端口型[15]。两端口微纳机电开关仅由弹性梁和一个电极组成,该电极同时作为驱动电极和接触电极,这种类型的开关结构简单,但是驱动电压偏大,且在闭合时控制电路会与工作电路产生干涉,因此实用性不强;三端口微纳机电开关在两端口类型的基础上增加了一个电极,实现了驱动电极和接触电极的分离,无论断开还是闭合,驱动电极都不参与开关的工作电路,但是弹性梁在闭合后仍然兼具电极的功能;四端口微纳机电开关在接触电极和弹性梁之间加了一层绝缘介质,弹性梁和驱动电极只起控制作用,控制电路和工作电路是完全隔离的,主要劣势是制作工艺复杂。目前微纳机电开关的研究主要集中在三端口类型。
3 微纳机电开关研究进展
微纳机电开关作为一个极具潜力的领域经过近30年的发展,在尺寸、速度、阈值电压、稳定性等方面取得了巨大突破。随着电子设备朝着微型化、集成化、高精度化的方向发展,小尺寸逐渐成为评定微纳机电开关性能的标准之一。微细加工工艺的发展促进了微纳机电开关的小型化,目前,微纳机电开关的特征尺寸已经从上世纪90年代的亚毫米级、微米级进入了纳米量级,其中弹性梁尺寸和气隙能达到20 nm左右。Davidson等人便通过原子层沉积(ALD)技术成功将微型开关的运动气隙缩小到了20 nm[16]。更小的尺寸不仅意味着更轻的质量、更小的占用面积,而且能在很大程度上缩小驱动电压。2010年FENG X L制作出了一种NEMS开关,通过将弹性梁的宽度和气隙减小到25 nm,使得阈值电压仅为1.5 V[17],如图3所示。随着电子束光刻等超精细加工技术的出现,微纳机电开关的尺寸和阈值电压将会进一步减小。

除了尺寸和阈值电压,稳定性和速度也是反应微纳机电开关性能好坏的重要指标。在最初的研究中,受限于材料和工艺条件,微纳机电开关的稳定性很差,不停的闭合工作往往导致疲劳失效,器件仅能正常工作几百次甚至几十次。近年来微纳机电开关的稳定性得到了大幅提高,从2010年的1 000次[18]到2011年的5 000 000次[19],再到2012年的109次[15],微纳机电开关的寿命正以指数形式增长,在稳定性方面已经能满足实际应用需求。微纳机电开关在工作过程中存在机械延迟,这种特性能被应用到非易失存储器中,但同时也增加了器件的响应时间,而且由于受实际加工工艺的影响,气隙、弹性梁等尺寸参数不可能无限减小,多方面的因素使得响应时间成为微纳机电开关的发展障碍。目前,场效晶体管的响应时间在10 ns之内,而微米级别的机电开关仍然停留在微秒甚至毫秒级别,虽然可以通过增加驱动电压缩短响应时间,但是工作电压的增加势必会影响微纳机电开关与CMOS器件的集成。理论分析表明,微纳机电开关的速度与器件的尺寸是成反比关系的,随着微型开关的特征尺寸进入纳米量级,其响应时间也缩短到了纳秒级别。在Rhesa Nathanael[15]设计的微纳机电开关中,当驱动电压为7.6 V时,开关的响应时间为100 ns左右。而根据KAM H[20]等人的研究,如果微纳机电开关的尺寸能减小到90 nm,那么其响应时间将能缩减至10 ns,已与晶体管处于同一水平内。
金属良好的导电性和易得性使其成为研究微纳机电开关的主要材料,随着研究的深入,微纳机电开关的材料选择正朝着多元化的方向发展,已由最初的金属扩展到了半导体和陶瓷等材料。2004年出现了以碳纳米管为结构材料的NEMS开关[21],该开关的初始气隙为150 nm,阈值电压在6 V左右,在逻辑电路、记忆单元、脉冲发射器、电流/电压放大器等高频率吉赫兹电子器件中有着广阔的应用前景。碳纳米管具有良好的物理和化学性质,它的重量轻、强度高、耐腐蚀,是制作微纳机电开关的理想材料,但是碳纳米管在制作过程中数量和位置的不确定性阻碍了其在微纳机电开关上的应用。2008年,Weon Wi Jang[22]将目光投向了高熔点、高硬度、耐磨损、导电性良好的TiN金属陶瓷材料,并将其成功应用到微纳机电开关中,研制成功了包括弹性梁式固支梁式的TiN开关,如图4所示。其中,弹性梁式开关泄漏电流为零,亚阈值摆幅小于3 mV/decade,远小于CMOS器件在室温下的理论极限值60 mV/decade。为了能与CMOS结合以及实现更好的集成度,多晶硅也正被越来越多的应用到微纳机电开关中,但是鉴于多晶硅的导电性并不是十分理想,往往需要在其表面生长一层高导电性物质。图1便是用多晶硅制作的微纳机电开关,为了防止开关在闭合的过程中产生“微焊接”并增加导电性,在锗硅上淀积了一层金属钨,其最小气隙为50 nm,驱动电压能够降到2 V左右,整个开关的占用面积仅为4 μm2,而且具有很高的稳定性[13]。材料等相关领域的发展会继续扩展微纳机电开关的材料选择,越来越多的新物质将会被应用进来。
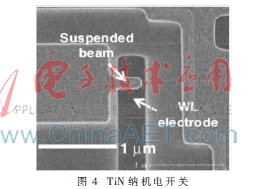
微纳机电开关的高速发展得益于微加工技工技术的逐渐成熟。作为MEMS技术的一个重要分支,微纳机电开关的制作工艺在初期的研究中多采用MEMS加工技术,如表面微加工技术、体硅微加工技术和紫外光刻技术等,随着微加工技术的发展,目前微纳机电开关的制作包含了气相淀积(CVD)、紫外光刻技术(UV-LIGA)、磁控溅射、原子层淀积(ALD)、牺牲层释放技术、离子注入、掺杂等多种工艺[23-24]。微纳机电开关的制作正朝着CMOS技术的方向扩展,CMOS与MEMS器件相结合将是微纳机电开关未来的发展趋势。与传统的MEMS工艺相比,CMOS与MEMS的结合具有以下优点:(1)CMOS的标准化能大大降低设备和材料成本。(2)可集成化程度高,缩短了器件的研发周期。(3)CMOS工艺提高了MEMS/NEMS器件的性能和可靠性。
4 结语
虽然微纳机电开关在近几年取得了重要进展,但是仍有很长的路要走。目前,阻碍微纳机电开关发展的因素主要有两种:一是现有加工技术的限制,虽然MEMS加工技术和CMOS技术已经非常成熟,但是能够制作特征尺寸在纳米量级内器件的手段仍然非常有限,而且大都十分昂贵。另一因素则是器件缩小至纳米量级内时引起的物理、化学等性质的变化,如毛细力、范德华力等,解决这一障碍牵涉到机械、物理、化学、数学等多门学科,需要研究者具有扎实的理论知识。将来对微纳机电开关的研究工作应集中在减小开关尺寸、降低阈值电压、增加响应速度、消除粘附力等方面。而在加工工艺方面,为了实现与CMOS器件的集成,CMOS技术在微纳机电开关上的应用将是未来的发展趋势。
参考文献
[1] PARSA R,SHAVEZIPUR M,LEEK W S,et al.Nanoelec-tromechanical relays with decoupled electrode and suspen-sion[C].Micro Electro Mechanical Systems(MEMS),2011 IEEE 24th International Conference.Cancun,Mexico,2011:1361-1364.
[2] MEINDL J D,CHEN Q,DAVIS J A.Limits on silicon nanoelectronics for terascale integration[J].Science,2001,293:2044-2049.
[3] FRANK D J,DENNARD R H,NOWAK E,et al.Device scaling limits of Si MOSFETs and their application depen-dencies[J].Proc IEEE,2001,89:259-88.
[4] Yousefi Darani B,Abbaspour Sani E,Shayanfar R,et al.Low actuation voltage RF MEMS switch for WiMAX appli-cations[C].RF and Microwave Conference,Seremban,Negeri Sembilan,2011:351-355.
[5] CZAPLEWSKI D A,NORDQUIST C D.RF MEMS switches with RuO2-Au contacts cycled to 10 billion cycles[J].Journal of Microelectro Mechanical Systems,2013,22(3):655-661.
[6] Zhu Yanqing,Han Lei,Wang Lifeng.A novel three state RF MEMS switch for ultrabroadband(DC-40 GHz) applica-tions[J].Electron Device Letters,2013,34(8):1062-1064.
[7] Intel.Your source for Intel product information.[DB/OL].[2015-03-30].http://ark.intel.com/.
[8] ZHIRNOV V V,CAVIN R K,HUTCHBY J A,et al.Limits to binary logic switch scaling-a gedanken model[J].Proceedings of the IEEE,2003,91(11):1934-1939.
[9] Weon Wi Jang,Jeong Oen Lee.A dram-like mechanical non-volatile memory[C].Solid-State Sensors,Actuators and Microsystems Conference,Lyon,France,2007:2187-2190.
[10] Daesung Lee,Lee W S.Combinational logic design using six-terminal NEM relays[J].Computer-Aided Design of Integrated Circuits and Systems,2013,32(5):653-666.
[11] RUAN M,SHEN J,WHEELER C B.Latching micromag-netic relays[J].IEEE JMEMS,2001,10:511-517.
[12] Roozbeh Parsa.Nanoelectromechanical relays for low power applications[D].California:Stanford University,2011.
[13] Jack Yaung.NEM relay scaling for ultra-low power digitallogic[D].California:University of California,Berkeley,2013.
[14] HINCHET R,MONTES L.Electrical and mechanical char-acterization of lateral NEMS switches[C].Design,Test,Integration and Packaging of MEMS/MOEMS(DTIP),Aix-en-Provence,France,2011:348-351.
[15] NATHANAEL R.Nano-electro-mechanical (NEM) relay devices and technology for ultra-low energy digital inte-grated circuits[D].California:University of California,Berkeley,2012.
[16] DAVIDSON B D,GEORGE S M,BRIGHT V M.Atomic layer deposition(ALD) tungsten nano-electromechanical transistors[C].2010 IEEE 23rd International Micro ElectroMechanical Systems(MEMS) Conference,2010:424-427.
[17] FENG X L,MATHENY M H,ZORMAN C A.Low voltagenanoelectromechanical switches based on silicon carbide nanowires[J].NanoLetters,2010,10(8):2891-2896.
[18] LEE D,LEE W S,PROVINE J.Titanium nitride sidewall stringer process for lateral nano-electromechanical relays[C].IEEE International Conference on Micro Electro MechanicalSystems-MEMS,Hongkong,2010:456-459.
[19] DAVIDSONA B D,SEGHETEB D,GEORGE S M.ALD tungsten NEMS switches and tunneling devices[C].22nd IEEE International Conference on Micro Electro MechnicalSystems,Sorrento,Italy,2009:25-29.
[20] KAM H,POTT V,NATHANAEL R,et al.Design and reliability of a microrelay technology for zero-standby- power digital logic applications[C].International Electron Devices Meeting,Baltimore,MD,2009:809-812,2009.
[21] LEE S W,LEE D S,MORJAN R E.A three-terminal carbon nanorelay[J].Nano Lett,2004,4(10):2027-2030.
[22] Weon Wi Jang,Jun-Bo Yoon,Min-Sang Kim.NEMS switch with 30 nm-thick beam and 20 nm-thick air-gapfor high densitynon-volatile memory applications[C].Semi-conductor Device Research Symposium,College Park,USA,2007:1-2.
[23] Lee W S,CHONG S,PARSA R.Dual sidewall lateral nanoelectromechanical relays with beam isolation[C].Solid-State Sensors,Actuators and Microsystems Conference,Beijing,China.2011:2606-2609.
[24] CHONG S,LEE B.Integration of nanoelectromechanical(NEM) relays with silicon CMOS with functional CMOS-NEM circuit[D].Electron Devices Meeting(IEDM),Wash-ington,USA,2011:30.5.1-30.5.4.

