文献标识码: A
DOI:10.16157/j.issn.0258-7998.2017.01.003
中文引用格式: 侯斌,邢鼎,张战国,等. 4H-SiC MESFET特性对比及仿真[J].电子技术应用,2017,43(1):13-15,19.
英文引用格式: Hou Bin,Xing Ding,Zhang Zhanguo,et al. The characteristic comparison and simulation of 4H-SiC MESFET[J].Application of Electronic Technique,2017,43(1):13-15,19.
0 引言
4H-SiC MESFET作为下一代大功率微波器件的首选,具有静态工作电压高、输出阻抗大、线性化程度理想、器件通用性好及设计成本低等优点[1,2]。传统的4H-SiC MESFET器件虽然在理论上具有很好的直流和射频特性,但在实际中,由于击穿电压和漏电流的提高,在一定程度上为相互制约的关系,导致功率密度达不到更高的要求。目前科学界通过改变4H-SiC MESFET结构的尺寸、形状等手段来提高4H-SiC MESFET器件的性能。而双凹栅结构4H-SiC MESFET和阶梯栅结构MESFET的提出,对栅结构的改变提供了良好的思路。对于阶梯栅4H-SiC MESFET的研究表明,当阶梯栅的数目越多时,器件的各项特性将越好[3]。所以阶梯的数目趋向于无穷时,阶梯的形状就被微分为一个斜坡。
1 阶梯栅和坡形栅4H-SiC MESFET的结构
图1为阶梯栅结构MESFET的剖面图,从图中可以看出,MESFET的栅部分由上栅和下栅两部分构成,上栅部分为长方形结构,栅长为LG;下栅部分为倒阶梯状结构,栅长为W,下栅通过刻蚀延伸到N型沟道区。

图2是将阶梯数目极限后所产生的结构,器件的结构由一个半绝缘的衬底、一个P型的缓冲层、一个N型沟道和高掺杂的n型覆盖层从下而上堆叠而成,堆叠层表面通过溅射金属引出栅(G)、源(S)、漏电极(D)。坡形栅MESFET结构的尺寸如下:栅长度LGU为0.7 μm,栅源间距LGS为0.5 μm,栅漏间距LGD为1.8 μm,下栅高度为0.06 μm,N型沟道厚度为0.25 μm。掺杂浓度为3×1017cm-3,P型缓冲层厚度为0.5 μm,掺杂浓度为1.4×1015cm-3,栅的肖特基接触金属为镍[4]。

2 器件的物理模型及参数
对于4H-SiC MESFET的研究,通常采用漂移-扩散模型、热力学方程模型和流体力学模型来描述[5]。本文对坡形栅MESFET及其他结构的仿真中,由于牵扯到高温,漂移扩散模型不可用,流体力学模型相对于热力学模型速度慢得多,所以采用热力学模型进行分析[6]。
热力学模型假设载流子和晶格相互热平衡,所以可以假定系统温度统一,电子和空穴的电流密度方程可以通过式(1)和式(2)表示:

本文的仿真软件采用ISE-TCAD,描述坡形栅MESFET器件的基本模型有能带变窄模型、迁移率模型、雪崩离化模型和复合模型等。
3 不同栅结构的4H-SiC MESFET物理特性对比及坡形栅结构的优化
3.1 双凹栅结构和阶梯栅结构4H-SiC MESFET物理特性对比
在不同栅结构的4H-SiC MESFET器件中,具有代表性的有双凹栅MESFET和阶梯栅MESFET。双凹栅MESFET的结构剖面图如图3所示。
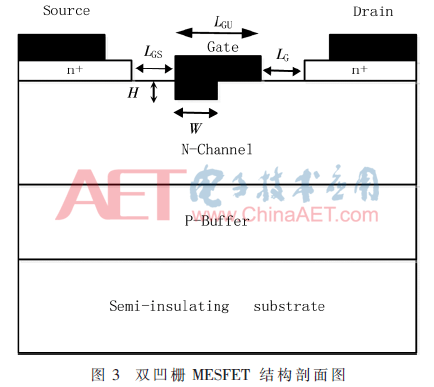
从图3中可以看出,双凹栅结构和阶梯栅结构4H-SiC MESFET的区别为下栅部分,双凹栅4H-SiC MESFET的下栅部分为具有长度为W的长方形栅,而阶梯栅的下栅部分为阶梯状的栅。
3.1.1 双凹栅和阶梯栅电流输出特性对比
在不同栅压下(VG=0 V、-3 V、-6 V、-9 V),阶梯栅和双凹栅MESFET结构的直流输出I-V特性曲线如图4所示。
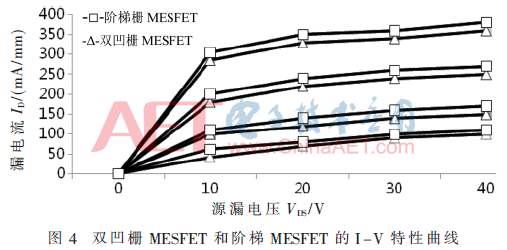
从图4中可以看出,在不同的栅压下,阶梯栅MESFET的饱和漏极输出电流大于双凹栅MESFET。这是因为对于4H-SiC MESFET,沟道区的等效电阻主要由耗尽区的大小决定,随着低栅部分阶梯数目的变化,耗尽区随之改变,提高阶梯数目使得沟道电阻减小,使漏电流得到提高。在栅压VG=0 V时,阶梯栅MESFET的饱和漏电流为391 mA/mm,比同条件下的双凹栅MESFET提高了5.9%。
3.1.2 双凹栅和阶梯栅的击穿电压对比
图5为双凹栅MESFET和阶梯MESFET的击穿电压曲线,从图中可以看出,阶梯栅MESFET的击穿电压为52 V,比双凹栅MESFET提高了4%。这是因为,要使得器件发生击穿,器件内部的电场则需要更高的电压。因此,阶梯栅MESFET的击穿电压大于双凹栅MESFET[7]。

3.1.3 最大输出功率对比分析
通过阶梯MESFET与双凹栅MESFET的饱和漏电流和击穿电压可以计算出两种结构的最大输出功率密度Pmax:

其中,Id是4H-SiC MESFE器件的饱和漏电流,VB是击穿电压,Vknee是膝点电压。
从式(3)可以看出,由于阶梯栅MESFET的击穿电压和饱和漏极电流均大于双凹栅MESFET,因此其最大输出功率密度也大于双凹栅MESFET,可见阶梯栅MESFET比双凹栅MESFET具有更加优秀的击穿特性和功率特性。
3.2 阶梯栅结构和坡形栅结构4H-SiC MESFET物理特性对比及优化
在图2中描述了坡形栅MESFET的结构,在此引入坡形栅MESFET的特征参数(EPCG),即坡形栅的终点,定义上栅和下栅的交点为坡形栅的终点。图6中①、②、③、④分别代表了1/4栅、1/2栅、3/4栅和全栅的坡形栅MESFET。图7为坡形栅和阶梯栅MESFET漏电流-漏源电压对比图。


从图7中可以看出,在VDS较小,即器件工作在线性区时,坡形栅MESFET和阶梯栅MESFET的漏电流基本相同,但当VDS进一步增大,这几种结构就有了显著差异。对于坡形栅MESFET,由于EPCG的不同,导致器件沟道区内的耗尽层发生改变,使得最大饱和漏电流发生变化。当EPCG为1/2栅时,最大饱和漏电流取得最大值,在VG=0 V、VDS=40 V的条件下达到了545 mA。而EPCG为1/4栅、3/4栅和全栅时,最大饱和漏电流不如EPCG为1/2栅时,也就是说,当EPCG从全栅移动到3/4栅、1/2栅时,由于沟道层内的耗尽区不断减小,使得沟道不断展宽,导致最大饱和漏电流不断增大;而EPCG从1/2栅移动到1/4栅时,沟道耗尽区边界的电流集边效应将会越来越严重,这会使得沟道减小,导致最大饱和漏电流减小。因此,当EPCG为1/2栅时,坡形栅MESFET的漏电流达到最大值。
图8为EPCG分别为1/4栅、1/2栅、3/4栅和全栅时,坡形栅MESFET的击穿电压对比图。从图中可以看出,当EPCG为1/2栅时,坡形栅MESFET的击穿电压最大达到57.5 V;而当EPCG为3/4栅时,坡形栅MESFET的击穿电压最小,为48 V。这是因为,在EPCG为3/4栅和全栅时,由于栅结构下方的终点距离漏测较近,使得栅漏边缘形成了较大的电场,因此更易发生击穿。而EPCG为1/4栅和1/2栅时,漏测边缘更接近于常规4H SiC MESFET,因此击穿电压较高。

4 结论
本文对比了双凹栅结构和阶梯栅4H-SiC MESFET的电流电压直流特性。结果表明,阶梯栅4H-SiC MESFET具有更好的直流特性。通过对阶梯栅的极限化处理,引出了坡形栅的4H-SiC MESFET结构,以及坡形栅的4H-SiC MESFET的特征参数-坡形栅的终点(EPCG)。仿真结果表明,当EPCG为1/2栅,最大饱和漏电流取得最大值,在VG=0 V、VDS=40 V的条件下达到了545 mA;EPCG为1/4栅、3/4栅和全栅时,最大饱和漏电流均不如EPCG为1/2栅时取得的最大值。
参考文献
[1] SUDOW M,ANDERSSON K,BILLSTROM N,et al.An SiC MESFET-based MMIC process[J].Microwave Theory and Techniques,IEEE Transaction on,2006,54(12):4072-4078.
[2] WILLARDSON R K,WEBER E R.SiC material and devices[M].Academic Press,1998.
[3] JIA H,ZHANG H,XING D,et al.A novel 4H-SiC MESFET with ultrahigh upper gate[J].Superlattices and Microstructures,2015,86:372-378.
[4] MEAD C A.Schottky barrier gate field effect transistor[J].Proceeding of the IEEE,1966,54(2):307-308.
[5] 刘恩科.半导体物理学(第七版)[M].北京:国防工业出版社,2011.
[6] 任雪峰,杨银堂,贾护军.4H-SiC MESFET直流I-V特性解析模型[J].半导体技术,2008(2):129-132.
[7] RAMEZANI Z,OROUJI A A,AGHAREZAEI H.A novel symmetrial 4H-SiC MESFET:an effective way to improve the breakdown voltage[J].Joural of Computation Elctronics,2015(1).
作者信息:
侯 斌,邢 鼎,张战国,臧继超,马 磊
(航天科技集团九院七七一研究所,陕西 西安710000)

