文献标识码: A
DOI:10.16157/j.issn.0258-7998.2017.01.006
中文引用格式: 李照,张战国,高博,等. 晶体管场环终端技术的优化设计及应用[J].电子技术应用,2017,43(1):24-27.
英文引用格式: Li Zhao,Zhang Zhanguo,Gao Bo,et al. Optimization design and application of transistor field ring termination technology[J].Application of Electronic Technique,2017,43(1):24-27.
0 引言
双极型晶体管是半导体器件中最为通用的一种,特别是一些具有高耐压、大电流等性能的双极型晶体管在电力电子技术领域获得越来越广泛的应用。为了提高晶体管的耐压,已开发的高压终端结构有场板技术、刻槽技术、场环技术等,这几种终端技术都有其各自不同的特点,其中场环技术可由常规工艺实现,且工艺简单,提高耐压效果好,是一种常用的改善晶体管耐压的有效方法。本文主要研究场环终端技术的优化设计及其在实际版图设计中的应用。
1 浮空场环的工作原理
在扩区主结的四周设置浮空场环是提高击穿电压的一个有效方法。浮空场环能够有效改变主结附近的电场分布,使曲面结的曲率半径增大,抑制表面电场的集中,从而提高器件的击穿电压。图1所示为同一结构在添加浮空场环前后的耗尽层边界对比。与未加浮空场环结构相比,主结附近增加了浮空场环的结构其耗尽层边界也发生了变化,有效增大了结的曲率半径,从而达到提高击穿电压的目的。

2 浮空场环的设计优化
浮空场环的设计重点是确定场环与主结的间距,为了能有效改变主结附近的电场,浮空场环必须设置在主结的耗尽宽度内,如果浮空场环距离主结过近,其电势会和主结很接近,因为高电场出现在浮空场环处,并不能有效提高击穿电压;而如果浮空场环设置得距离主结过远,其对主结电场的影响会很小,对击穿电压的提高也不明显。所以有必要将浮空场环设置在最佳的间距来提高击穿电压。
本文主要针对的是一款高压NPN晶体管的版图设计时遇到的问题,该款晶体管采用刻槽工艺来满足高耐压要求,但由于刻槽工艺相比场环工艺较难实现,而且需要专业的刻蚀设备,成本也较大。所以选择用浮空场环技术代替刻槽技术来满足该款晶体管的高耐压要求。
在进行浮空场环设计时,场环间距是一个很关键的参数。在最优间距时,主结与浮空场环同时达到击穿临界电场。在实际设计场环间距时主要考虑的因素包括:(1)场环与主结的最佳间距;(2)基区和场环的横向扩散。
2.1 场环与主结的最佳间距
根据经验,场环与主结的最佳间距WS一般在平行平面结击穿时耗尽层宽度[1]的0.15~0.35倍范围内。对于本设计,BVCBO需大于600 V,实际设计时考虑到20%的设计余量,BVCBO设计值为720 V。由于本设计CB结是由N型外延与P型基区扩散区形成的PN结,而外延相对于基区掺杂浓度很小,因此该PN结可近似为单边突变结即该结耗尽区主要在外延这边,所以用单边突变结时的耗尽区宽度计算公式进行计算。
一般地,若W为击穿时的耗尽区宽度,耗尽区宽度的计算公式为:

由于该PN结近似于单边突变结,该集电区耗尽区宽度可用突变结耗尽层近似,因而该公式可以简化为:

根据图2的单浮空场环归一化最优间距,可以看出归一化最优间距随着结归一化结曲率半径的增大而增大。最优间距在平行平面结击穿时耗尽层宽度的0.15~0.35倍范围内。通过对要设计晶体管样品的解剖分析及仿真,其基区结深为30 μm左右,通过计算已知击穿时耗尽层宽度为67 μm,可以得到其归一化曲率半径为0.44,则其归一化最优场环解析值为0.35。所以场环的最优间距WS=67×0.35≈23 μm。
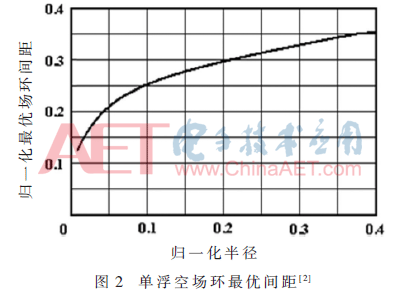
2.2 考虑基区的横向扩散
由于基区在注入推结时,杂质离子在向纵向扩散的同时还存在横向扩散,所以在设置场环间距时必须考虑到结的横向扩散。本设计基区结深Xj=30 μm,根据经验,杂质离子横向扩散长度约为其纵向扩散长度的80%,所以基区的横向扩散长度为0.8Xj。因场环与基区主结是同时形成的,所以两边的横向扩散都需要考虑,这里需考虑的横向扩散总距离为2×0.8Xj=2×24 μm=48 μm。
综上所述,该产品版图设计的场环距基区的主结间距是上述几个值之和,即:

实际版图设计[3]时取整70 μm作为场环间距。由式(3)可知,该产品版图设计时场环的最优间距为70 μm时满足设计耐压要求。
3 仿真验证
为了验证场环是否能有效提高耐压,首先用Silvaco软件对该产品加浮空场环前后的BVCBO(集电极-基极击穿电压)、BVCEO(集电极-发射极击穿电压)等电特性进行了仿真。随后,在相同条件下对采用浮空场环技术和刻槽技术的两种不同结构分别进行仿真,对比其仿真结果。
仿真时,采用电阻率为23 Ω·cm的N型衬底(掺磷杂质浓度为2.1×1014/cm3),基区采用注入剂量为5E15的硼,发射区采用注入剂量为8E17的磷。
对于未加浮空场环的结构,其仿真结果如图3、图4所示。

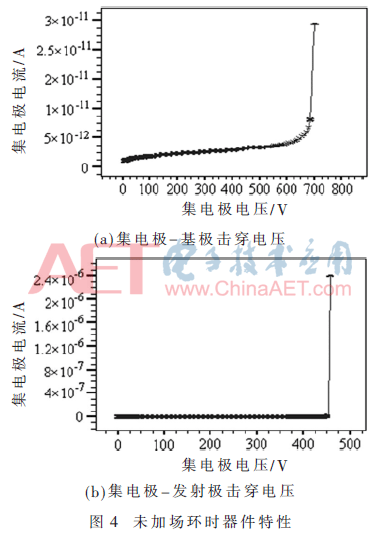
图3显示了常规结构的工艺仿真结果及CB结击穿时的电场分布,从图3(a)可看出其集电极-基极结击穿时硅材料内部的电场分布情况,电场线的疏密代表电场的强弱,电场线越密处电场越强;从图3(b)可看出其纵向结构,基区结深30 μm,发射区结深12 μm。图4为未加浮空场环时仿真所得的器件特性,由图4仿真结果可以看出,基区周围未加浮空场环前,BVCBO不到700 V,BVCEO约为460 V左右。
由图5仿真结果可以看出,加浮空场环后,BVCBO达到800 V左右,BVCEO为500 V左右。图6为CB结击穿时,基区主结与浮空场环的电场分布,电场线越密,代表电场强度越强,从图6(a)中可以看出,当CB结击穿时,其电场线最密处出现在基区主结与场环结的拐点处,代表这两处电场最强,即击穿点;从图6(b)中可以看出,当CB结击穿时,基区主结与浮空场环同时达到击穿临界电场。

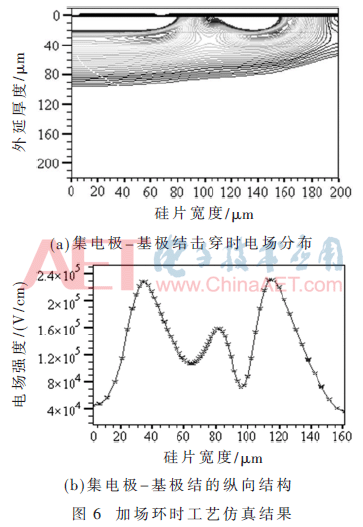
对比上述仿真结果,可看出在相同仿真条件下,加浮空场环的结构与未加浮空场环的结构相比,其结击穿电压BVCBO提高了100 V左右,BVCEO提高了40 V左右,击穿电压特性在加浮空场环后有明显提高。因此,场环终端技术确实能够有效提高器件的耐压特性。
随后通过对比解剖国外同类产品,发现其芯片结构采用了刻槽工艺[4]来提高耐压。仿真时,在其他仿真条件不变的前提下,将浮空场环技术替换为刻槽技术,槽深按实际解剖所得80 μm设计,并对其耐压特性进行了仿真,其工艺结构及器件特性仿真结果如图7、图8所示。
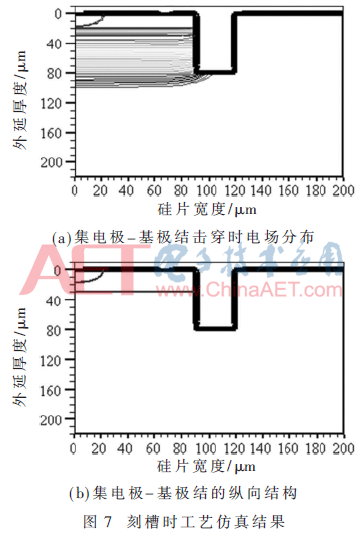
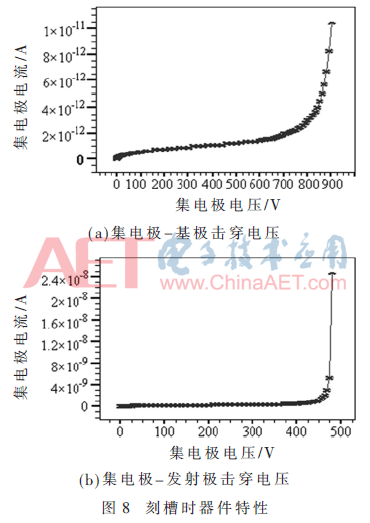
图7所示为采用刻槽工艺时器件的纵向结构及CB结击穿时的电场分布,电场线越密,代表电场强度越强,从图中可以看出电场最强处出现在槽边缘部位即击穿点部位。由图8仿真结果可知,当采用刻槽工艺时,BVCBO和BVCEO也分别能达到 800 V左右和500 V左右。上述3种不同结构器件仿真结果对比如表1所示。

由上述结果可知,采用浮空场环技术与采用刻槽技术的器件特性仿真结果基本一致,这两种结构相比常规结构都能明显提高器件的耐压。但是考虑到刻槽工艺需要专业的设备,而且工艺要求更高,所以在实际芯片生产中可以采用更容易实现且成本较低的浮空场环工艺来替代刻槽工艺,以达到芯片电特性要求。
在对该产品的实际版图设计时进行了拼版设计,分别采用了两种不同的技术来提高耐压,一种是按实际解剖的结果采用刻槽工艺技术,另一种是采用浮空场环技术来提高耐压。采用拼版设计既可以节约研发成本,用一批实验流片实现两种工艺技术的实验对比,又可以缩短研发时间。通过实际流片测试,其器件电特性都基本满足设计要求。
4 总结
通过上述的理论分析与仿真结果及实际流片结果,可见浮空场环技术确实有效提高了器件的击穿电压。而且与刻槽技术相比,场环技术更容易实现,不需要增加额外工艺步骤,也不需增加专业设备,工艺可行性更高,成本更低。通过理论计算及实验仿真可实现场环的设计优化,且其在工艺上容易实现,兼容性好。通过本次版图设计,体会到在以后的分立器件设计中,不一定非要照搬样品的结构设计,而是应该根据生产线的实际情况选择成本最低、更容易实现且工艺兼容性更好并能实现相同效果的设计。
参考文献
[1] 刘恩科,朱秉升.半导体物理学[M].北京:电子工业出版社,2015.
[2] BALIGA B J.功率半导体器件基础[M].韩郑生,陆江,宋李梅,译.北京:电子工业出版社,2013.
[3] HASTINGS A.模拟电路版图艺术[M].王志功,译.北京:电子工业出版社,2012.
[4] MAY G S,施敏.半导体制造基础[M].代永平,译.北京:人民邮电出版社,2007.
作者信息:
李 照,张战国,高 博,常正阳,黄山圃
(航天科技集团九院七七一研究所,陕西 西安710000)

