文献标识码: A
DOI:10.16157/j.issn.0258-7998.2017.07.012
中文引用格式: 李扬. SiP系统级封装设计仿真技术[J].电子技术应用,2017,43(7):47-50,54.
英文引用格式: Li Yang. SiP-system in package design and simulation technology[J].Application of Electronic Technique,2017,43(7):47-50,54.
0 引言
SiP系统级封装是一种最新的电子封装和系统集成技术,目前正成为电子技术发展的热点,受到了来自多方面的关注。这些关注者既来源于传统的封装Package设计者,也来源于传统的MCM设计者,更多来源于传统的PCB设计者,甚至SoC的设计者也开始密切关注SiP。
和Package比较而言,SiP是系统级的多芯片封装,能够完成独立的系统功能。和MCM比较而言,SiP是3D立体化的多芯片封装,其3D主要体现在芯片堆叠和基板腔体上。同时,SiP的规模和所能完成的功能也比MCM有较大提升。和PCB比较而言,SiP技术的优势主要体现在小型化、低功耗、高性能方面。实现和PCB同样的功能,SiP只需要PCB面积的10~20%左右,功耗的40%左右,性能也会有较大的提升。和SoC比较而言,SiP技术的优势体现在周期短、成本低、易成功等方面。实现同样的功能,SiP只需要SoC研发时间的10~20%,成本的10~15%左右,并且更容易取得成功。
1 应用在SiP设计仿真中的技术
SiP设计是集高级封装设计、MCM设计、PCB设计之大成,同时又和IC设计密切相关。在SiP设计中,主要包含的技术有:键合线(Wire Bonding)、芯片堆叠(Die Stacks)、腔体(Cavity)、倒装焊(Flip Chip)及重分布层(RDL)、高密度基板(HDI)、埋入式无源元件(Embedded Passive)、参数化射频电路(RF)等技术。
同时,为了先导的IC芯片设计以及后续PCB设计协同,SiP设计中会应用到多版图项目设计技术。
图1给出了IC裸芯片、SiP封装、PCB板级系统三者之间的关系。IC裸芯片被封装在SiP中,SiP又被安装在PCB之上。信号在三者之间相互传递,电源从外部设备提供到PCB→SiP→IC裸芯片。从整个系统应用的环节上来说,三者之间是密不可分的。
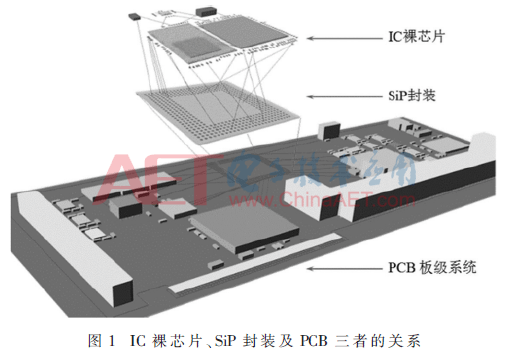
为了提高设计效率以及应对突发紧急的项目,SiP设计中会应用多人协同设计,这包括原理图多人协同设计和版图多人协同设计。
另外,因为SiP具有3D立体化的特点,需要设计工具支持3D实时显示和3D DRC检查等功能。
除了设计技术,仿真技术也是保证SiP产品成功的重要环节,其中包含信号完整性仿真、电源完整性仿真、热分析、电热联合仿真以及3D电磁场仿真等。
2 SiP设计仿真流程
为了确保SiP项目能够取得成功,遵循严格而规范的设计流程是必不可少的。通过多个实际SiP项目的成功经验,现将SiP的设计仿真流程总结如下,参看图2,SiP设计仿真流程主要包含12个步骤:

(1)设计方案定义,主要包括:SiP相关资料收集、裸芯片物理尺寸、管脚定义、能否采购等。封装类型是采用BGA还是其他封装形式、封装尺寸的确定、管脚间距、数目的确定。采用自定义管脚排列方式还是采用标准封装。封装工艺和材料选择,根据其应用领域选择塑料封装、陶瓷封装或金属封装。
(2)建库及库管理,主要包括原理图符号库、IC裸芯片库、BGA封装库、Part库以及仿真模型库等建立。
(3)原理图设计,主要包括原理图输入,射频原理设计以及原理图协同设计等。
(4)设计前仿真,可和原理图设计同步进行,通过假定分析,确定设计层叠结构、关键信号的网络拓扑结构、阻抗匹配,以及电源平面的分割、电容种类及型号选择等。对数模混合电路根据需要进行电路功能仿真。
(5)工艺确定,主要是为了确定SiP采用哪种工艺,如Wire Bonding、FlipChip、TAB、TSV等。基板上是否要挖腔体,采用单面腔体还是双面腔体,以及腔体结构等。同时要考虑是否做芯片堆叠Chip stack,基板的层数以及层叠结构等通常在这一步要确定下来。
(6)基板层叠设置,约束规则设置,根据工艺确定及设计复杂程度进行SiP基板层叠结构设置,包括层数以及层叠结构的选择,是采用m+N+m(其中m代表激光孔,N代表机械孔)或者ALIVH等层叠结构。约束规则设置主要包括网络分类、网络类规则、间距规则、电气规则、区域规则等。
(7)器件布局,确定裸芯片在SiP封装中的位置。如果芯片需要放置到腔体里,则需要确定腔体的深度以及是单阶还是多阶腔体,腔体形状的绘制和属性设置等;如果需要设计芯片堆叠,则堆叠芯片后再进行布局。
(8)引线键合、布线和敷铜,主要确定引线键合方式是单层键合还是多层键合、键合线模型选择、电源环设置;交互式手工布线或自动布线、电源层分割、射频电路设计,埋阻、埋容的自动综合等。
(9)版图设计检查,检查版图设计中的DRC错误并进行修正,确保设计的正确性。
(10)设计后仿真
将版图设计数据导出到仿真工具,进行信号完整性、电源完整性、电磁场及热等方面的仿真。解决由于信号质量、供电不足、噪声等产生的问题,以及由于芯片功耗过大而发生的过热问题,确保产品工作的稳定和可靠性。后仿真如果顺利通过,则进入到下一步,如果不能通过则需要回到前仿真,进行优化后重新设计和仿真。
(11)后处理及生产文件
输出包括Gerber、Drill、BOM、DXF、IDF、GDSII、ODB++等格式的文件。
(12)电子结构一体化设计
电子设计软件ECAD工具主要完成的是SiP内部的设计,包括基板设计和芯片组装、键合等,而SiP的外壳等数据通常需要通过结构设计软件MCAD来确定,如陶瓷封装的金属框架、盖板、塑封的模封,BGA的焊球,金属封装的外壳等,需要电子结构一体化设计完成。
所有流程走完,SiP设计仿真结束,进入生产环节。
3 SiP设计仿真技术在实际项目的应用
结合某SiP项目的实际应用,阐述SiP设计仿真的流程及具体问题的解决方法。
SiP设计和仿真采用了Mentor Graphics最新的Xpedition软件高级封装功能模块及相关的仿真工具。
3.1 从方案定义到工艺确定
首先是设计方案定义,该SiP是一款应用在航空航天项目中的计算机系统SiP,其原理和在航天项目中成功应用的PCB主板基本相同, 原理图设计主要参考原有的主板进行设计。由于需要扇出的引脚数量较多,所以选择BGA封装形式。由于该产品工作环境苛刻,所以选择陶瓷封装。该SiP包含的主要的裸芯片为CPU、FPGA、DDRIII、SRAM和3片Flash。在有限的空间内,无法在单面完成布局,因此选择双面器件布局的方案,其中尺寸较大的FPGA放在基板背面,并采用腔体嵌入,周围为BGA焊球区域,其他芯片放置在基板正面,整体方案如图3所示。
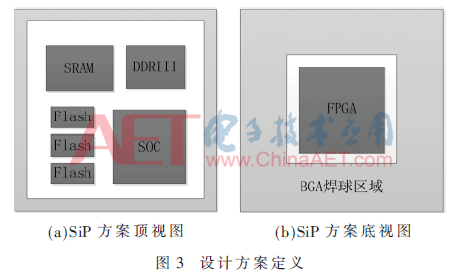
下一步是创建所需要的元器件库,包括裸芯片库、无源器件库和BGA封装库。这部分工作由中心库管理工具来完成,分别创建焊盘Padstacks,创建原理符号Symbol,创建版图单元Cell,然后把Symbol和Cell对应起来,形成器件Part,就可以直接在原理图中使用了。需要注意的是Padstack、symbol、Cell的信息都可以从上游IC设计的输出文件中获取,并通过建库向导来创建,这样既保证了效率,又避免出错。
库创建完成后,进入原理图设计阶段。其主要工作是确定硬件系统结构以及使用的总线等,从库中调用元器件,放置到原理图并进行正确的网络互连。在原理图设计过程中或设计完成后,可在原理图中抽取关键网络进行设计前仿真。通过LineSim-link功能,可直接将选择的关键网络传递到仿真工具HyperLynx前仿真环境LineSim中,然后加载器件模型,进行前仿真。
该SiP主要由数字电路组成,无需做数模混合电路仿真。另外,由于电源种类不多,每种电源都能有充足的空间分布,所以也无需做电源完整性前仿真。前仿真主要工作是完成信号完整性仿真。
根据LineSim前仿真结果,对原理图进行了优化设计,确定了网络拓扑结构,关键网络的匹配方式,部分网络增加了匹配电阻,确定了关键信号的布线策略。
下一步进入工艺阶段。工艺确定是前面方案定义阶段的细化,该SiP包含的所有IC裸芯片均支持键合工艺,布局上采用双面布局,FPGA和CPU因为引脚数量比较多,键合线多层排列,均要设计多阶腔体阶,将芯片放置在腔体内部,这样,多层键合时外层键合线跨度和弧度均能有效减小,提高键合线的稳定性。参看图4。

该SiP工艺确定包括:Bond wire,基板多阶腔体,芯片堆叠等工艺。
3.2 SiP版图设计
工艺确定后,进入层叠设置和规则设置阶段,该设计中采用多层HTCC陶瓷基板,首先按照前面工艺确定的要求,绘制双面多阶腔体,然后进行器件布局。需要注意的是,BGA封装也作为一个器件,布局到基板的背面,作为信号对外通路以及外部供电的接口。布局完成后进行规则设置,在CES(Constraint Edit System)中设置线宽、线间距、等长、差分等规则。另外还需要合理分配电源、地平面层,选择合适的过孔等。规则设置完后,进行裸芯片的键合,将芯片与基板电气连接。
因为Bond wire、芯片堆叠及腔体都是3D元素,所以要结合2D和3D设计环境进行操作,图5所示为完成布局和键合后的SiP设计在3D环境中的截图。为了更清楚地检查Bond wire细节以及顶层CPU和底层FPGA的位置,可以选择3D局部检查。图6为键合完成后的3D侧面局部截图,可以清楚地看出CPU、FPGA的键合图和它们的相对位置,从此图也可以看出腔体结构大大减小了外层Bond wire的跨距和弧度,增加了Bond wire的稳定性,提高了SiP的抗震动和冲击能力。


随后,进入版图布线和覆铜环节。完成后做版图DRC检查环节,这两步基本和PCB设计大同小异,在此不做赘述。DRC检查通过后,版图设计完成。
3.3 SiP设计后仿真
版图设计完成后,需要对关键网络进行仿真。因为SiP的3D立体特性,二维的仿真工具已无法解决问题,需要采用三维仿真工具抽取三维模型。这里采用HyperLynx Full-Wave Solver抽取版图设计的3D模型,因为3D电磁场仿真对系统资源和内存要求都很高,一般抽取关键网络及其参考网络周边的局部3D模型,在满足仿真精度的要求下,节省资源消耗,如图7所示为抽取的DDRIII部分关键网络的3D模型。
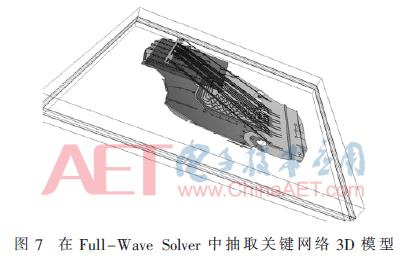
在此模型基础上,进行3D电磁场仿真,可得到关键网络的S-parameter模型,此模型为关键网络的互联特性模型,如图8所示为关键网络的S参数。
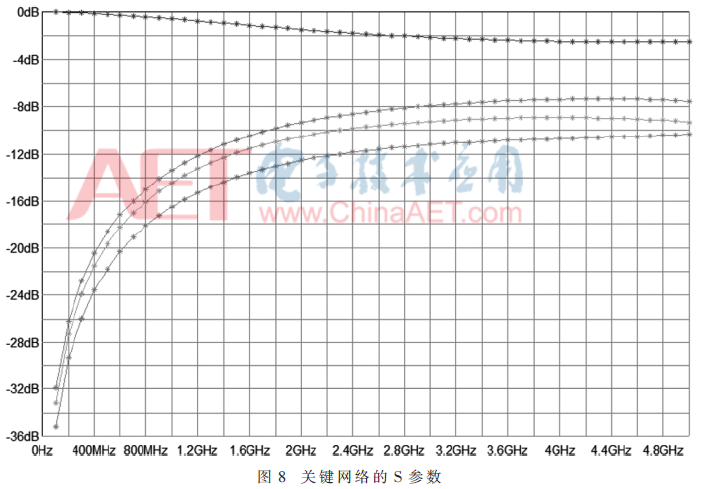
然后将此互联路径的S参数模型连同IC芯片的IBIS或者Spice模型一起导入HyperLynx SI中进行仿真,即可获得DDRIII信号实际工作时的信号波形,如图9所示为DDRIII信号眼图,可以看出,眼图张开良好,满足设计要求。

另外,为了保证有足够的电源供应,避免由于电压供应不足而造成的系统不稳定,以及电流密度过大造成局部温度过高而产生事故,这都需要进行电源完整性PI分析。通过PI分析,该SiP设计满足要求,未出现压降过大或者电流密度过大的问题。图10给出3.3 V电源的电流密度仿真结果,可以看出最大电流密度为33.9 mA/mil2,满足设计要求。

此外,热分析也是SiP仿真后分析的重要的环节,通过热分析,可以避免由于器件过热而造成的系统工作不稳定,可靠性下降等问题。由于文章篇幅关系,这里就不做详述。
3.4 生产文件输出及电子结构一体化设计
后仿真通过后,就可以输出生产文件,一般需要输出基板的Gerber及Drill文件,描述每一层的图形和钻孔。另外,此SiP设计基板的结构比较复杂,所以还需要一个输出一份DXF文件,详细描述腔体的位置、尺寸、每一台阶的宽度和深度。另外,再编写一份技术说明文档,提醒生产厂家生产中应注意的问题。
在SiP基板设计完成后,可将结构软件设计的盖板,框架以及后续工艺需要植在基板底部的BGA焊球等数据从结构设计软件导入3D设计检查环境,检查ECAD和MCAD设计的一致性,在3D环境中模拟产品结构和外观,避免数据交互中由于误解而造成的设计往复。
4 结论
本文介绍了SiP系统级封装设计仿真技术的流程和方法,并结合实际的SiP工程项目,详细论述了SiP设计和仿真的具体环节及实施方法。
本文中描述的SiP设计仿真流程和方法,已成为SiP设计仿真工程师的重要参考,成功应用在国内多款SiP项目中,并取得了良好的社会效益和经济效益。
参考文献
[1] 李扬,刘杨.SiP系统级封装设计与仿真—Mentor Expedition Enterprise Flow高级应用指南[M].北京:电子工业出版社,2012.
[2] Advanced Packaging Guide,Release X-ENTP VX.2,Mentor Graphics,2016.
[3] Philip E.Garrou, Lwona Turlik著.多芯片组件技术手册[M].王传声,叶天培等,译.北京:电子工业出版社,2006.
[4] HyperLynx SI/PI User Guide,Mentor Graphics,2016.
作者信息:
李 扬
(奥肯思科技有限公司,北京100045)

