文献标识码: A
DOI:10.16157/j.issn.0258-7998.190016
中文引用格式: 王磊. 基于多层板的多功能组件微波互联技术研究[J].电子技术应用,2019,45(6):7-10.
英文引用格式: Wang Lei. Research on the microwave interconnection technology of multifunctional components based on multi-layer PCB[J]. Application of Electronic Technique,2019,45(6):7-10.
0 引言
电子装备正在向小型化、轻量化和多功能方向发展,尤其机载、舰载、星载等电子装备以及电子对抗中的通信、雷达和光电子设备,均需要大量的高性能、高可靠的微电子模块,作为其核心模块的微波毫米波多芯片模块(MMCM)三维互联与封装技术已经成为微波毫米波集成技术的研究热点[1-3]。多层板如共烧陶瓷基板、硅基、金属基和多层电路印制板等,在微波产品中已经得到了广泛应用。但从成本、周期、工程研制等方面考虑,多层印制板更具有明显的优势。利用多层板实现系统级封装中各信号层、电源层、接地层之间的相互联接,以实现MMCM微型化、高性能和低成本等技术要求,满足MMCM越来越精密的装配精度、越来越微小的空间尺寸和越来越高的可靠性要求[4-6]。目前的多层板技术主要应用于数字电路或低频电路的高密度集成封装中,射频方面的应用相对较少且主要工作于Ku及以下频段。
为了实现多层板应用时微波毫米波频段过渡信号的低损耗传输,本文设计了一种低损耗过渡结构,并对样件进行了测试。该过渡结构在Ka频段具有良好的射频传输特性,为多芯片组件的小型化问题[7]。
1 多层板过渡模型及仿真
本文设计的多层板过渡模型如图1所示,整版厚度为1.0 mm。多层板部分顶层为Alon CLTE/XT微波板,下层板材为FR-4,参考工程易实现的装配尺寸,将双面板与多层板间隙f设置为0.2 mm,在与双面板连接端通过金属化孔过渡,实现微波信号传输,金属化孔的直径的间距均为0.25 mm,金属化孔离微带的距离为d。金属化过孔的作用是在端口处实现微波共地。

为了说明金属化过孔的作用,利用三维仿真软件HFSS,首先对没有金属化孔的模型进行仿真,图2为无金属化孔模型,图3为该模型的仿真参数结果。同时给出直通微带的仿真参数作为对比,如图4所示。

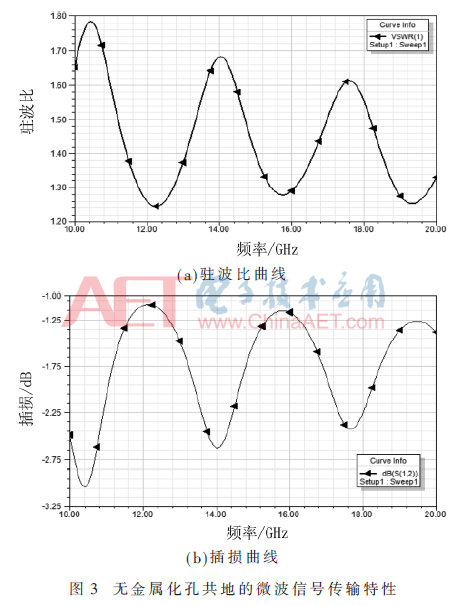

从图3和图4的对比可以看出,在没有金属化孔的情况下,微波信号处于失配状态,谐振较大,不能在组件中用于微波信号传输。
图5给出了金属化孔距离微带尺寸不同时,信号的传输特性。从图中可以看出,金属化孔离微带的距离越近,信号传输特性越好,尤其对于频率较高的频点。当间距由0.6 mm变为1.2 mm时,在20 GHz处的插损由0.48 dB变为0.72 dB,驻波比由1.4变为1.75,变化幅度较为明显,且无谐振现象。
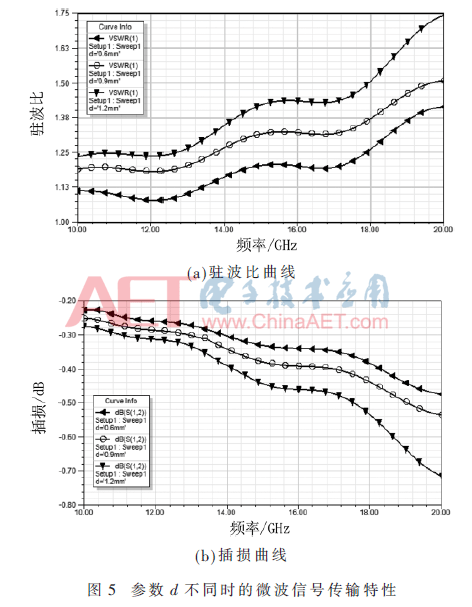
将d为0.6 mm时的传输特性与直通微带相比,驻波比大了0.3,插损仅大0.1 dB。其参数变化处于可接受范围,满足工程应用要求。
2 Ka波段多层板过渡模型优化及仿真
Ka波段芯片已日趋成熟及多样化,其性能基本能满足系统需求,而传统的多芯片组件大多采用正面隔腔走微波信号,背面走低频信号的布局,低频信号通过穿线或焊接低频绝缘子的形式给芯片馈电。这种布局的优点是电性能容易调试且高频信号与低频信号之间的相互串扰较小。但其缺点也很明显,就是组件需采用双面结构,组件厚度很难缩小,且组件盖板需双面气密,工程难度较大;再者就是穿线工艺带来装配难度增加,组件内部裸芯片容易被污染损坏,尤其是在多芯片组件中,馈电点较多的情况下,这种现象更为明显。于是,研究多层板技术在Ka波段的应用显得尤为迫切。
图6为图1模型在30 GHz~40 GHz频段范围内的仿真结果,从仿真结果可以看出虽然没有谐振现象,但传输特性较差,损耗大驻波比差,不能满足工程应用。
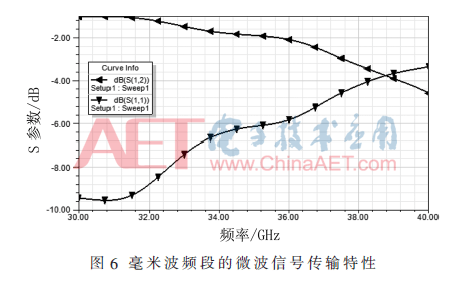
传统电路中,当频率较低时,过孔的各参数的确定多是基于经验值。但当频率上升至微波频段时,过孔结构引起的阻抗不连续性会导致能量的反射并影响电路性能,过孔结构可以用一个简单的集总LC-π型电路等效,如图7所示。基于准静态分析,其电容电感值可以用如下公式来表示[8]:

其中,εr、T、Dp、Dap、h和d分别为基板相对介电常数、基板厚度、过孔焊盘直径、过孔隔离焊盘直径、过孔高度以及过孔直径。

为了减小式(1)中的电感效应,需要减小过孔的高度。同样地,为了减小式(2)中的电容效应,过孔焊盘直径、相对介电常数以及多层板厚度应该尽量小并增大隔离焊盘直径。金属化孔的寄生参数受过孔高度影响较大,高度越大,电感越大,从而会导致高频信号传输特性变差。
通过仿真优化,发现金属化过孔的高度对多层板的传输特性有较大影响,将原高度0.75 mm降为0.4 mm,则整个多层板厚度为0.65 mm,再次进行仿真,仿真结果如图8所示。同时将其与直通微带(如图9所示)、金属化过孔高度为1.0 mm的参数(如图6所示)进行对比。可以看出,过孔高度降低后带内插损最大为0.65 dB,驻波比最大为1.55;与直通微带的最大插损0.35 dB、最大驻波比1.15相比还是有一定的差距,但已能满足常规组件的性能需求,较优化前的最大插损4.5 dB、最大驻波比5.7相比已经有明显的改善。


3 结论
复合多层板技术是研制小型化、高集成和高可靠微波毫米波多芯片组件的关键技术。本文设计了一种基于复合多层板工艺的板间微波互联结构,并利用电磁场仿真软件分析了不同互联模型的微波传输性能。优化后的多层互联结构在10 GHz~20 GHz范围内只比直通微带的插损大0.1 dB,驻波比大0.3;在30 GHz~40 GHz范围内只比直通微带的插损大0.3 dB,驻波比大0.4,具备良好的微波特性。该互联结构具有工艺简单、集成度高、成本低廉等优势,可以解决多芯片组件中的高密度电气互联的问题。
参考文献
[1] 杨晖.中国(成都)电子展聚焦微波射频新技术[J].电子技术应用,2015,41(8):153-154.
[2] 段玮倩,胡岸勇,苗俊刚.射频与微波技术在安防领域的应用[J].电子技术应用,2017,43(7):4-7,15.
[3] 毕晓东.毫米波通信的发展:从产品到测试[J].电子技术应用,2017,43(2):11-12.
[4] 白锐,高长征.基于微波多层板的小型化多通道接收前端设计[J].电讯技术,2014(11):1544-1548.
[5] 刘志辉,吴明远.微系统功能模块集成工艺发展趋势及挑战[J].电子工艺技术,2015,36(4):195-198.
[6] 严伟,吴金财,郑伟.三维微波多芯片组件垂直微波互联技术[J].微波学报,2012,28(5):1-6.
[7] 张先荣.一种低损耗毫米波垂直互联设计[J].电讯技术,2017,57(7):825-829.
[8] JOHNSON H W,GRAHAM M.High-speed digita-l design:a handbook of black magic[M].Upper Saddle River,NJ:Prentice Hall,1993.
作者信息:
王 磊
(中国航天科工集团8511研究所,江苏 南京210007)

