华为、中芯国际赶紧来学,台积电的3D封装太牛,7nm比5nm还强
2022-03-07
来源:互联网乱侃秀
在很多网友的心目中,要提升芯片性能,就要推动芯片工艺的进步,比如从7nm到5nm,再到3nm,再到2nm。
而过去的这些年,芯片厂商、晶圆厂商都是这么教育市场、教育消费者的,手机芯片、电脑从10nmn进步到7nm,再进步到5nm,再接着进入3nm……

事实上,当芯片进入到3nm后,要再提升工艺到2nm,甚至到埃米级(1埃米=0.1nm)是非常困难的,因为成本太高了,所以各大芯片厂商们,也一直在探索不靠提升芯片工艺,来提升芯片性能。
前几天台积电、ARM、英特尔等10大芯片厂商成立的Chiplet联盟,其实也是这个目的,通过封装各和种不同工艺,不同厂商的小芯片粒,达到工艺不变,性能提升的目的。

而在Chiplet联盟成立之外,台积电也办了另外一件事,那就是利用先进的3D封装技术,让7nm的芯片,比5nm还要强。
3月3日,英国的AI芯片公司Graphcore发布了一款IPU产品Bow,采用的就是台积电7纳米的3D封装技术,也是全球首颗3D封装的芯片。
这颗芯片的性能较上代提升了40%、功耗提升了16%,而单个封装中的晶体管数量超过了600亿晶体管。
按照业内人士的说法,如果这颗芯片采用5nm工艺,未必比现在强,也就是说在采用了3D封装技术后,7nm其实比5nm更强了。
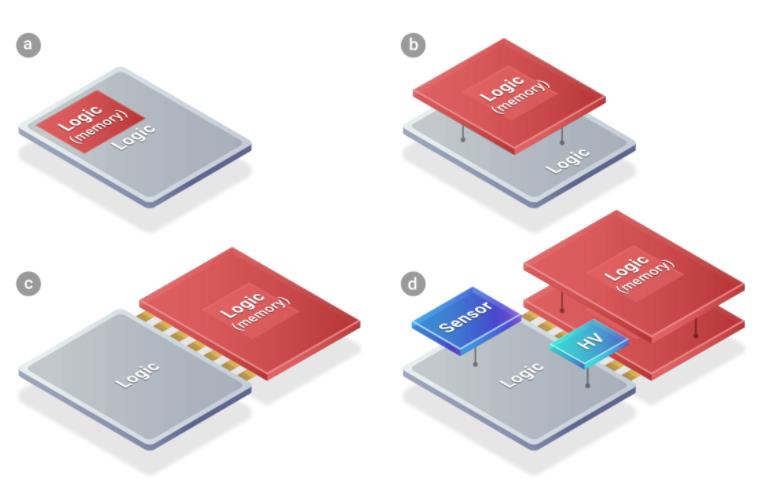
3D封装技术究竟是什么技术?我们知道以前的芯片封装时,都是单个Die(硅片)进行封装,要想芯片性能好, 要么Die(硅片)的面积更大,要么工艺再提升。
而3D封装技术不一样,采用的是几块Die(硅片)垂直叠加在一起,搞几层一起封装成一颗芯片,这样减少了面积,减轻了重量,还提升了性能,因为单位面积内,Die的面积呈几倍增加,自然晶体管的数量也是成倍增加了。
事实上,这也有一点像之前网上曝光的所谓的华为双芯片叠加技术,用两块14nm的芯片叠加起来,实现7nm芯片的性能。

但这个更彻底一点,不是两颗芯片叠加,而是两块没封装的Die叠加,实现更强的性能,这远比封装成芯片后再叠加,强大的多,成本更低,性能更好,功耗也可控得多。
而这颗芯片的诞生,也证明了芯片性能的提升并不一定要提升工艺,也可以升级封装技术,向先进封装转移。
这无疑也是当前众多芯片厂商需要考虑和选择的另外一个方面了,特别是国内芯片工艺无法进步时,这种封装技术,更加重要。


