陈君, 侯倩,廉得亮
(深圳大学信息工程学院,广东 深圳 518060)
摘要:集成电路(Integrated Circuits)的快速发展,导致对互连线的材料要求更高,互连线的问题成为了集成电路的研究热点。尤其是当电路的特征尺寸越来越小的时候,互连线引起的各种效应是影响电路性能的重要因素。本文阐述了传统金属铝以及合金到现在主流的铜以及正在发展的新型材料——碳纳米管作为互连线的优劣,并对新型光互连进行了介绍。
关键词:集成电路;互连线;金属;碳纳米管;光互连
0引言
如今,集成电路(Integrated Circuits, IC)朝着高密度和低功耗方向发展,IC中器件的特征尺寸日益减小,现代集成电路可以集成得非常紧凑,可将数十亿晶体管和其他电子组件集成在一个面积约1 cm2甚至更小的衬底上。由于特征尺寸越来越小,互连线越来越细,导致互连引线横截面和线间距的减小, 电阻、电容、电感引起的寄生效应越来越影响电路的性能,互连RC延迟成为限制整体信号传播延迟的重要原因。所以集成电路的互连线的发展对集成电路的发展影响深远。减少RC延迟、动态功耗以及相声噪声是研究集成电路互连线的新材料的动力[1]。
1金属互连线
集成电路金属互连引线在选材方面需要具有较小的电阻率且易于沉积和刻蚀。集成电路芯片中的金属连线通常要能够承受很高的电流强度(105A/cm2以上),在高电流强度下,集成电路芯片中就容易出现电迁移。由于金属离子变得活跃了, 大量电子的猛烈撞击就发生宏观迁移现象。电迁移使得金属离子会在阳极堆积成小丘,在阴极出现空洞,导致金属引线断裂,从而使整个集成电路失效[2]。集成电路金属互连引线在选材方面需要具有良好的抗电迁移特性。
1.1铝互连线
铝基本上可以满足作为集成电路互连线性能的要求,所以集成电路中最初常用的互连金属材料是铝。在室温下,铝的导电率高(电阻率仅为2.65 μΩ·cm),与n型、p型硅或多晶硅的欧姆接触电阻低(可低至10-6 Ω/cm),与硅和磷硅玻璃的附着性很好,易于沉积与刻蚀。在传统的铝互连工艺技术中,互连引线的加工流程是首先在介质层上淀积金属层铝 ,然后以光刻胶作掩膜,刻蚀形成金属互连引线的图形。随着对于集成电路制造工艺越来越成熟,特征尺寸能做得越来越小,铝互连线也暴露出许多致命的缺陷,尖楔现象和电迁移现象最为严重。
目前集成电路的衬底基本为硅,然而铝在硅中的溶解度非常低,而硅在铝中的溶解度却非常高,由于这一物理现象,导致了集成电路淀积在硅片上的铝与硅接触时硅会溶于铝中而产生裂缝,一般铝/硅接触中的尖楔长度可以达到1 μm,而集成电路中有源区的厚度一般都在纳米级别。因此尖楔现象的存在可能使某些PN节失效。电迁移现象上文已经说明,随着互连线层数和互连线长度的迅速增加以及互连线宽度的减小,更容易出现电迁移现象。当人们发现铝互连线已经不能适应互连技术发展对互连线材料的需求时,开始做了大量研究,如文献[3,4]中的研究,研究表明使用铝铜合金代替纯铝能解决电迁移现象。
1.2铝合金互连线
合金可以增大电子迁移率、增强扩散屏蔽等。文献[5]表明,铝互连线的电迁移问题研究的突破性进展是通过用铝铜合金代替纯铝实现的。1970年,IBM公司的Ames等发现在纯铝中加入少量的铜能够大大提高铝互连线的电迁移寿命,而后经过大批人的研究发现稍微在铝中多加1%的硅即可使铝导线上的缺陷减至最少[6],而在铝中加入少量的铜,则可使电子迁移率提高数量级倍[7]。
1.3铜互连线
集成电路金属互连线制造工艺达到纳米级后,因为超高纯铜具有更佳的电阻率和抗电迁徙能力,很快高纯铜就替代超高纯铝合金成为金属互连线的主要材料[8]。铜替代铝成为集成电路互连线的一个巨大障碍是已成熟的铝互连工艺不适用于铜,铜不能产生易挥发的物质,难以刻蚀,而且铜在硅和二氧化硅中扩散得很快,这使衬底的介电性能严重减弱,用一般的刻蚀方法难以刻蚀形成互连图形。为将铜作为集成电路互连线的材料,就需要发展出与铝布线完全不同的工艺来解决。铜互连工艺发展采用了全新的布线工艺,目前应用最普遍的为最早由IBM提出的镶嵌工艺[910]。但是,集成电路技术进入32 nm这一节点后,就算是镶嵌铜线布线的技术,也同样面临着传统的蚀刻铝线互连所面临的问题,互连线的最大有效电流承载密度已远远无法满足需求,电迁移现象也愈发凸显[11],铜互连线的稳定性,阻碍了集成电路的进一步发展。
2碳纳米管互连线
在这种发展趋势下,传统的金属互连线已阻碍了集成电路的发展。于是,对材料的优化成了主要的挑战。自Kroto和Smalley在1985年发现碳纳米管后[12,13],在世界范围内掀起了一股碳纳米管热。碳纳米管具有很好的电学性能、导电性质、力学性质——极高的强度、极大的韧性和良好的热学性能,还有特殊的磁性能、高的扩散率、高的反应活性和催化性能,以及吸收电磁波的性能。因为碳纳米管拥有的这些性能,其能广泛地用于提高复合材料应力水平、电池的电极改性、导电、电磁屏蔽等[14]。碳纳米管(CNT)由于尺寸较小,能够承受的电迁移电流密度高,且有上述优等性能,能解决纳米尺度以及电迁移的难题,碳纳米管成为目前互连材料的研究热点[15]。
碳纳米管是由六角网状的石墨卷成的,具有螺旋周期管状结构。由石墨层卷曲而形成的封闭管状结构,根据石墨层图1碳纳米管的结构数的不同可分为单壁碳纳米管(SingleWalled Nanotubes, SWNTs)和多壁碳纳米管(MultiWalled Nanotubes, MWNTs)。如图1所示。单壁碳纳米管由一层石墨组成,又称富勒(Fullerenes tubes)。多壁碳纳米管含有多层石墨,形状像个同轴电缆。
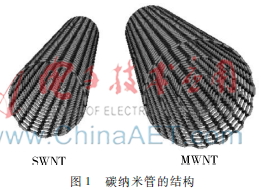
目前,在各大学的物理系和IBM等公司都在制造碳纳米管,成本相对来说比较高。现阶段制造碳纳米管的方法包括石墨电弧法、催化裂解法(又称CVD法)等[16]。电弧放电法是以含有催化剂(铁系元素、稀土元素等)的石墨棒作阳极,纯石墨棒作为阴极,在电弧室(充满惰性气体)内,通过电极间产生高温连续电弧,使得石墨与催化剂完全气化蒸发,在阴极上生成碳纳米管。但此方法不适用于集成电路。而CVD法是半导体工业中应用最为广泛的用来沉积多种材料的技术,已经成熟。该方法用于生长碳纳米管是在含有碳源的气体(或蒸汽)流反应室内,经金属催化剂表面时分解, 并生成炭纤维导,沉积到晶片表面上。图2是Nishant团队用CVD法制备碳纳米管的装备[17]。


图3不同生长温度下制备的碳纳米管薄膜的扫描虽然CVD法能用于集成电路制备碳纳米管,但是在工艺和可靠性方面都存在很多问题。大多数高质量的碳纳米管的生长温度都超过600℃,这对于硅工艺而言是不允许的。碳纳米管的生长工艺与CMOS工艺的兼容还是要大力研究的。要两工艺兼容,必将牺牲生长温度,由于生长温度越低,碳管中的缺陷也就越多。而且碳纳米管的生长方向、长度和直径可控的生长也是经过长期的研究。可以用来影响碳纳米管生长的因素很多,比如气体[17]、温度[18]、重力[19]。如下图3是文献[18]中在4种不同生长温度(a是750℃,b是800℃,c是850℃,d是900℃)下制备的碳纳米管薄膜的SEM照片。其表明通过生长温度可以调控碳纳米管薄膜形貌和浸润性能。但是利用这些因素制备碳纳米管方法的生长机理研究还不够深入,还不具备现实意义和应用价值,还不能投入生产。
尽管碳纳米管的发展很快,但是将其集成到当今的大规模集成电路中去的技术还不是很成熟,还属于研究阶段,并未投入工业生产,且虽然目前很多专业人士对碳纳米管带来的挑战提出了各种解决方案,可是到目前为止都没有很好的方案来彻底解决。
3光互连
传统的片上互连技术以及现在一直在大力研究的新型碳纳米管互连的技术到一定的极限就会受到电互连物理特性的制约,但光互连就不同了。光互连的主要优势在于低RC延时、低功耗以及不会有金属互连线的电迁移现象。另外,光互连用于芯片互连不需物理上的新突破。光互连技术已广泛应用于高性能计算机中的机柜间和节点间互连[20]。文献[21]研究指出,FFT 运算规模与加速比的关系如图4所示,运算规模与效率的关系如图5所示,其表明在同等条件下,不论是加速比还是效率,在网孔模型中,光互连(Optical interconnection)比电互连(Electrical interconnection)各方面性能的提高都超过了50%。

的加速比对比
在各种光互连方案中,硅基光互连技术被认为是最有发展前途的一个方案。硅基光互连的研究具体还包括硅基纳米发光材料的设计、制备;硅基发光材料的设计、制备和激射;硅基发光器件的设计、制备和发光增强;硅图5在网孔结构中,光互连与电互连的效率对比基光源和光波导集成耦合等[22]。具体光互连系统如图6。光互连的研究不单单是互连线的研究,还需要材料、信号处理、光学等学科研究人员的同心协力。

科研实力无比雄厚的IBM一直在钻研集成纳米光子图6硅基光互连集成系统
技术,自2003年开始致力于CMOS的研究,取得了显著进展,主要研究成果包括硅光子互连技术所需的各种光子器件的制备;2012年在光信号取代电信号进行信息传输方面取得重大突破。经过十多年的研发,“硅纳米光子”终于利用100 nm以下工艺,在单颗硅芯片内同时整合了多种不同的光学部件和电子电路,但严格来说这也只是光与电的结合,光子只是部分取代了电子。光互连的实用化还需要走很长的路。
4结束语
集成电路的发展离不开对互联线的研究,现在互连线的研究还主要是对金属互连线的优化,金属互连线还是占主导地位,互连线目前的发展趋势还是金属互连线。但是对新的互连线材料的开发及研究是互连线研究的热点。最近经过很多专业人士的研究,互联线发展了新材料——碳纳米管,但是由于这些进展都还处在研发阶段,碳纳米管互连线在制备工艺过程中的问题以及可靠性方面的问题等都没有解决,还没有投入工业生产中。不过由于碳纳米管的优越性,还是值得作为集成电路的互联线研究的。光互连虽然工艺技术上还存在不少问题,未来的制作成本也还无法预估,但是解决和完善这些问题是指日可待的。当光互连技术在集成电路中得到工业化应用时,集成电路必将再发展一大步。
参考文献
[1] MIKHAIL R. Advanced interconnects: materials, processing, and reliability[J].ECS Journal of Solid State State Science and Technology,2015,4(1):14.
[2] 张文杰, 易万兵, 吴瑾. 铝互连线的电迁移问题及超深亚微米技术下的挑战[J]. 物理学报, 2006(10):54245434.
[3] LU Y, TOHMYOH H, SAKA M. Comparison of stress migration and electromigration in the fabrication of thin Al wires[J]. Thin Solid Films, 2012, 520(9):34483452.
[4] RAMMINGER S, SELIGER N, WACHUTKA G. Reliability model for Al wire bonds subjected to heel crack failures[J]. Microelectronics Reliability, 2000, 40(8):15211525.
[5] 于建姝.铝互连线电迁移可靠性研究[D].天津:天津大学,2010.
[6] 张蓓榕, 忻佩胜, 孙沩. Al—Si(1%)互连线电迁移失效研究[J]. 华东师范大学学报:自然科学版, 1994(1):3540.
[7] 陈军, 毛昌辉. 铝铜互连线电迁移失效的研究[J]. 稀有金属, 2009(4):530533.

